Intel 5400 Series, X5472 - Cpu Xeon Quad Core 3.00Ghz Fsb1600Mhz 12M Lga771 Tray, Xeon 5400 Series Design Manuallines
Page 1

Quad-Core Intel® Xeon® Processor
5400 Series
Thermal/Mechanical Design Guidelines
November 2007
Reference Number: 318611 Revision: 001
Page 2

IINFORMATION IN THIS DOCUMENT IS PROVIDED IN CONNECTION WITH INTEL® PRODUCTS. NO LICENSE, EXPRESS OR
IMPLIED, BY ESTOPPEL OR OTHERWISE, TO ANY INTELLECTUAL PROPERTY RIGHTS IS GRANTED BY THIS DOCUMENT. EXCEPT AS
PROVIDED IN INTEL'S TERMS AND CONDITIONS OF SALE FOR SUCH PRODUCTS, INTEL ASSUMES NO LIABILITY WHATSOEVER,
AND INTEL DISCLAIMS ANY EXPRESS OR IMPLIED WARRANTY, RELATING TO SALE AND/OR USE OF INTEL PRODUCTS INCLUDING
LIABILITY OR WARRANTIES RELATING TO FITNESS FOR A PARTICULAR PURPOSE, MERCHANTABILITY, OR INFRINGEMENT OF ANY
PATENT, COPYRIGHT OR OTHER INTELLECTUAL PROPERTY RIGHT. Intel products are not intended for use in medical, life saving, or
life sustaining applications. Intel may make changes to specifications and product descriptions at any time, without notice.
Designers must not rely on the absence or characteristics of any features or instructions marked “reserved” or “undefined.” Intel
reserves these for future definition and shall have no responsibility whatsoever for conflicts or incompatibilities arising from future
changes to them.
The Quad-Core Intel® Xeon® 5400 Series may contain design defects or errors known as errata, which may cause the product to
deviate from published specifications. Current characterized errata are available upon request.
Contact your local Intel sales office or your distributor to obtain the latest specifications and before placing your product order.
Copies of documents which have an order number and are referenced in this document, or other Intel literature, may be obtained
by calling1-800-548-4725, or by visiting Intel's website at http://www.intel.com.
Intel, Intel Inside, Xeon, Intel Core and the Intel logo are trademarks or registered trademarks of Intel Corporation or its
subsidiaries in the United States and other countries.
* Other brands and names may be claimed as the property of others.
Copyright © 2007, Intel Corporation. All rights reserved.
2 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 3

Contents
1Introduction..............................................................................................................9
1.1 Objective ...........................................................................................................9
1.2 Scope ................................................................................................................9
1.3 References .........................................................................................................9
1.4 Definition of Terms ............................................................................................ 10
2 Thermal/Mechanical Reference Design.................................................................... 13
2.1 Mechanical Requirements ................................................................................... 13
2.1.1 Processor Mechanical Parameters ............................................................. 13
2.1.2 Quad-Core Intel® Xeon® Processor 5400 Series Package............................ 14
2.1.3 Quad-Core Intel® Xeon® Processor 5400 Series Considerations................... 18
2.2 Processor Thermal Parameters and Features ......................................................... 19
2.2.1 Thermal Control Circuit and TDP............................................................... 19
2.2.2 Digital Thermal Sensor............................................................................ 20
2.2.3 Platform Environmental Control Interface (PECI) ........................................ 21
2.2.4 Multiple Core Special Considerations ......................................................... 21
2.2.5 Thermal Profile ...................................................................................... 24
2.2.6 TCONTROL Definition .............................................................................. 25
2.2.7 Thermal Profile Concepts for the Quad-Core Intel® Xeon®
2.2.8 Performance Targets............................................................................... 28
2.3 Fan Fail Guidelines ............................................................................................ 32
2.4 Characterizing Cooling Solution Performance Requirements..................................... 33
2.4.1 Fan Speed Control.................................................................................. 33
2.4.2 Processor Thermal Characterization Parameter Relationships........................ 34
2.4.3 Chassis Thermal Design Considerations ..................................................... 36
2.5 Thermal/Mechanical Reference Design Considerations ............................................ 37
2.5.1 Heatsink Solutions.................................................................................. 37
2.5.2 Thermal Interface Material....................................................................... 38
2.5.3 Summary .............................................................................................. 38
2.5.4 Assembly Overview of the Intel Reference Thermal Mechanical Design........... 39
2.5.5 Thermal Solution Performance Characteristics ............................................ 41
2.5.6 Thermal Profile Adherence....................................................................... 42
2.5.7 Components Overview ............................................................................ 45
2.5.8 Boxed Active Thermal Solution for the Quad-Core Intel®
A 1U Alternative Heatsink Thermal/Mechanical Design............................................... 53
A.1 Component Overview......................................................................................... 53
A.2 Thermal Solution Performance Characterics .......................................................... 54
A.3 Thermal Profile Adherence.................................................................................. 54
B Mechanical Drawings............................................................................................... 57
C Heatsink Clip Load Methodology .............................................................................. 83
C.1 Overview ......................................................................................................... 83
C.2 Test Preparation................................................................................................ 83
C.2.1 Heatsink Preparation .............................................................................. 83
C.2.2 Typical Test Equipment ........................................................................... 86
C.2.3 Test Procedure Examples ........................................................................ 86
C.2.4 Time-Zero, Room Temperature Preload Measurement ................................. 86
C.2.5 Preload Degradation under Bake Conditions ............................................... 87
Processor 5400 Series............................................................................. 26
Xeon® Processor 5400 Series Thermal Profile ............................................ 49
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 3
Page 4

D Safety Requirements................................................................................................89
E Quality and Reliability Requirements .......................................................................91
E.1 Intel Verification Criteria for the Reference Designs ................................................91
E.1.1 Reference Heatsink Thermal Verification ....................................................91
E.1.2 Environmental Reliability Testing ..............................................................91
E.1.3 Material and Recycling Requirements.........................................................93
F Enabled Suppliers Information.................................................................................95
F.1 Supplier Information ..........................................................................................95
F.1.1 Intel Enabled Suppliers............................................................................95
F.1.2 Additional Suppliers ................................................................................96
Figures
2-1 Quad-Core Intel® Xeon® Processor 5400 Series Mechanical Drawing (1 of 3)............15
2-2 Quad-Core Intel® Xeon® Processor 5400 Series Mechanical Drawing (2 of 3)............16
2-3 Quad-Core Intel® Xeon® Processor 5400 Series Mechanical Drawing (3 of 3)............17
2-4 Processor Case Temperature Measurement Location ...............................................19
2-5 DTS Domain for Quad-Core Intel® Xeon® Processor 5400 Series ............................21
2-6 Processor Core Geometric Center Locations ...........................................................23
2-7 Thermal Profile Diagram .....................................................................................24
2-8 TCONTROL Value and Digital Thermal Sensor Value Interaction................................25
2-9 TCONTROL and Thermal Profile Interaction............................................................26
2-10 Dual Thermal Profile Diagram..............................................................................27
2-11 Thermal Profile for the Quad-Core Intel® Xeon® Processor X5400 Series..................29
2-12 Thermal Profile for Quad-Core Intel® Xeon® Processor E5400 Series .......................30
2-13 Thermal Profile for Quad-Core Intel® Xeon® Processor X5482 Series.......................31
2-14 TCONTROL and Fan Speed Control .......................................................................33
2-15 Processor Thermal Characterization Parameter Relationships ...................................35
2-16 Exploded View of CEK Thermal Solution Components..............................................39
2-17 2U+ CEK Heatsink Thermal Performance...............................................................41
2-18 1U CEK Heatsink Thermal Performance.................................................................42
2-19 2U+CEK Thermal Adherence to Quad-Core Intel® Xeon® Processor X5400
Series Thermal Profile A......................................................................................43
2-20 1U CEK Thermal Adherence to Quad-Core Intel® Xeon® Processor X5400
Series Thermal Profile B......................................................................................44
2-21 1U CEK Thermal Adherence to Quad-Core Intel® Xeon® Processor E5400
Series Thermal Profile ........................................................................................45
2-22 Isometric View of the 2U+ CEK Heatsink...............................................................46
2-23 Isometric View of the 1U CEK Heatsink .................................................................46
2-24 CEK Spring Isometric View..................................................................................48
2-25 Isometric View of CEK Spring Attachment to the Base Board ...................................48
2-26 Boxed Active CEK Heatsink Solutions with PWM/DTS Control
(Representation Only) ........................................................................................49
2-27 Fan Cable Connection (Active CEK) ......................................................................50
A-1 Isometric View of the 1U Alternative Heatsink........................................................53
A-2 1U Alternative Heatsink Thermal Performance .......................................................54
A-3 1U Alternative Heatsink Thermal Adherence to Quad-Core Intel® Xeon®
Processor L5400 Series Thermal Profile.................................................................55
B-1 2U CEK Heatsink (Sheet 1 of 4) ...........................................................................58
B-2 2U CEK Heatsink (Sheet 2 of 4) ...........................................................................59
B-3 2U CEK Heatsink (Sheet 3 of 4) ...........................................................................60
B-4 2U CEK Heatsink (Sheet 4 of 4) ...........................................................................61
4 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 5

B-5 CEK Spring (Sheet 1 of 3) .................................................................................. 62
B-6 CEK Spring (Sheet 2 of 3) .................................................................................. 63
B-7 CEK Spring (Sheet 3 of 3) .................................................................................. 64
B-8 Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 1 of 6).................................................................... 65
B-9 Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 2 of 6).................................................................... 66
B-10 Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 3 of 6).................................................................... 67
B-11 Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 4 of 6).................................................................... 68
B-12 Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 5 of 6).................................................................... 69
B-13 Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 6 of 6).................................................................... 70
B-14 1U CEK Heatsink (Sheet 1 of 4)........................................................................... 71
B-15 1U CEK Heatsink (Sheet 2 of 4)........................................................................... 72
B-16 1U CEK Heatsink (Sheet 3 of 4)........................................................................... 73
B-17 1U CEK Heatsink (Sheet 4 of 4)........................................................................... 74
B-18 Active CEK Thermal Solution Volumetric (Sheet 1 of 3)........................................... 75
B-19 Active CEK Thermal Solution Volumetric (Sheet 2 of 3)........................................... 76
B-20 Active CEK Thermal Solution Volumetric (Sheet 3 of 3)........................................... 77
B-21 1U Alternative Heatsink (1 of 4) .......................................................................... 78
B-22 1U Alternative Heatsink (2 of 4) .......................................................................... 79
B-23 1U Alternative Heatsink (3 of 4) .......................................................................... 80
B-24 1U Alternative Heatsink (4 of 4) .......................................................................... 81
C-1 Load Cell Installation in Machined Heatsink Base Pocket - Bottom View..................... 84
C-2 Load Cell Installation in Machined Heatsink Base Pocket - Side View......................... 85
C-3 Preload Test Configuration.................................................................................. 85
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 5
Page 6

Tables
1-1 Reference Documents.......................................................................................... 9
1-2 Terms and Descriptions ......................................................................................10
2-1 Processor Mechanical Parameters Table ................................................................13
2-2 Input and Output Conditions for the Quad-Core Intel® Xeon® Processor 5400
Series Thermal Management Features ..................................................................22
2-3 Processor Core Geometric Center Dimensions........................................................23
2-4 Intel Reference Heatsink Performance Targets for the Quad-Core Intel®
Xeon® Processor X5400 Series............................................................................31
2-5 Intel Reference Heatsink Performance Targets for the Quad-Core Intel®
Xeon® Processor E5400 Series............................................................................32
2-6 Fan Speed Control, TCONTROL and DTS Relationship..............................................34
2-7 CEK Heatsink Thermal Mechanical Characteristics...................................................47
2-8 Recommended Thermal Grease Dispense Weight ...................................................47
2-9 Fan Specifications (Boxed 4-wire PWM/DTS Heatsink Solution) ................................50
2-10 Fan Cable Connector Pin Out (Active CEK).............................................................51
A-1 1U Alternative Heatsink Thermal Mechanical Characteristics ....................................54
B-1 Mechanical Drawing List......................................................................................57
C-1 Typical Test Equipment.......................................................................................86
E-1 Use Conditions Environment................................................................................92
F-1 Suppliers for the Quad-Core Intel® Xeon® Processor 5400 Series Intel
Reference Solution.............................................................................................95
F-2 Additional Suppliers for the Quad-Core Intel® Xeon® Processor 5400 Series
Intel Reference Solution .....................................................................................97
6 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 7

Revision History
Reference
Number
318611 001 Initial release of the document. November 2007
Revision
Number
Description Date
§
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 7
Page 8

8 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 9

Introduction
1 Introduction
1.1 Objective
The purpose of this guide is to describe the reference thermal solution and design
parameters required for the Quad-Core Intel® Xeon® Processor 5400 Series.
It is also the intent of this document to comprehend and demonstrate the processor
cooling solution features and requirements. Furthermore, this document provides an
understanding of the processor thermal characteristics, and discusses guidelines for
meeting the thermal requirements imposed over the entire life of the processor. The
thermal/mechanical solutions described in this document are intended to aid
component and system designers in the development and evaluation of processor
compatible thermal/mechanical solutions.
1.2 Scope
The thermal/mechanical solutions described in this document pertain to a solution(s)
intended for use with the Quad-Core Intel® Xeon® Processor 5400 Series in 1U, 2U,
2U+ and workstation form factors systems. This document contains the mechanical
and thermal requirements of the processor cooling solution. In case of conflict, the data
in the Quad-Core Intel® Xeon® Processor 5400 Series Datasheet supersedes any data
in this document. Additional information is provided as a reference in the appendices.
1.3 References
Material and concepts available in the following documents may be beneficial when
reading this document.
Table 1-1. Reference Documents (Sheet 1 of 2)
Document Comment
European Blue Angel Recycling Standards http://www.blauer-engel.de
®
Intel
Xeon® Dual- and Multi- Processor Family Thermal Test Vehicle
User's Guide
LGA771 Socket Mechanical Design Guide See Note following table.
LGA771 SMT Socket Design Guidelines See Note following table.
LGA771 Daisy Chain Test Vehicle User Guide See Note following table.
Stoakley Platform Design Guide (PDG) See Note following table.
Dual-Core Intel
Guide (PDG)
Dual-Core Intel
Guide (PDG)
Clovertown, Harpertown & Wolfdale-DP Processors Compatibility Design
Guide for Bensley, Bensley-VS, and Glidewell Platforms
PECI Feature Set Overview See Note following table
Platform Environment Control Interface(PECI) Specification See Note following table
Quad-Core Intel® Xeon® Processor 5400 Series Datasheet See Note following table.
Clovertown_Harpertown_Wolfdale-DP Processor Enabled CEK and
Package Mechanical Models (in IGES and ProE* format)
®
Xeon® Processor-Based Servers Platform Design
®
Xeon® Processor-Based Workstation Platform Design
See Note at bottom table.
See Note following table.
See Note following table.
See Note following table.
Available electronically
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 9
Page 10

Table 1-1. Reference Documents (Sheet 2 of 2)
Document Comment
Clovertown_Harpertown_Wolfdale-DP Processor Enabled Components
CEK Thermal Models (in Flotherm* and Icepak*)
Clovertown_Harpertown_Wolfdale-DP Processor Package Thermal
Models (in Flotherm and Icepak)
RS - Wolfdale Processor Family BIOS Writers Guide (BWG) See Note following table.
Thin Electronics Bay Specification (A Server System Infrastructure (SSI)
Specification for Rack Optimized Servers
Note: Contact your Intel field sales representative for the latest revision and order number of this document.
1.4 Definition of Terms
Table 1-2. Terms and Descriptions (Sheet 1 of 2)
Term Description
Bypass Bypass is the area between a passive heatsink and any object that can act to form a
DTS Digital Thermal Sensor replaces the Tdiode in previous products and
MSR The processor provides a variety of model specific registers that are used to control and
FMB Flexible Motherboard Guideline: an estimate of the maximum value of a processor
FSC Fan Speed Control
IHS Integrated Heat Spreader: a component of the processor package used to enhance the
LGA771 Socket The Quad-Core Intel® Xeon® Processor 5400 Series interfaces to the baseboard
P
MAX
PECI A proprietary one-wire bus interface that provides a communication channel between
Ψ
CA
Ψ
CS
Ψ
SA
T
CASE
T
CASE_MAX
TCC Thermal Control Circuit: Thermal monitor uses the TCC to reduce the die temperature
duct. For this example, it can be expressed as a dimension away from the outside
dimension of the fins to the nearest surface.
sensor as the PROCHOT# sensor to indicate the on-die temperature. The temperature
value represents the number of degrees below the TCC activation temperature.
report on processor performance. Virtually all MSRs handle system related functions and
are not accessible to an application program.
specification over certain time periods. System designers should meet the FMB values to
ensure their systems are compatible with future processor releases.
thermal performance of the package. Component thermal solutions interface with the
processor at the IHS surface.
through this surface mount, 771 Land socket. See the LGA771 Socket Mechanical
Design Guide for details regarding this socket.
The maximum power dissipated by a semiconductor component.
Intel processor and chipset components to external thermal monitoring devices, for use
in fan speed control. PECI communicates readings from the processors Digital Thermal
Sensor. PECI replaces the thermal diode available in previous processors.
Case-to-ambient thermal characterization parameter (psi). A measure of thermal
solution performance using total package power. Defined as (T
Package Power. Heat source should always be specified for Ψ measurements.
Case-to-sink thermal characterization parameter. A measure of thermal interface
material performance using total package power. Defined as (T
Package Power.
Sink-to-ambient thermal characterization parameter. A measure of heatsink thermal
performance using total package power. Defined as (T
The case temperature of the processor, measured at the geometric center of the topside
of the IHS.
The maximum case temperature as specified in a component specification.
by using clock modulation and/or operating frequency and input voltage adjustment
when the die temperature is very near its operating limits.
Introduction
Available electronically
Available electronically
www.ssiforum.com
uses the same
– TLA) / Total
CASE
– TS) / Total
CASE
– TLA) / Total Package Power.
S
10 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 11

Introduction
Table 1-2. Terms and Descriptions (Sheet 2 of 2)
T
CONTROL
T
OFFSET
TDP Thermal Design Power: Thermal solution should be designed to dissipate this target
Thermal Monitor A feature on the processor that can keep the processor’s die temperature within factory
Thermal Profile Line that defines case temperature specification of a processor at a given power level.
TIM Thermal Interface Material: The thermally conductive compound between the heatsink
T
LA
T
SA
U A unit of measure used to define server rack spacing height. 1U is equal to 1.75 in, 2U
A processor unique value for use in fan speed control mechanisms. T
temperature specification based on a temperature reading from the processor’s Digital
Thermal Sensor. T
implementation. T
An offset value from the TCC activation temperature value programmed into each
processor during manufacturing and can be obtained by reading the
IA_32_TEMPERATURE_TARGET MSR. This is a static and a unique value. Refer to the
can be described as a trigger point for fan speed control
CONTROL
= -T
CONTROL
RS - Wolfdale Processor Family BIOS Writers Guide (BWG) for further details.
power level. TDP is not the maximum power that the processor can dissipate.
specifications under normal operating conditions.
and the processor case. This material fills the air gaps and voids, and enhances the
transfer of the heat from the processor case to the heatsink.
The measured ambient temperature locally surrounding the processor. The ambient
temperature should be measured just upstream of a passive heatsink or at the fan inlet
for an active heatsink.
The system ambient air temperature external to a system chassis. This temperature is
usually measured at the chassis air inlets.
equals 3.50 in, etc.
OFFSET
is a
CONTROL
.
§
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 11
Page 12

Introduction
12 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 13

Thermal/Mechanical Reference Design
2 Thermal/Mechanical Reference
Design
This chapter describes the thermal/mechanical reference design for Quad-Core Intel®
Xeon® Processor 5400 Series. Both Quad-Core Intel® Xeon® Processor X5400 Series
and Quad-Core Intel® Xeon® Processor E5400 Series are targeted for the full range of
form factors (2U, 2U+ and 1U). The Quad-Core Intel® Xeon® Processor X5482 sku is
an ultra performance version of the Quad-Core Intel® Xeon® Processor 5400 Series
with 150W TDP and is use only in workstation platforms.
2.1 Mechanical Requirements
The mechanical performance of the processor cooling solution must satisfy the
requirements described in this section.
2.1.1 Processor Mechanical Parameters
Table 2-1. Processor Mechanical Parameters Table
Parameter Minimum Maximum Unit Notes
Volumetric Requirements and Keepouts 1
Static Compressive Load 3
Static Board Deflection 3
Dynamic Compressive Load 3
Tra n s ient B e n d 3
Shear Load 70
Tensile Load 25
Torsi on L o a d 35
Notes:
1. Refer to drawings in Appendix B.
2. In the case of a discrepancy, the most recent Quad-Core Intel® Xeon® Processor 5400 Series Datasheet
and LGA771 Socket Mechanical Design Guide supersede targets listed in Ta bl e 2 -1 above.
3. These socket limits are defined in the LGA771 Socket Mechanical Design Guide.
4. These package handling limits are defined in the Quad-Core Intel® Xeon® Processor 5400 Series
Datasheet.
5. Shear load that can be applied to the package IHS.
6. Tensile load that can be applied to the package IHS.
7. Torque that can be applied to the package IHS.
311
111
3.95
lbf
N
lbf
N
in*lbf
N*m
2,4,5
2,4,6
2,4,7
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 13
Page 14

Thermal/Mechanical Reference Design
2.1.2 Quad-Core Intel® Xeon® Processor 5400 Series Package
The Quad-Core Intel® Xeon® Processor 5400 Series is packaged using the flip-chip
land grid array (FC-LGA) package technology. Please refer to the Quad-Core Intel®
Xeon® Processor 5400 Series Datasheet for detailed mechanical specifications. The
Quad-Core Intel® Xeon® Processor 5400 Series mechanical drawing shown in
Figure 2-1, Figure 2-2, and Figure 2-3 provide the mechanical information for the
Quad-Core Intel® Xeon® Processor 5400 Series. The drawing is superseded with the
drawing in the processor datasheet should there be any conflicts. Integrated package/
socket stackup height information is provided in the LGA771 Socket Mechanical Design
Guide.
14 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 15

Thermal/Mechanical Reference Design
Figure 2-1. Quad-Core Intel® Xeon® Processor 5400 Series Mechanical Drawing (1 of 3)
Note: Guidelines on potential IHS flatness variation with socket load plate actuation and installation of the cooling solution are
available in the processor Thermal/Mechanical Design Guidelines.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 15
Page 16

Thermal/Mechanical Reference Design
Figure 2-2. Quad-Core Intel® Xeon® Processor 5400 Series Mechanical Drawing (2 of 3)
16 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 17

Thermal/Mechanical Reference Design
Figure 2-3. Quad-Core Intel® Xeon® Processor 5400 Series Mechanical Drawing (3 of 3)
Note: The optional dimple packing marking highlighted by Detail F from the above drawing may only be found on initial
processors.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 17
Page 18

Thermal/Mechanical Reference Design
The package includes an integrated heat spreader (IHS). The IHS transfers the nonuniform heat from the die to the top of the IHS, out of which the heat flux is more
uniform and spreads over a larger surface area (not the entire IHS area). This allows
more efficient heat transfer out of the package to an attached cooling device. The IHS
is designed to be the interface for contacting a heatsink. Details can be found in the
Quad-Core Intel® Xeon® Processor 5400 Series Datasheet.
The processor connects to the baseboard through a 771-land surface mount socket. A
description of the socket can be found in the LGA771 Socket Mechanical Design Guide.
The processor package and socket have mechanical load limits that are specified in the
Quad-Core Intel® Xeon® Processor 5400 Series Datasheet and the LGA771 Socket
Mechanical Design Guide. These load limits should not be exceeded during heatsink
installation, removal, mechanical stress testing, or standard shipping conditions. For
example, when a compressive static load is necessary to ensure thermal performance
of the Thermal Interface Material (TIM) between the heatsink base and the IHS, it
should not exceed the corresponding specification given in the LGA771 Socket
Mechanical Design Guide.
The heatsink mass can also add additional dynamic compressive load to the package
during a mechanical shock event. Amplification factors due to the impact force during
shock must be taken into account in dynamic load calculations. The total combination
of dynamic and static compressive load should not then exceed the processor/socket
compressive dynamic load specified in the LGA771 Socket Mechanical Design Guide
during a vertical shock. It is not recommended to use any portion of the processor
substrate as a mechanical reference or load-bearing surface in either static or dynamic
compressive load conditions.
2.1.3 Quad-Core Intel® Xeon® Processor 5400 Series
Considerations
An attachment mechanism must be designed to support the heatsink since there are no
features on the LGA771 socket to directly attach a heatsink. In addition to holding the
heatsink in place on top of the IHS, this mechanism plays a significant role in the
robustness of the system in which it is implemented, in particular:
• Ensuring thermal performance of the TIM applied between the IHS and the
heatsink. TIMs, especially ones based on phase change materials, are very
sensitive to applied pressure: the higher the pressure, the better the initial
performance. TIMs such as thermal greases are not as sensitive to applied
pressure. Refer to Section 2.5.2 and Section 2.5.7.2 for information on tradeoffs
made with TIM selection. Designs should consider possible decrease in applied
pressure over time due to potential structural relaxation in enabled components.
• Ensuring system electrical, thermal, and structural integrity under shock and
vibration events. The mechanical requirements of the attach mechanism depend on
the weight of the heatsink and the level of shock and vibration that the system
must support. The overall structural design of the baseboard and system must be
considered when designing the heatsink attach mechanism. Their design should
provide a means for protecting LGA771 socket solder joints as well as preventing
package pullout from the socket.
Note: The load applied by the attachment mechanism must comply with the package and
socket specifications, along with the dynamic load added by the mechanical shock and
vibration requirements, as identified in Section 2.1.1.
18 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 19

Thermal/Mechanical Reference Design
A potential mechanical solution for heavy heatsinks is the direct attachment of the
heatsink to the chassis pan. In this case, the strength of the chassis pan can be utilized
rather than solely relying on the baseboard strength. In addition to the general
guidelines given above, contact with the baseboard surfaces should be minimized
during installation in order to avoid any damage to the baseboard.
The Intel reference design for Quad-Core Intel® Xeon® Processor 5400 Series is using
such a heatsink attachment scheme. Refer to Section 2.5 for further information
regarding the Intel reference mechanical solution.
2.2 Processor Thermal Parameters and Features
2.2.1 Thermal Control Circuit and TDP
The operating thermal limits of the processor are defined by the Thermal Profile. The
intent of the Thermal Profile specification is to support acoustic noise reduction through
fan speed control and ensure the long-term reliability of the processor. This
specification requires that the temperature at the center of the processor IHS, known
as (T
Figure 2-4 shows the measurement location for the Quad-Core Intel® Xeon®
Processor 5400 Series package. Compliance with the T
achieve optimal operation and long-term reliability (See the Intel® Xeon® Dual- and
Multi- Processor Family Thermal Test Vehicle User's Guide for Case Temperature
definition and measurement methods).
Figure 2-4. Processor Case Temperature Measurement Location
) remains within a certain temperature specification. For illustration,
CASE
specification is required to
CASE
To ease the burden on thermal solutions, the Thermal Monitor feature and associated
logic have been integrated into the silicon of the processor. One feature of the Thermal
Monitor is the Thermal Control Circuit (TCC). When active, the TCC lowers the
processor temperature by reducing power consumption. This is accomplished through a
combination of Thermal Monitor and Advanced Thermal Monitor (TM2). Thermal
Monitor modulates the duty cycle of the internal processor clocks, resulting in a lower
effective frequency. When active, the TCC turns the processor clocks off and then back
on with a predetermined duty cycle. Thermal Monitor 2 activation adjusts both the
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 19
Page 20

Thermal/Mechanical Reference Design
processor operating frequency (via the bus multiplier) and input voltage (via the VID
signals). Please refer to the Quad-Core Intel® Xeon® Processor 5400 Series Datasheet
for further details on TM and TM2.
PROCHOT# is designed to assert at or a few degrees higher than maximum T
CASE
(as
specified by the thermal profile) when dissipating TDP power, and can not be
interpreted as an indication of processor case temperature. This temperature delta
accounts for processor package, lifetime, and manufacturing variations and attempts to
ensure the Thermal Control Circuit is not activated below maximum T
CASE
when
dissipating TDP power. There is no defined or fixed correlation between the PROCHOT#
assertion temperature and the case temperature. However, with the introduction of the
Digital Thermal Sensor (DTS) on the Quad-Core Intel® Xeon® Processor 5400 Series,
the DTS reports a relative offset below the PROCHOT# assertion (see Section 2.2.2 for
more details on the Digital Thermal Sensor). Thermal solutions must be designed to the
processor specifications (i.e Thermal Profile) and can not be adjusted based on
experimental measurements of T
, PROCHOT#, or Digital Thermal Sensor on
CASE
random processor samples.
By taking advantage of the Thermal Monitor features, system designers may reduce
thermal solution cost by designing to the Thermal Design Power (TDP) instead of
maximum power. TDP should be used for processor thermal solution design targets.
TDP is not the maximum power that the processor can dissipate. TDP is based on
measurements of processor power consumption while running various high power
applications. This data set is used to determine those applications that are interesting
from a power perspective. These applications are then evaluated in a controlled
thermal environment to determine their sensitivity to activation of the thermal control
circuit. This data set is then used to derive the TDP targets published in the processors
datasheet. The Thermal Monitor can protect the processors in rare workload excursions
above TDP. Therefore, thermal solutions should be designed to dissipate this target
power level. The thermal management logic and thermal monitor features are
discussed in extensive detail in the Quad-Core Intel® Xeon® Processor 5400 Series
Datasheet.
In addition, on-die thermal management features called THERMTRIP# and FORCEPR#
are available on the Quad-Core Intel® Xeon® Processor 5400 Series. They provide a
thermal management approach to support the continued increases in processor
frequency and performance. Please see the Quad-Core Intel® Xeon® Processor 5400
Series Datasheet for guidance on these thermal management features.
2.2.2 Digital Thermal Sensor
The Quad-Core Intel® Xeon® Processor 5400 Series include on-die temperature
sensor feature called Digital Thermal Sensor (DTS). The DTS uses the same sensor
utilized for TCC activation. Each individual processor is calibrated so that TCC activation
occurs at a DTS value of 0. The temperature reported by the DTS is the relative offset
in PECI counts below the onset of the TCC activation and hence is negative. Changes in
PECI counts are roughly linear in relation to temperature changes in degrees Celsius.
For example, a change in PECI count by '1' represents a change in temperature of
approximately 1°C. However, this linearity cannot be guaranteed as the offset below
TCC activation exceeds 20-30 PECI counts. Also note that the DTS will not report any
values above the TCC activation temperature, it will simply return 0 in this case.
The DTS facilitates the use of multiple thermal sensors within the processor without the
burden of increasing the number of thermal sensor signal pins on the processor
package. Operation of multiple DTS will be discussed in more detail in Section 2.2.4.
Also, the DTS utilizes thermal sensors that are optimally located when compared with
thermal diodes available with legacy processors. This is achieved as a result of a
20 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 21
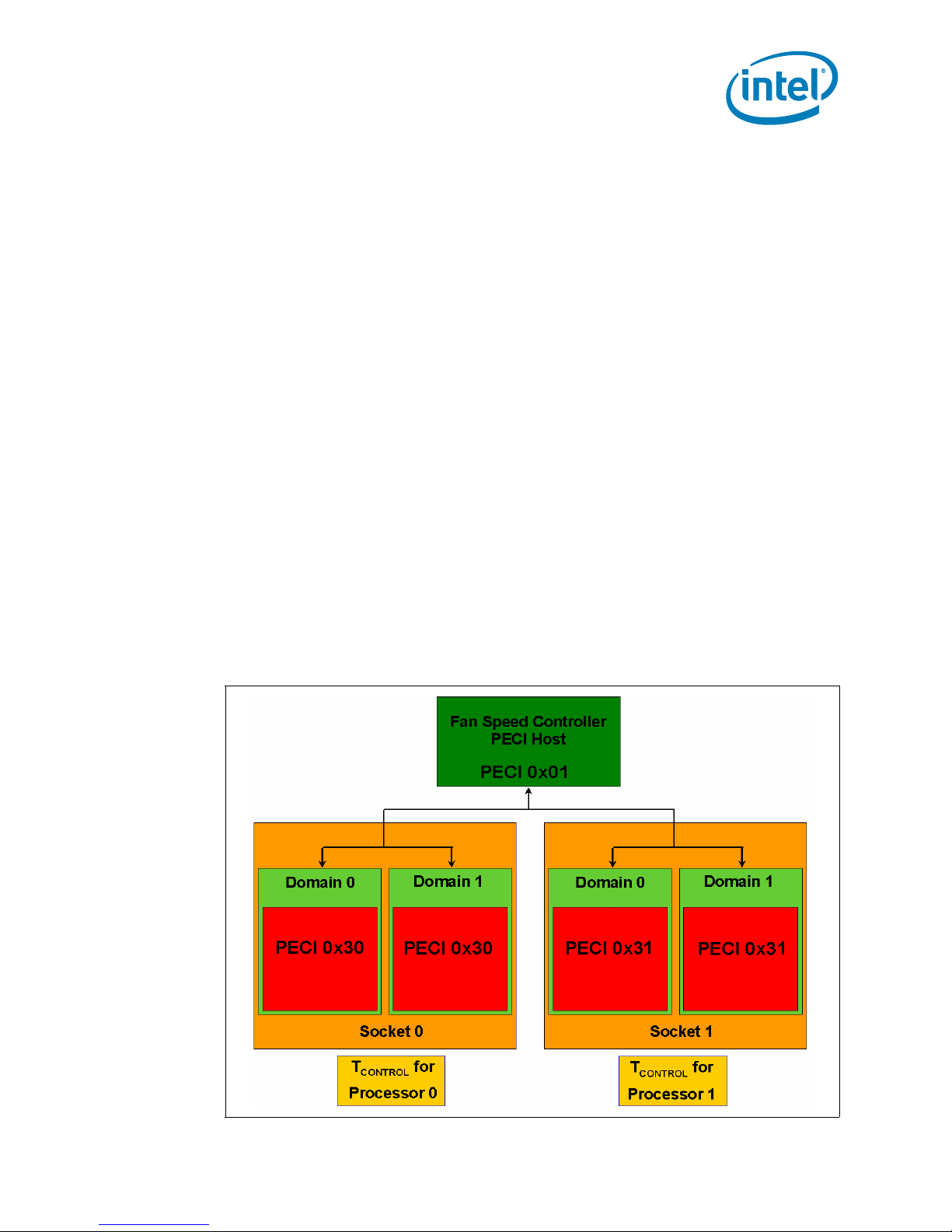
Thermal/Mechanical Reference Design
smaller foot print and decreased sensitivity to noise. These DTS benefits will result in
more accurate fan speed control and TCC activation.The DTS application in fan speed
control will be discussed in more detail in Section 2.4.1.
2.2.3 Platform Environmental Control Interface (PECI)
The PECI interface is designed specifically to convey system management information
from the processor (initially, only thermal data from the Digital Thermal Sensor). It is a
proprietary single wire bus between the processor and the chipset or other health
monitoring device. The PECI specification provides a specific command set to discover,
enumerate devices, and read the temperature. For an overview of the PECI interface,
please refer to PECI Feature Set Overview. For more detailed information on PECI,
please refer to Platform Environment Control Interface (PECI) Specification and Quad-
Core Intel® Xeon® Processor 5400 Series Datasheet.
2.2.4 Multiple Core Special Considerations
2.2.4.1 Multiple Digital Thermal Sensor Operation
Each Quad-Core Intel® Xeon® Processor 5400 Series can have multiple Digital
Thermal Sensors located on the die. Each die within the processor currently maps to a
PECI domain. The Quad-Core Intel® Xeon® Processor 5400 Series contains two cores
per die (domain) and two domains (die) per socket. BIOS will be responsible for
detecting the proper processor type and providing the number of domains to the
thermal management system. An external PECI device that is part of the thermal
management system polls the processor domains for temperature information and
currently receives the highest of the DTS output temperatures within each domain.
Figure 2-5 provides an illustration of the DTS domains for the Quad-Core Intel® Xeon®
Processor 5400 Series.
Figure 2-5. DTS Domain for Quad-Core Intel® Xeon® Processor 5400 Series
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 21
Page 22

2.2.4.2 Thermal Monitor for Multiple Core Products
Thermal/Mechanical Reference Design
The thermal management for multiple core products has only one T
processor. The T
CONTROL
for processor 0 and T
CONTROL
for processor 1 are independent
CONTROL
value per
from each other. If the DTS temperature from any domain within the processor is
greater than or equal to T
CONTROL
, the processor case temperature must remain at or
below the temperature as specified by the thermal profile. See Section 2.2.6 for
information on T
CONTROL
. The PECI signal is available through CPU pin (G5) on each
LGA771 socket for the Quad-Core Intel® Xeon® Processor 5400 Series. Through this
pin, the two domains provide the current hottest value received from all the
temperature sensors, to an external PECI device such as a thermal management
system.
2.2.4.3 PROCHOT#, THERMTRIP#, and FORCEPR#
The PROCHOT# and THERMTRIP# outputs will be shared by all cores on a processor.
The first core to reach TCC activation will assert PROCHOT#. A single FORCEPR# input
will be shared by every core. Tabl e 2- 2 provides an overview of input and output
conditions for the Quad-Core Intel® Xeon® Processor 5400 Series thermal
management features.
Table 2-2. Input and Output Conditions for the Quad-Core Intel® Xeon® Processor 5400
Series Thermal Management Features
Item Processor Input Processor Output
DTS
TM1/TM2
PROCHOT#
Core X > TCC Activation Temperature
Core X > TCC Activation Temperature
DTS
All Cores TCC Activation
PROCHOT# Asserted
Core X > THERMTRIP # Assertion
THERMTRIP#
FORCEPR#
Note:
1. X=1,2,3,4; represents any one of the core1, core2, core3 and core4 in the Quad-Core Intel® Xeon® Processor 5400
Series.
2. For more information on PROCHOT#, THERMTRIP#, and FORCEPR# see the Quad-Core Intel® Xeon® Processor 5400
Series Datasheet.
DTS
Tem p era t ur e
FORCEPR# Asserted All Cores TCC Activation
THERMTRIP# Asserted,
all cores shut down
2.2.4.4 Heatpipe Orientation for Multiple Core Processors
Thermal management of multiple core processors can be achieved without the use of
heatpipe heatsinks, as demonstrated by the Intel Reference Thermal Solution discussed
in Section 2.5.
To assist customers interested in designing heatpipe heatsinks, processor core
locations have been provided. In some cases, this may influence the designer’s
selection of heatpipe orientation. For this purpose, the core geometric center locations,
as illustrated in Figure 2-6, are provided in Tab l e 2 - 3 . Dimensions originate from the
vertical edge of the IHS nearest to the pin 1 fiducial as shown in Figure 2-6.
22 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 23
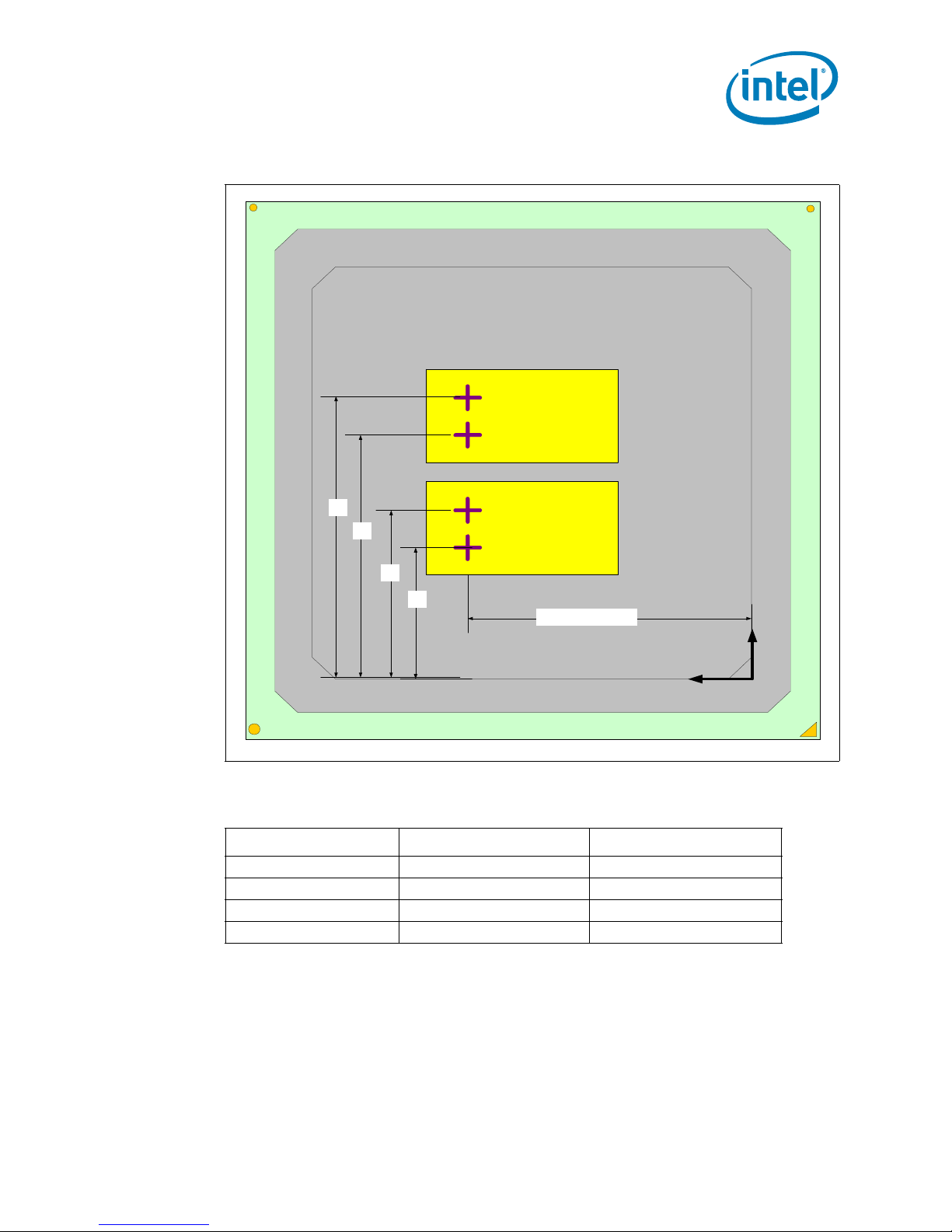
Thermal/Mechanical Reference Design
Figure 2-6. Processor Core Geometric Center Locations
Core4
Core4
Core3
Core3
Y4
Y4
Y3
Y3
Core2
Core2
Core1
Y2
Y2
Y1
Y1
Table 2-3. Processor Core Geometric Center Dimensions
Feature X Dimension Y Dimension
Core 1 18.15 mm 6.15 mm
Core 2 18.15 mm 10.35 mm
Core 3 18.15 mm 18.85 mm
Core 4 18.15 mm 23.05 mm
Core1
X1, X2, X3, X4
X1, X2, X3, X4
Y
Y
X
X
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 23
Page 24

2.2.5 Thermal Profile
The thermal profile is a line that defines the relationship between a processor’s case
temperature and its power consumption as shown in Figure 2-7. The equation of the
thermal profile is defined as:
Equation 2-1.y = ax + b
Where:
y = Processor case temperature, T
x = Processor power consumption (W)
a = Case-to-ambient thermal resistance, ΨCA (°C/W)
b = Processor local ambient temperature, TLA (°C)
Figure 2-7. Thermal Profile Diagram
CASE
Thermal/Mechanical Reference Design
(°C)
The high end point of the Thermal Profile represents the processor’s TDP and the
associated maximum case temperature (T
the local ambient temperature at P = 0W. The slope of the Thermal Profile line
represents the case-to-ambient resistance of the thermal solution with the y-intercept
being the local processor ambient temperature. The slope of the Thermal Profile is
constant, which indicates that all frequencies of a processor defined by the Thermal
Profile will require the same heatsink case-to-ambient resistance.
In order to satisfy the Thermal Profile specification, a thermal solution must be at or
below the Thermal Profile line for the given processor when its DTS temperature is
greater than T
CONTROL
customers to make a trade-off between the thermal solution case-to-ambient
resistance and the processor local ambient temperature that best suits their platform
implementation (refer to Section 2.4.3). There can be multiple combinations of thermal
solution case-to-ambient resistance and processor local ambient temperature that can
meet a given Thermal Profile. If the case-to-ambient resistance and the local ambient
temperature are known for a specific thermal solution, the Thermal Profile of that
solution can easily be plotted against the Thermal Profile specification. As explained
24 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
CASE_MAX
) and the lower end point represents
(refer to Section 2.2.6). The Thermal Profile allows the
Page 25

Thermal/Mechanical Reference Design
above, the case-to-ambient resistance represents the slope of the line and the
processor local ambient temperature represents the y-axis intercept. Hence the
T
CASE_MAX
determined, the line can be extended to Power (P) = 0W representing the Thermal
Profile of the specific solution. If that line stays at or below the Thermal Profile
specification, then that particular solution is deemed as a compliant solution.
value of a specific solution can be calculated at TDP. Once this point is
2.2.6 T
T
processor T
longer absolute. The T
activation set point (i.e. PECI Count = 0), as indicated by PROCHOT#. Figure 2-8
depicts the interaction between the T
Figure 2-8. T
CONTROL
CONTROL
CONTROL
Digital Thermal Sensor Temperature
Digital Thermal Sensor Temperature
Tcontrol = -5
Tcontrol = -5
Definition
can be described as a trigger point for fan speed control implementation. The
CONTROL
Value and Digital Thermal Sensor Value Interaction
value provided by the Digital Thermal Sensor is relative and no
CONTROL
-10
-10
-10
-20
-20
-20
-30
-30
-30
-40
-40
-40
value is now defined as a relative value to the TCC
CONTROL
0
0
0
value and Digital Thermal Sensor value.
Temperature
Temperature
The value for T
individually. For the Quad-Core Intel® Xeon® Processor 5400 Series, the T
value is obtained by reading the processor model specific register
(IA32_TEMPERATURE_TARGET MSR).
Note: There is no T
The fan speed control device only needs to read the T
the DTS value from the PECI interface. The equation for calculating T
Equation 2-2.T
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 25
CONTROL
Where:
T
OFFSET
CONTROL_BASE
= -T
= A DTS-based value programmed into each processor during
Time
Time
CONTROL
OFFSET
manufacturing that can be obtained by reading the
IA32_TEMPERATURE_TARGET MSR. This is a static and a unique value.
Refer to the RS - Wolfdale Processor Family BIOS Writer’s Guide (BWG)
for further details.
is calibrated in manufacturing and configured for each processor
CONTROL
value to sum as previously required on legacy processors.
OFFSET MSR
and compare this to
CONTROL
is:
Page 26
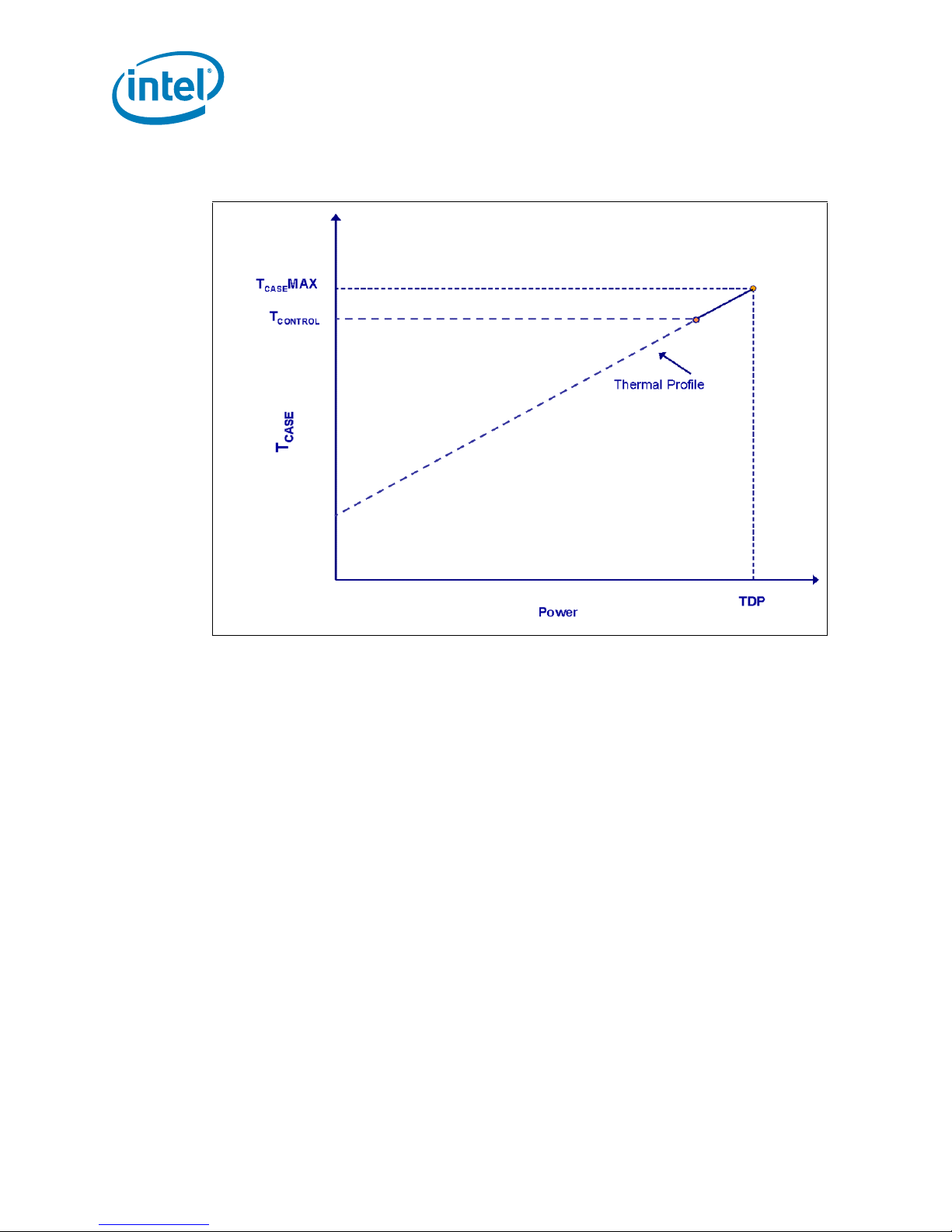
Thermal/Mechanical Reference Design
Figure 2-9. T
Figure 2-9 depicts the interaction between the Thermal Profile and T
CONTROL
and Thermal Profile Interaction
CONTROL
.
If the DTS temperature is less than T
CONTROL
, then the case temperature is permitted
to exceed the Thermal Profile, but the DTS temperature must remain at or below
T
CONTROL
T
CASE
T
CASE_MAX
Refer to Section 2.4.1 for the implementation of the T
. The thermal solution for the processor must be able to keep the processor’s
at or below the Thermal Profile when operating between the T
CONTROL
and
at TDP under heavy workload conditions.
CONTROL
value in support of fan
speed control (FSC) design to achieve better acoustic performance.
2.2.7 Thermal Profile Concepts for the Quad-Core Intel® Xeon®
Processor 5400 Series
2.2.7.1 Dual Thermal Profile Concept for the Quad-Core Intel® Xeon® Processor
X5400 Series
The Quad-Core Intel® Xeon® Processor X5400 Series is designed to go into various
form factors, including the volumetrically constrained 1U and custom blade form
factors. Due to certain limitations of such form factors (i.e. airflow, thermal solution
height), it is very challenging to meet the thermal requirements of the processor. To
mitigate these form factor constraints, Intel has developed a dual Thermal Profile
specification, shown in Figure 2-10.
26 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 27

Thermal/Mechanical Reference Design
Figure 2-10. Dual Thermal Profile Diagram
T
T
case_max_B
case_max_B
T
T
case_max_A
case_max_A
Thermal Profile B
Thermal Profile B
Thermal Profile A
Thermal Profile A
TDP
Power
Power
The Thermal Profile A is based on Intel’s 2U+ air cooling solution. Designing to Thermal
Profile A ensures that no measurable performance loss due to Thermal Control Circuit
(TCC) activation is observed in the processor. It is expected that TCC would only be
activated for very brief periods of time when running a worst-case real world
application in a worst-case thermal condition. These brief instances of TCC activation
are not expected to impact the performance of the processor. A worst case real world
application is defined as a commercially available, useful application which dissipates a
power equal to, or above, the TDP for a thermally relevant timeframe. One example of
a worst-case thermal condition is when a processor local ambient temperature is at or
above 42.8°C for Quad-Core Intel® Xeon® Processor X5400 Series Thermal Profile A.
Thermal Profile B supports volumetrically constrained platforms (i.e. 1U, blades, etc.),
and is based on Intel’s 1U air cooling solution. Because of the reduced capability
represented by such thermal solutions, designing to Thermal Profile B results in an
increased probability of TCC activation and an associated measurable performance loss.
Measurable performance loss is defined to be any degradation in the processor’s
performance greater than 1.5%. The 1.5% number is chosen as the baseline since the
run-to-run variation in a given performance benchmark is typically between 1 and 2%.
Although designing to Thermal Profile B results in increased T
compared to Thermal Profile A at a given power level, both of these Thermal Profiles
ensure that Intel’s long-term processor reliability requirements are satisfied. In other
words, designing to Thermal Profile B does not impose any additional risk to Intel’s
long-term reliability requirements. Thermal solutions that exceed Thermal Profile B
specification are considered incompliant and will adversely affect the long-term
reliability of the processor.
temperatures
CASE
TDP
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 27
Page 28

Thermal/Mechanical Reference Design
Refer to the Quad-Core Intel® Xeon® Processor 5400 Series Datasheet or
Section 2.2.8 for the Thermal Profile A and Thermal Profile B specifications. Section 2.5
of this document also provides details on the 2U+ and 1U Intel reference thermal
solutions that are designed to meet the Quad-Core Intel® Xeon® Processor X5400
Series Thermal Profile A and Thermal Profile B respectively.
2.2.7.2 Thermal Profile Concept for the Quad-Core Intel® Xeon® Processor
E5400/X5482 Series
The Quad-Core Intel® Xeon® Processor E5400 Series is designed to go into various
form factors, including the volumetrically constrained 1U and custom blade form
factors. The Quad-Core Intel® Xeon® Processor X5482 is designed to go into
volumetrically unconstrained workstation platforms only. Intel has developed single
thermal profile for E5400/X5482 Series.
Designing to the Thermal Profile ensures that no measurable performance loss due to
Thermal Control Circuit (TCC) activation is observed in the processor. It is expected
that TCC would only be activated for very brief periods of time when running a worstcase real world application in a worst-case thermal condition. These brief instances of
TCC activation are not expected to impact the performance of the processor. A worst
case real world application is defined as a commercially available, useful application
which dissipates a power equal to, or above, the TDP for a thermally relevant
timeframe. One example of a worst-case thermal condition is when a processor local
ambient temperature is at or above 43.2°C for Quad-Core Intel® Xeon® Processor
E5400 Series Thermal Profile.
Thermal solutions that exceed the Thermal Profile specification are considered
incompliant and will adversely affect the long-term reliability of the processor.
Refer to the Quad-Core Intel® Xeon® Processor 5400 Series Datasheet or
Section 2.2.8 for the Quad-Core Intel® Xeon® Processor 5400 Series Thermal Profile
specifications. Section 2.5 and Appendix A of this document provide details on 1U Intel
reference thermal solutions that are designed to meet the Quad-Core Intel® Xeon®
Processor E5400 Series Thermal Profile.
2.2.8 Performance Targets
The Thermal Profile specifications for this processor are published in the Quad-Core
Intel® Xeon® Processor 5400 Series Datasheet. These Thermal Profile specifications
are shown as a reference in the subsequent discussions.
28 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 29
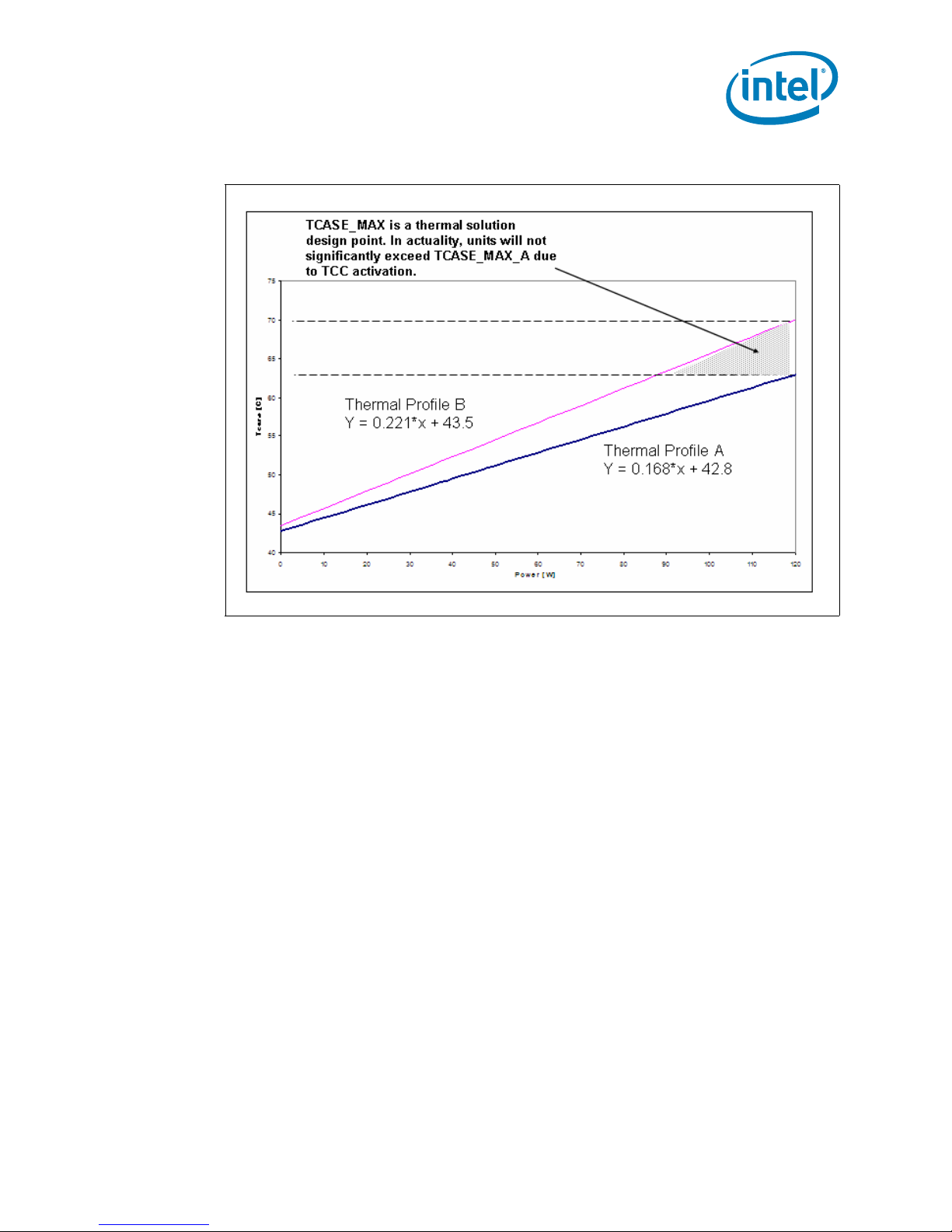
Thermal/Mechanical Reference Design
Figure 2-11. Thermal Profile for the Quad-Core Intel® Xeon® Processor X5400 Series
Notes:
1. The The thermal specifications shown in this graph are for Quad-Core Intel® Xeon® Processor X5400
Series except the Quad-Core Intel® Xeon® Processor X5482 sku.
2. Refer to the Quad-Core Intel® Xeon® Processor 5400 Series Datasheet for the Thermal Profile
specifications. In case of conflict, the data information in the datasheet supersedes any data in this figure.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 29
Page 30

Thermal/Mechanical Reference Design
Figure 2-12. Thermal Profile for Quad-Core Intel® Xeon® Processor E5400 Series
Note: The thermal specifications shown in this graph are for reference only. Refer to the Quad-Core Intel®
Xeon® Processor 5400 Series Datasheet for the Thermal Profile specifications. In case of conflict, the
data information in the datasheet supersedes any data in this figure.
30 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 31

Thermal/Mechanical Reference Design
Figure 2-13. Thermal Profile for Quad-Core Intel® Xeon® Processor X5482 Series
Thermal Profile (2U)
75
70
65
60
55
Tcase [C]
50
45
40
Thermal P r ofile
Y = 0.187*x + 35
35
0 102030405060708090100110120130140150
Pow er [W]
Ta b le 2 - 4 and Ta bl e 2- 5 describe the thermal performance target for the Quad-Core
Intel® Xeon® Processor 5400 Series cooling solution enabled by Intel.
Table 2-4. Intel Reference Heatsink Performance Targets for the Quad-Core Intel®
Xeon® Processor X5400 Series
Parameter Maximum Unit Notes
Altitude Sea-level m Heatsink designed at 0 meters
T
LA
TDP 120 W
T
CASE_MAX_A
Airflow 27
Pressure Drop 0.182
ψ
CA
T
CASE_MAX_B
Airflow 15
Pressure Drop 0.331
ψ
CA
40 °C
2U+ CEK, Thermal Profile A
63 °C
CFM
3
45.9
45.3
0.187 °C/W Mean + 3σ
1U CEK, Thermal Profile B
70 °C
25.5
82.4
0.246 °C/W Mean + 3σ
/ hr
m
Inches of H
Pa
CFM
3
m
/ hr
Inches of H
Pa
O
2
O
2
Airflow through the heatsink fins
Airflow through the heatsink fins
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 31
Page 32

Thermal/Mechanical Reference Design
Table 2-5. Intel Reference Heatsink Performance Targets for the Quad-Core Intel®
Xeon® Processor E5400 Series
Parameter Maximum Unit Notes
Altitude Sea-Level m Heatsink designed at 0 meters
T
LA
TDP
40 °C
80 W
1U CEK
T
CASE_MAX
Airflow
Pressure Drop
ψ
CA
T
CASE_MAX
Airflow
Pressure Drop
ψ
CA
67 °C
15
25.5
0.331
82.4
0.246 °C/W Mean + 3σ
1U Alternative Heatsink
67 °C
15
25.5
0.331
82.4
0.331 °C/W Mean + 3σ
CFM
3
/ hr
m
Inches of H
Pa
CFM
3
m
/ hr
Inches of H
Pa
2
2
Airflow through the heatsink fins
O
Airflow through the heatsink fins
O
Note: Intel does not enable reference heatsink for the Quad-Core Intel® Xeon®
Processor X5482 with 150W TDP. The Intel 2U CEK is capable of meeting the
thermal specification when local ambient temperature (TLA) is maintained at
or below 35°C.
2.3 Fan Fail Guidelines
Under fan failure or other anomalous thermal excursions, Tcase may exceed Thermal
Profile [Thermal Profile B for Quad-Core Intel® Xeon® Processor X5400 Series] for a
duration totaling less than 360 hours per year without affecting long term reliability
(life) of the processor. For more typical thermal excursions, Thermal Monitor is
expected to control the processor power level as long as conditions do not allow the
Tcase to exceed the temperature at which Thermal Control Circuit (TCC) activation
initially occurred. Under more severe anomalous thermal excursions when the
processor temperature cannot be controlled at or below this Tcase level by TCC
activation, then data integrity is not assured. At some higher threshold THERMTRIP#
will enable a shut down in an attempt to prevent permanent damage to the processor.
Thermal Test Vehicles (TTVs) may be used to check anomalous thermal excursion
compliance by ensuring that the processor Tcase value, as measured on the TTV, does
not exceed Tcase_max [Tcase_max_B for Quad-Core Intel® Xeon® Processor X5400
Series] at the anomalous power level for the environmental condition of interest. This
anomalous power level is equal to 80% of the TDP limit for Quad-Core Intel® Xeon®
Processor X5400 Series with 120W TDP and 90% of the TDP limit for Quad-Core Intel®
Xeon® Processor E5400 Series with 80W TDP.
Note: Fan Failure Guidelines apply only to SKUs which have Thermal Monitor2 enabled.
32 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 33

Thermal/Mechanical Reference Design
2.4 Characterizing Cooling Solution Performance
Requirements
2.4.1 Fan Speed Control
Fan speed control (FSC) techniques to reduce system level acoustic noise are a
common practice in server designs. The fan speed is one of the parameters that
determine the amount of airflow provided to the thermal solution. Additionally, airflow
is proportional to a thermal solution’s performance, which consequently determines the
of the processor at a given power level. Since the T
T
CASE
important parameter in the long-term reliability of a processor, the FSC implemented in
a system directly correlates to the processor’s ability to meet the Thermal Profile and
hence the long-term reliability requirements. For this purpose, the parameter called
T
CONTROL
as explained in Section 2.2.6, is to be used in FSC designs to ensure that the
long-term reliability of the processor is met while keeping the system level acoustic
noise down. Figure 2-14 depicts the relationship between T
methodology.
of a processor is an
CASE
CONTROL
and FSC
Figure 2-14. T
CONTROL
and Fan Speed Control
Once the T
CONTROL
reading from the processor can be compared to this T
control scheme can be implemented as described in Tabl e 2 - 6 without compromising
the long-term reliability of the processor.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 33
value is determined as explained earlier, the DTS temperature
CONTROL
value. A fan speed
Page 34

Thermal/Mechanical Reference Design
Table 2-6. Fan Speed Control, T
Condition FSC Scheme
DTS ≤ T
CONTROL
DTS >T
CONTROL
CONTROL
FSC can adjust fan speed to maintain DTS ≤ T
FSC should adjust fan speed to keep T
specification (increased acoustic region).
and DTS Relationship
CASE
(low acoustic region).
CONTROL
at or below the Thermal Profile
There are many different ways of implementing fan speed control, including FSC based
on processor ambient temperature, FSC based on processor Digital Thermal Sensor
(DTS) temperature or a combination of the two. If FSC is based only on the processor
ambient temperature, low acoustic targets can be achieved under low ambient
temperature conditions. However, the acoustics cannot be optimized based on the
behavior of the processor temperature. If FSC is based only on the Digital Thermal
Sensor, sustained temperatures above T
CONTROL
drives fans to maximum RPM. If FSC is
based both on ambient and Digital Thermal Sensor, ambient temperature can be used
to scale the fan RPM controlled by the Digital Thermal Sensor. This would result in an
optimal acoustic performance. Regardless of which scheme is employed, system
designers must ensure that the Thermal Profile specification is met when the processor
Digital Thermal Sensor temperature exceeds the T
CONTOL
value for a given processor.
2.4.2 Processor Thermal Characterization Parameter
Relationships
The idea of a “thermal characterization parameter”, Ψ (psi), is a convenient way to
characterize the performance needed for the thermal solution and to compare thermal
solutions in identical conditions (heating source, local ambient conditions). A thermal
characterization parameter is convenient in that it is calculated using total package
power, whereas actual thermal resistance, θ (theta), is calculated using actual power
dissipated between two points. Measuring actual power dissipated into the heatsink is
difficult, since some of the power is dissipated via heat transfer into the socket and
board. Be aware, however, of the limitations of lumped parameters such as Ψ when it
comes to a real design. Heat transfer is a three-dimensional phenomenon that can
rarely be accurately and easily modeled by lump values.
The case-to-local ambient thermal characterization parameter value (Ψ
measure of the thermal performance of the overall thermal solution that is attached to
the processor package. It is defined by the following equation, and measured in units of
°C/W:
Equation 2-3.Ψ
CA
= (T
CASE
- TLA) /
Where:
Ψ
T
T
= Case-to-local ambient thermal characterization parameter (°C/W).
CA
= Processor case temperature (°C).
CASE
= Local ambient temperature in chassis at processor (°C).
LA
TDP = TDP dissipation (W) (assumes all power dissipates through the
34 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
TDP
integrated heat spreader (IHS)).
) is used as a
CA
Page 35

Thermal/Mechanical Reference Design
The case-to-local ambient thermal characterization parameter of the processor, ΨCA, is
comprised of ΨCS, the TIM thermal characterization parameter, and of ΨSA, the sink-tolocal ambient thermal characterization parameter:
Equation 2-4.Ψ
= ΨCS + ΨSA
CA
Where:
Ψ
Ψ
= Thermal characterization parameter of the TIM (°C/W).
CS
= Thermal characterization parameter from heatsink-to-local ambient
SA
(°C/W).
is strongly dependent on the thermal conductivity and thickness of the TIM
Ψ
CS
between the heatsink and IHS.
is a measure of the thermal characterization parameter from the bottom of the
Ψ
SA
heatsink to the local ambient air. ΨSA is dependent on the heatsink material, thermal
conductivity, and geometry. It is also strongly dependent on the air velocity through
the fins of the heatsink.
Figure 2-15 illustrates the combination of the different thermal characterization
parameters.
Figure 2-15. Processor Thermal Characterization Parameter Relationships
2.4.2.1 Example
The cooling performance, Ψ
characterization parameter described above:
• Define a target case temperature T
processor datasheet.
• Define a target local ambient temperature at the processor, TLA.
The following provides an illustration of how one might determine the appropriate
performance targets. The example power and temperature numbers used here are not
related to any Intel processor thermal specifications, and are for illustrative purposes
only.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 35
is then defined using the principle of thermal
CA,
CASE_MAX
and corresponding TDP, given in the
Page 36

Thermal/Mechanical Reference Design
Assume the datasheet TDP is 85 W and the case temperature specification is 68 °C.
Assume as well that the system airflow has been designed such that the local processor
ambient temperature is 45°C. Then the following could be calculated using equation
(2-3) from above:
Equation 2-5.Ψ
CA
= (T
– TLA) / TDP = (68 – 45) / 85 = 0.27 °C/W
CASE
To determine the required heatsink performance, a heatsink solution provider would
need to determine Ψ
performance for the selected TIM and mechanical load
CS
configuration. If the heatsink solution was designed to work with a TIM material
performing at ΨCS ≤ 0.05 °C/W, solving for equation (2-4) from above, the performance
of the heatsink would be:
Equation 2-6.Ψ
= ΨCA − ΨCS = 0.27 − 0.05 = 0.22 °C/W
SA
If the local processor ambient temperature is assumed to be 40°C, the same
calculation can be carried out to determine the new case-to-ambient thermal
resistance:
Equation 2-7.ΨCA = (T
– TLA) / TDP = (68 – 40) / 85 = 0.33 °C/W
CASE
It is evident from the above calculations that, a reduction in the local processor
ambient temperature has a significant positive effect on the case-to-ambient thermal
resistance requirement.
2.4.3 Chassis Thermal Design Considerations
2.4.3.1 Chassis Thermal Design Capabilities and Improvements
One of the critical parameters in thermal design is the local ambient temperature
assumption of the processor. Keeping the external chassis temperature fixed, internal
chassis temperature rise is the only component that can affect the processor local
ambient temperature. Every degree gained at the local ambient temperature directly
translates into a degree relief in the processor case temperature.
Given the thermal targets for the processor, it is extremely important to optimize the
chassis design to minimize the air temperature rise upstream to the processor (T
rise
),
hence minimizing the processor local ambient temperature.
The heat generated by components within the chassis must be removed to provide an
adequate operating environment for both the processor and other system components.
Moving air through the chassis brings in air from the external ambient environment and
transports the heat generated by the processor and other system components out of
the system. The number, size and relative position of fans, vents and other heat
generating components determine the chassis thermal performance, and the resulting
ambient temperature around the processor. The size and type (passive or active) of the
thermal solution and the amount of system airflow can be traded off against each other
to meet specific system design constraints. Additional constraints are board layout,
spacing, component placement, and structural considerations that limit the thermal
solution size.
In addition to passive heatsinks, fan heatsinks and system fans, other solutions exist
for cooling integrated circuit devices. For example, ducted blowers, heat pipes and
liquid cooling are all capable of dissipating additional heat. Due to their varying
attributes, each of these solutions may be appropriate for a particular system
implementation.
36 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 37

Thermal/Mechanical Reference Design
To develop a reliable, cost-effective thermal solution, thermal characterization and
simulation should be carried out at the entire system level, accounting for the thermal
requirements of each component. In addition, acoustic noise constraints may limit the
size, number, placement, and types of fans that can be used in a particular design.
2.5 Thermal/Mechanical Reference Design
Considerations
2.5.1 Heatsink Solutions
2.5.1.1 Heatsink Design Considerations
To remove the heat from the processor, three basic parameters should be considered:
• The area of the surface on which the heat transfer takes place - Without any
enhancements, this is the surface of the processor package IHS. One method used
to improve thermal performance is by attaching a heatsink to the IHS. A heatsink
can increase the effective heat transfer surface area by conducting heat out of the
IHS and into the surrounding air through fins attached to the heatsink base.
• The conduction path from the heat source to the heatsink fins - Providing a
direct conduction path from the heat source to the heatsink fins and selecting
materials with higher thermal conductivity typically improves heatsink
performance. The length, thickness, and conductivity of the conduction path from
the heat source to the fins directly impact the thermal performance of the heatsink.
In particular, the quality of the contact between the package IHS and the heatsink
base has a higher impact on the overall thermal solution performance as processor
cooling requirements become strict. Thermal interface material (TIM) is used to fill
in the gap between the IHS and the bottom surface of the heatsink, and thereby
improves the overall performance of the thermal stackup (IHS-TIM-Heatsink). With
extremely poor heatsink interface flatness or roughness, TIM may not adequately
fill the gap. The TIM thermal performance depends on its thermal conductivity as
well as the pressure load applied to it. Refer to Section 2.5.2 for further information
on the TIM between the IHS and the heatsink base.
• The heat transfer conditions on the surface on which heat transfer takes
place - Convective heat transfer occurs between the airflow and the surface
exposed to the flow. It is characterized by the local ambient temperature of the air,
, and the local air velocity over the surface. The higher the air velocity over the
T
LA
surface, the resulting cooling is more efficient. The nature of the airflow can also
enhance heat transfer via convection. Turbulent flow can provide improvement over
laminar flow. In the case of a heatsink, the surface exposed to the flow includes the
fin faces and the heatsink base.
An active heatsink typically incorporates a fan that helps manage the airflow through
the heatsink.
Passive heatsink solutions require in-depth knowledge of the airflow in the chassis.
Typically, passive heatsinks see slower air speed. Therefore, these heatsinks are
typically larger (and heavier) than active heatsinks due to the increase in fin surface
required to meet a required performance. As the heatsink fin density (the number of
fins in a given cross-section) increases, the resistance to the airflow increases: it is
more likely that the air will travel around the heatsink instead of through it, unless air
bypass is carefully managed. Using air-ducting techniques to manage bypass area is an
effective method for maximizing airflow through the heatsink fins.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 37
Page 38

2.5.2 Thermal Interface Material
TIM application between the processor IHS and the heatsink base is generally required
to improve thermal conduction from the IHS to the heatsink. Many thermal interface
materials can be pre-applied to the heatsink base prior to shipment from the heatsink
supplier and allow direct heatsink attach, without the need for a separate TIM dispense
or attach process in the final assembly factory.
All thermal interface materials should be sized and positioned on the heatsink base in a
way that ensures the entire processor IHS area is covered. It is important to
compensate for heatsink-to-processor attach positional alignment when selecting the
proper TIM size.
When pre-applied material is used, it is recommended to have a protective application
tape over it. This tape must be removed prior to heatsink installation.
The TIM performance is susceptible to degradation (i.e. grease breakdown) during the
useful life of the processor due to the temperature cycling phenomena. For this reason,
the measured T
the type of TIM material.
Refer to Section 2.5.7.2 for information on the TIM used in the Intel reference heatsink
solution.
value of a given processor can decrease over time depending on
CASE
Thermal/Mechanical Reference Design
2.5.3 Summary
In summary, considerations in heatsink design include:
• The local ambient temperature T
dissipated by the processor, and the corresponding maximum T
These parameters are usually combined in a single lump cooling performance
parameter, ΨCA (case to air thermal characterization parameter). More information
on the definition and the use of Ψ
• Heatsink interface (to IHS) surface characteristics, including flatness and
roughness.
• The performance of the TIM used between the heatsink and the IHS.
• Surface area of the heatsink.
• Heatsink material and technology.
• Development of airflow entering and within the heatsink area.
• Physical volumetric constraints placed by the system.
• Integrated package/socket stackup height information is provided in the LGA771
Socket Mechanical Design Guide.
at the heatsink, airflow (CFM), the power being
LA
is given in Section 2.5 and Section 2.4.2.
CA
temperature.
CASE
38 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 39

Thermal/Mechanical Reference Design
2.5.4 Assembly Overview of the Intel Reference Thermal
Mechanical Design
The reference design heatsinks that meet the Quad-Core Intel® Xeon® Processor 5400
Series thermal performance targets are called the Common Enabling Kit (CEK)
heatsinks, and are available in 1U, 2U, & 2U+ form factors. Each CEK consists of the
following components:
• Heatsink (with captive standoff and screws)
• Thermal Interface Material (TIM)
•CEK Spring
2.5.4.1 Geometric Envelope
The baseboard keepout zones on the primary and secondary sides and height
restrictions under the enabling component region are shown in detail in Appendix B.
The overall volumetric keep in zone encapsulates the processor, socket, and the entire
thermal/mechanical enabling solution.
2.5.4.2 Assembly Drawing
Figure 2-16. Exploded View of CEK Thermal Solution Components
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 39
Page 40

Thermal/Mechanical Reference Design
The CEK reference thermal solution is designed to extend air-cooling capability through
the use of larger heatsinks with minimal airflow blockage and bypass. CEK retention
solution can allow the use of much heavier heatsink masses compared to the legacy
limits by using a load path directly attached to the chassis pan. The CEK spring on the
secondary side of the baseboard provides the necessary compressive load for the
thermal interface material. The baseboard is intended to be isolated such that the
dynamic loads from the heatsink are transferred to the chassis pan via the stiff screws
and standoffs. This reduces the risk of package pullout and solder-joint failures.
Using the CEK reference thermal solution, Intel recommends that the maximum
outside diameter dimension of the chassis pan standoffs, regardless of shape, that
interfaces with the CEK spring on the secondary side of the baseboard and captive
screws on the primary side of the baseboard to attach the heatsink to the chassis pan
should be no larger than 7.112 mm [0.28 in.]. For example, circular standoffs should
be no larger than 7.112 mm [0.28 in.] point-to-point.
The baseboard mounting holes for the CEK solution are at the same location as the hole
locations used for previous Intel
®
Xeon® processor thermal solution. However, CEK
assembly requires 10.16 mm [0.400 in.] large diameter holes to compensate for the
CEK spring embosses.
The CEK solution is designed and optimized for a baseboard thickness range of 1.57 –
2.31 mm [0.062-0.093 in]. While the same CEK spring can be used for this board
thickness range, the heatsink standoff height is different for a 1.57 mm [0.062 in] thick
board than it is for a 2.31 mm [0.093 in] thick board. In the heatsink assembly, the
standoff protrusion from the base of the heatsink needs to be 0.6 mm [0.024 in] longer
for a 2.31 mm [0.093 in] thick board, compared to a 1.57 mm [0.062 in] thick board.
If this solution is intended to be used on baseboards that fall outside of this range, then
some aspects of the design, including but not limited to the CEK spring design and the
standoff heights, may need to change. Therefore, system designers need to evaluate
the thermal performance and mechanical behavior of the CEK design on baseboards
with different thicknesses.
Refer to Appendix B for drawings of the heatsinks and CEK spring. The screws and
standoffs are standard components that are made captive to the heatsink for ease of
handling and assembly.
Contact your Intel field sales representative for an electronic version of mechanical and
thermal models of the CEK (Pro/Engineer*, IGES and Icepak*, Flotherm* formats).
Pro/Engineer, Icepak and Flotherm models are available on Intel Business Link (IBL).
Note: Intel reserves the right to make changes and modifications to the design as necessary.
Note: The thermal mechanical reference design for the Quad-Core Intel® Xeon® Processor
5400 Series was verified according to the Intel validation criteria given in Appendix E.1.
Any thermal mechanical design using some of the reference components in
combination with any other thermal mechanical solution needs to be fully validated
according to the customer criteria. Also, if customer thermal mechanical validation
criteria differ from the Intel criteria, the reference solution should be validated against
the customer criteria.
2.5.4.3 Structural Considerations of CEK
As Intel explores methods of keeping thermal solutions within the air-cooling space, the
mass of the thermal solutions is increasing. Due to the flexible nature (and associated
large deformation) of baseboard-only attachments, Intel reference solutions, such as
40 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 41

Thermal/Mechanical Reference Design
CEK, are now commonly using direct chassis attach (DCA) as the mechanical retention
design. The mass of the new thermal solutions is large enough to require consideration
for structural support and stiffening on the chassis.
2.5.5 Thermal Solution Performance Characteristics
Figure 2-17 and Figure 2-18 show the performance of the 2U+ and 1U passive
heatsinks, respectively. These figures show the thermal performance and the pressure
drop through fins of the heatsink versus the airflow provided. The best-fit equations for
these curves are also provided to make it easier for users to determine the desired
value without any error associated with reading the graph.
Figure 2-17. 2U+ CEK Heatsink Thermal Performance
If other custom heatsinks are intended for use with the Quad-Core Intel® Xeon®
Processor 5400 Series, they must support the following interface control requirements
to be compatible with the reference mechanical components:
• Requirement 1: Heatsink assembly must stay within the volumetric keep-in.
• Requirement 2: Maximum mass and center of gravity.
Current maximum heatsink mass is 1000 grams [2.2 lbs] and the maximum center of
gravity 3.81 cm [1.5 in.] above the bottom of the heatsink base.
• Requirement 3: Maximum and minimum compressive load.
Any custom thermal solution design must meet the loading specification as
documented within this document, and should refer to the Quad-Core Intel® Xeon®
Processor 5400 Series Datasheet and LGA771 Socket Mechanical Design Guide for
specific details on package/socket loading specifications.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 41
Page 42

Figure 2-18. 1U CEK Heatsink Thermal Performance
Thermal/Mechanical Reference Design
2.5.6 Thermal Profile Adherence
The 2U+ CEK Intel reference thermal solution is designed to meet the Thermal Profile A
for the Quad-Core Intel® Xeon® Processor 5400 Series. From Tabl e 2- 4 , the threesigma (mean+3sigma) performance of the thermal solution is computed to be 0.187
°C/W and the processor local ambient temperature (T
°C. Hence, the Thermal Profile equation for this thermal solution is calculated as:
Equation 2-8.y = 0.187*X + 40
where,
y = Processor T
x = Processor power value (W)
Figure 2-19 below shows the comparison of this reference thermal solution’s Thermal
Profile to the Quad-Core Intel® Xeon® Processor 5400 Series Thermal Profile A
specification. The 2U+ CEK solution meets the Thermal Profile A with a 0.6°C margin at
the upper end (TDP). By designing to Thermal Profile A, it is ensured that no
measurable performance loss due to TCC activation is observed under the given
environmental conditions.
value (°C)
CASE
) for this thermal solution is 40
LA
42 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 43

Thermal/Mechanical Reference Design
Temper
atu
re(
Figure 2-19. 2U+CEK Thermal Adherence to Quad-Core Intel® Xeon® Processor X5400
Series Thermal Profile A
65
60
T
CASE_MAX_B
@ TDP
)
C
55
50
45
40
05101520 25 30 35 40 45 50 55 60 65 70 75 80
The 1U CEK Intel reference thermal solution is designed to meet the Thermal Profile B
for the Quad-Core Intel® Xeon® Processor X5400 Series. From Tabl e 2 - 7 the threesigma (mean+3sigma) performance of the thermal solution is computed to be
0.246°C/W and the processor local ambient temperature (T
is 40 °C. Hence, the Thermal Profile equation for this thermal solution is calculated as:
Equation 2-9.y = 0.246*X + 40
where,
y = Processor T
x = Processor power value (W)
Thermal Profile A
Y = 0.168 * X + 42.8
value (°C)
CASE
2U C EK R eference Solution
Y = 0.187 * X + 40
Power (W)
) for this thermal solution
LA
90 100 110
120
TDP
Figure 2-20 below shows the comparison of this reference thermal solution’s Thermal
Profile to the Quad-Core Intel® Xeon® Processor X5400 Series Thermal Profile
specification. The 1U CEK solution meets the Thermal Profile B with 0.5°C margin at
the upper end (TDP). However, as explained in Section 2.2.7, designing to Thermal
Profile B results in increased TCC activation and measurable performance loss for the
processor.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 43
Page 44

Thermal/Mechanical Reference Design
Figure 2-20. 1U CEK Thermal Adherence to Quad-Core Intel® Xeon® Processor X5400
Series Thermal Profile B
70
65
60
T
CASE_MAX_B
@ TDP
Thermal Profile B
)
C
55
Y = 0.221 * X + 43.5
1U CE K Reference Solution
Y = 0.246 * X + 40
50
Temp erature (
45
40
05101520 25 30 35 40 45 50 55 60 65 70 75 80
Power (W)
90 100 110
120
TDP
The 1U CEK Intel reference thermal solution is designed to meet the Thermal Profile
specification for the Quad-Core Intel® Xeon® Processor E5400 Series. From Ta b le 2- 7
the three-sigma (mean+3sigma) performance of the thermal solution is computed to
be 0.246 °C/W and the processor local ambient temperature (T
) for this thermal
LA
solution is 40 °C. Hence, the Thermal Profile equation for this thermal solution is
calculated as:
Equation 2-10.y = 0.246*X + 40
where,
y = Processor T
value (°C)
CASE
x = Processor power value (W)
Figure 2-21 below shows the comparison of this reference thermal solution’s Thermal
Profile to the Quad-Core Intel® Xeon® Processor E5400 Series Thermal Profile
specification. The 1U CEK solution meets the Thermal Profile with 7.3°C margin at the
upper end (TDP). By designing to Quad-Core Intel® Xeon® Processor E5400 Series
Thermal Profile, it is ensured that no measurable performance loss due to TCC
activation is observed under the given environmental conditions.
44 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 45

Thermal/Mechanical Reference Design
Figure 2-21. 1U CEK Thermal Adherence to Quad-Core Intel® Xeon® Processor E5400
Series Thermal Profile
T
65
60
CASE_MAX
@ TDP
Thermal Profile
Y = 0.298 * X + 43.2
55
)
C
50
1U CEK Reference Solution
Tcase (
45
40
35
0510
20 25 30 35 40
15
Y = 0.246 * X + 40
45
50
55
60 65 70 75 80
Note: Intel has also developed an 1U alternative reference heatsink design. This
alternative heatsink design meets the thermal profile specifications of the
Quad-Core Intel® Xeon® Processor E5400 Series and offers the advantages of
weight reduction and cost savings. Refer to Appendix B for detail information.
2.5.7 Components Overview
2.5.7.1 Heatsink with Captive Screws and Standoffs
The CEK reference heatsink uses snapped-fin technology for its design. It consists of a
copper base and copper fins with Shin-Etsu* G751 thermal grease as the TIM. The
mounting screws and standoffs are also made captive to the heatsink base for ease of
handling and assembly as shown in Figure 2-22 and Figure 2-23 for the 2U+ and 1U
heatsinks, respectively.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 45
Page 46

Figure 2-22. Isometric View of the 2U+ CEK Heatsink
Thermal/Mechanical Reference Design
.
Note: Refer to Appendix B for more detailed mechanical drawings of the heatsink.
Figure 2-23. Isometric View of the 1U CEK Heatsink
Note: Refer to Appendix B for more detailed mechanical drawings of the heatsink.
The function of the standoffs is to provide a bridge between the chassis and the
heatsink for attaching and load carrying. When assembled, the heatsink is rigid against
the top of the standoff, and the standoff is rigid to a chassis standoff with the CEK
spring firmly sandwiched between the two. In dynamic loading situations the standoff
carries much of the heatsink load, especially in lateral conditions, when compared to
the amount of load transmitted to the processor package. As such, it is comprised of
steel. The distance from the bottom of the heatsink to the bottom of the standoff is
8.79 mm [0.346 in.] for a board thickness of 1.57 mm [0.062 in]. The standoff will
need to be modified for use in applications with a different board thickness, as defined
in Section 2.5.4.2.
The function of the screw is to provide a rigid attach method to sandwich the entire CEK
assembly together, activating the CEK spring under the baseboard, and thus providing
the TIM preload. A screw is an inexpensive, low profile solution that does not negatively
impact the thermal performance of the heatsink due to air blockage. Any fastener
(i.e. head configuration) can be used as long as it is of steel construction; the head
does not interfere with the heatsink fins, and is of the correct length of 20.64 mm
[0.8125 in.].
46 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 47

Thermal/Mechanical Reference Design
Although the CEK heatsink fits into the legacy volumetric keep-in, it has a larger
footprint due to the elimination of retention mechanism and clips used in the older
enabled thermal/mechanical components. This allows the heatsink to grow its base and
fin dimensions, further improving the thermal performance. A drawback of this
enlarged size and use of copper for both the base and fins is the increased weight of
the heatsink. The retention scheme employed by CEK is designed to support heavy
heatsinks (approximately up to 1000 grams) in cases of shock, vibration and
installation as explained in Appendix E. Some of the thermal and mechanical
characteristics of the CEK heatsinks are shown in Ta b le 2-7 .
Table 2-7. CEK Heatsink Thermal Mechanical Characteristics
Size
2U+ 50.80 [2.00] 1.0 [2.2] 45.9 [27] 0.177 0.0033 45.3 [0.182]
1U 27.00 [1.06] 0.53 [1.2] 25.5 [15] 0.240 0.0023 82.4 [0.331]
Height Weight
(mm) [in.] (kg) [lbs]
Target
Airflow
Through Fins
3
(m
/hr)
[CFM]
Mean Ψ
(°C/W) (°C/W) (Pa) [in H
2.5.7.2 Thermal Interface Material (TIM)
A TIM must be applied between the package and the heatsink to ensure thermal
conduction. The CEK reference design uses Shin-Etsu G751 thermal grease.
The recommended grease dispense weight to ensure full coverage of the processor IHS
is given below. For an alternate TIM, full coverage of the entire processor IHS is
recommended.
Table 2-8. Recommended Thermal Grease Dispense Weight
Processor Minimum Maximum Units Notes
TIM Dispense weight 400 mg Shin-Etsu* G751. Dispense
TIM loading provided
by CEK
It is recommended that you use thermally conductive grease. Thermally conductive
grease requires special handling and dispense guidelines. The following guidelines
apply to Shin-Etsu G751 thermal grease. For guidance with your specific application,
please contact the vendor. Vendor information is provided in Appendix F. The use of a
semi-automatic dispensing system is recommended for high volume assembly to
ensure an accurate amount of grease is dispensed on top of the IHS prior to assembly
of the heatsink. A typical dispense system consists of an air pressure and timing
controller, a hand held output dispenser, and an actuation foot switch. Thermal grease
in cartridge form is required for dispense system compatibility. A precision scale with
an accuracy of ±5 mg is recommended to measure the correct dispense weight and set
the corresponding air pressure and duration. The IHS surface should be free of foreign
materials prior to grease dispense.
18
80
30
133
lbf
N
ca
Deviation Ψ
Standard
weight is an approximate target.
Generated by the CEK.
Pressure Drop
ca
2
O]
Additional recommendations include recalibrating the dispense controller settings after
any two hour pause in grease dispense. The grease should be dispensed just prior to
heatsink assembly to prevent any degradation in material performance. Finally, the
thermal grease should be verified to be within its recommended shelf life before use.
The CEK reference solution is designed to apply a compressive load of up to 133 N
[30 lbf] on the TIM to improve the thermal performance.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 47
Page 48

2.5.7.3 CEK Spring
The CEK spring, which is attached on the secondary side of the baseboard, is made
from 0.80 mm [0.0315 in.] thick 301 stainless steel half hard. Any future versions of
the spring will be made from a similar material. The CEK spring has four embosses
which, when assembled, rest on the top of the chassis standoffs. The CEK spring is
located between the chassis standoffs and the heatsink standoffs. The purpose of the
CEK spring is to provide compressive preload at the TIM interface when the baseboard
is pushed down upon it. This spring does not function as a clip of any kind. The two
tabs on the spring are used to provide the necessary compressive preload for the TIM
when the whole solution is assembled. The tabs make contact on the secondary side of
the baseboard. In order to avoid damage to the contact locations on the baseboard, the
tabs are insulated with a 0.127 mm [0.005 in.] thick Kapton* tape (or equivalent).
Figure 2-24 shows an isometric view of the CEK spring design.
Figure 2-24. CEK Spring Isometric View
Thermal/Mechanical Reference Design
Figure 2-25. Isometric View of CEK Spring Attachment to the Base Board
Please refer to Appendix B for more detailed mechanical drawings of the CEK spring.
Also, the baseboard keepout requirements shown in Appendix B must be met to use
this CEK spring design.
48 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Secondary
Secondary
Primary
Primary
Page 49

Thermal/Mechanical Reference Design
2.5.8 Boxed Active Thermal Solution for the Quad-Core Intel®
Xeon® Processor 5400 Series Thermal Profile
Intel will provide a 2U passive and a 1U passive/active heatsink solution for boxed
Quad-Core Intel® Xeon® Processor 5400 Series. This active heatsink solution is
primarily designed to be used in a pedestal chassis where sufficient air inlet space is
present and side directional airflow is not an issue. This active heatsink solution
consists of a 4 wire PWM fan and a 1U passive heatsink compatible with 1U form factors
both mechanically and thermally. These solutions are intended for system integrators
who build systems from components available through distribution channels. The
retention solution used for these products is called the CEK. The CEK base is
compatible with all the heatsink solutions.
Figure 2-26 provides a representation of the active CEK solution. This design is based
on a 4-pin PWM PECI/DTS controlled active fan heatsink solution. PWM (Pulse Width
Modulation also synonymous with Pulse Duration Modulation PDM) is a modulation in
which the duration of pulse is varied in accordance with some characteristic of the
modulating signal. This solution is being offered to help provide better control over
pedestal chassis acoustics. This is achieved though accurate measurement of processor
temperature through the processor’s Digital Thermal Sensor (DTS) temperature. Fan
RPM is modulated through the use of an ASIC (Application Specific Integrated Circuit)
located on the serverboard, that sends out a PWM control signal to the 4
connector labeled as Control.
th
pin of the
This heatsink solution also requires a constant +12 V supplied to pin 2 and does not
support variable voltage control or 3-pin PWM control. If no PWM signal is detected on
th
the 4
pin this heatsink solution will revert back to thermistor control mode,
supporting both the 4-wire PWM and standard 3-wire ambient air control methods.
The active heatsink solution will not exceed a mass of approximately 1050 grams. Note
that this is per processor, so a dual processor system will have up to approximately
2100 grams total mass in the heatsinks. This large mass will require a minimum
chassis stiffness to be met in order to withstand force during shock and vibration.
Figure 2-26. Boxed Active CEK Heatsink Solutions with PWM/DTS Control
(Representation Only)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 49
Page 50

Clearance is required around the heatsink to ensure unimpeded airflow for proper
cooling. The physical baseboard keepout requirements for the active solution are the
same as the passive CEK solution shown in Appendix B. Refer to Figure B-18 through
Figure B-20 for additional details on the active CEK thermal solution volumetrics.
2.5.8.1 Fan Power Supply
The active heatsink includes a fan, which requires a +12 V power supply. Platforms
must provide a matched fan power header to support the boxed processor. Tab l e 2 - 9
contains specifications for the input and output signals at the heatsink fan connector.
The fan outputs a SENSE signal, an open-collector output, which pulses at a rate of two
pulses per fan revolution. A baseboard pull-up resistor provides VCC to match the
baseboard-mounted fan speed monitor requirements, if applicable. Use of the SENSE
signal is optional. If the SENSE signal is not used, pin 3 of the connector should be tied
to GND.
Thermal/Mechanical Reference Design
It is recommended that a 4 pin fan header be used on the baseboard, in addition to, a
control ASIC that can send a PWM signal to the active fan heatsink solution on the 4
pin, at a nominal 25 KHz frequency. If a 3-pin CPU fan header is used instead, the
active fan heatsink solution will revert back to an automatic ambient air temperature
control mode.
The fan power header on the baseboard must be positioned to allow the fan heatsink
power cable to reach it. The fan power header identification and location must be
documented in the supplier’s platform documentation, or on the baseboard itself. The
baseboard fan power header should be positioned within 177.8 mm [7 in.] from the
center of the processor socket.
Table 2-9. Fan Specifications (Boxed 4-wire PWM/DTS Heatsink Solution)
Description Min
+12V: 12 Volt Fan Power
Supply
IC: Fan Current Draw N/A 1.25 1.5 1.5 A
SENSE: SENSE Frequency 2 2 2 2 Pulses per fan revolution 1
Note: System board should pull this pin up to VCC with a resistor.
10.8 12 12 13.2 V
Typ
Steady
Max
Steady
Max
Startup
Unit Notes
Figure 2-27. Fan Cable Connection (Active CEK)
th
50 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 51

Thermal/Mechanical Reference Design
Table 2-10. Fan Cable Connector Pin Out (Active CEK)
Pin Number Signal Color
1 Ground (Constant) Black
2 Power (+12V) Yellow
3 Signal: 2 pulses per revolution Green
4 Control 21KHz - 28KHz Blue
2.5.8.2 Systems Considerations Associated with the Active CEK
This heatsink was designed to help pedestal chassis users to meet the processor
thermal requirements without the use of chassis ducting. It may be necessary to
implement some form of chassis air guide or air duct to meet the T
40 °C depending on the pedestal chassis layout. Also, while the active heatsink solution
is designed to mechanically fit into a 2U chassis, it may require additional space at the
top of the heatsink to allow sufficient airflow into the heatsink fan. Therefore, additional
design criteria may need to be considered if this heatsink is used in a 2U rack mount
chassis, or in a chassis that has drive bay obstructions above the inlet to the fan
heatsink.
Thermal Profile A should be used to help determine the thermal performance of the
platform. The primary recommended control method for this solution is using pulse
width modulation control. This control method requires the motherboard provide the
correct PWM duty cycle to the active fan heatsink solution to properly follow the
thermal profile. If no PWM signal is detected the active heatsink solution will default
back to a thermistor controlled mode and the fan will automatically adjust fan RPM to
meet the thermal profile.
temperature of
LA
It is critical to supply a constant +12 V to the fan header so that the active CEK
heatsink solution can operate properly. If a system board has a jumper setting to select
either a constant +12 V power to the fan header or a variable voltage, it is strongly
recommended that the jumper be set by default to the constant +12 V setting.
It is recommended that the ambient air temperature outside of the chassis be kept at
or below 35 °C. The air passing directly over the processor heatsink should not be
preheated by other system components. Meeting the processor’s temperature
specification is the responsibility of the system integrator.
2.5.8.3 Boxed Processor Contents
A direct chassis attach method must be used to avoid problems related to shock and
vibration, due to the weight of the heatsink required to cool the processor. The board
must not bend beyond specification in order to avoid damage. The boxed processor
contains the components necessary to solve both issues. The boxed processor will
include the following items:
• Quad-Core Intel® Xeon® Processor 5400 Series
• Unattached heatsink solution
• 4 screws, 4 springs, and 4 heatsink standoffs (all captive to the heatsink)
• Thermal Interface Material (pre-applied on heatsink)
• Installation Manual
•Intel Inside
®
logo
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 51
Page 52

Thermal/Mechanical Reference Design
The other items listed in Figure 2-16 that are required to complete this solution will be
shipped with either the chassis or boards. They are as follows:
• CEK Spring (supplied by baseboard vendors)
• Heatsink standoffs (supplied by chassis vendors)
§
52 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 53

1U Alternative Heatsink Thermal/Mechanical Design
A1U Alternative Heatsink
Thermal/Mechanical Design
Intel has also developed an 1U alternative reference heatsink design for the
volumetrically constrained form factor and targeted for the rack-optimized and ultra
dense SKUs. This alternative heatsink design meets the thermal profile specifications of
the Quad-Core Intel® Xeon® Processor E5400 Series and offers the advantages of
weight reduction and cost savings in using this alternative 1U heatsink.
This section describes the alternative heatsink thermal performance and adherence to
Quad-Core Intel® Xeon® Processor E5400 Series thermal profile specifications.
A.1 Component Overview
The alternative 1U reference heatsink is an extruded aluminum heatsink and shares the
same volumetric footprint as the 1U CEK heatsink. It reuses Intel 1U CEK Captive
standoff/screws, Thermal Interface Material (TIM) and Spring.
Figure A-1 shows the isometric view of the 1U alternative heatsink.
Figure A-1. Isometric View of the 1U Alternative Heatsink
Note: Refer to Appendix B for more detailed mechanical drawings of the heatsink.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 53
Page 54

1U Alternative Heatsink Thermal/Mechanical Design
A.2 Thermal Solution Performance Characterics
Figure A-2 shows the performance of the 1U alternative heatsink. This figure shows the
thermal performance and the pressure drop through fins of the heatsink versus the
airflow provided. The best-fit equations for these curves are also provided to make it
easier for users to determine the desired value without any error associated with
reading the graph.
Figure A-2. 1U Alternative Heatsink Thermal Performance
Table A-1. 1U Alternative Heatsink Thermal Mechanical Characteristics
Size
1U 27.00
Height Weight Target Airflow
(mm) [in.] (kg) [lbs] (m
[1.06]
Mean Ψ
Through Fins
3
/hr) [CFM] (°C/W) (°C/W)
0.24 [0.53] 25.5 [15] 0.305 0.0087 85 [0.34]
ca
Standard
Deviation Ψ
ca
Pressure
Drop
(Pa) [in
H
O]
2
A.3 Thermal Profile Adherence
The 1U alternative thermal solution is designed to meet the Thermal Profile for the
Quad-Core Intel® Xeon® Processor E5400 Series in volumetrically constrained form
factors. From Tab le A- 1 the three-sigma (mean+3sigma) performance of the thermal
solution is computed to be 0.331 °C/W and the processor local ambient temperature
) for this thermal solution is 40 °C. Hence, the Thermal Profile equation for this
(T
LA
thermal solution is calculated as:
Equation A-1. y = 0.331*x + 40
where,
y = Processor T
54 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
value (°C)
CASE
Page 55

1U Alternative Heatsink Thermal/Mechanical Design
x = Processor power value (W)
Figure A-3 below shows the comparison of this reference thermal solution’s Thermal
Profile to the Quad-Core Intel® Xeon® Processor E5400 Series Thermal Profile
specification. The 1U alternative solution meets the Thermal Profile with 0.5°C margin
at the upper end (TDP). By designing to Thermal Profile, it is ensured that no
measurable performance loss due to TCC activation is observed under the given
environmental conditions.
Figure A-3. 1U Alternative Heatsink Thermal Adherence to Quad-Core Intel® Xeon®
Processor L5400 Series Thermal Profile
65
60
55
)
C
50
Tcase (
45
40
35
0510
T
CASE_MAX
@ TDP
Y = 0.298 * X + 43.2
20 25 30 35 40
15
Thermal Profile
§
1U Alternative Heatsink
Y = 0.331 * X + 40
45
55
50
60 65 70 75 80
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 55
Page 56

1U Alternative Heatsink Thermal/Mechanical Design
56 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 57

Mechanical Drawings
B Mechanical Drawings
The mechanical drawings included in this appendix refer to the thermal mechanical
enabling components for the Quad-Core Intel® Xeon® Processor 5400 Series.
Note: Intel reserves the right to make changes and modifications to the design as necessary.
Table B-1. Mechanical Drawing List
Drawing Description Figure Number
“2U CEK Heatsink (Sheet 1 of 4)” Figure B-1
“2U CEK Heatsink (Sheet 2 of 4)” Figure B-2
“2U CEK Heatsink (Sheet 3 of 4)” Figure B-3
“2U CEK Heatsink (Sheet 4 of 4)” Figure B-4
“CEK Spring (Sheet 1 of 3)” Figure B-5
“CEK Spring (Sheet 2 of 3)” Figure B-6
“CEK Spring (Sheet 3 of 3)” Figure B-7
“Baseboard Keepout Footprint Definition and Height Restrictions for Enabling Components
(Sheet 1 of 6)”
“Baseboard Keepout Footprint Definition and Height Restrictions for Enabling Components
(Sheet 2 of 6)”
“Baseboard Keepout Footprint Definition and Height Restrictions for Enabling Components
(Sheet 3 of 6)”
“Baseboard Keepout Footprint Definition and Height Restrictions for Enabling Components
(Sheet 4 of 6)”
“Baseboard Keepout Footprint Definition and Height Restrictions for Enabling Components
(Sheet 5 of 6)”
“Baseboard Keepout Footprint Definition and Height Restrictions for Enabling Components
(Sheet 6 of 6)”
“1U CEK Heatsink (Sheet 1 of 4)” Figure B-14
“1U CEK Heatsink (Sheet 2 of 4)” Figure B-15
“1U CEK Heatsink (Sheet 3 of 4)” Figure B-16
“1U CEK Heatsink (Sheet 4 of 4)” Figure B-17
“Active CEK Thermal Solution Volumetric (Sheet 1 of 3)” Figure B-18
“Active CEK Thermal Solution Volumetric (Sheet 2 of 3)” Figure B-19
“Active CEK Thermal Solution Volumetric (Sheet 3 of 3)” Figure B-20
“1U Alternative Heatsink (1 of 4)” Figure B-21
“1U Alternative Heatsink (2 of 4)” Figure B-22
“1U Alternative Heatsink (3 of 4)” Figure B-23
“1U Alternative Heatsink (4 of 4)” Figure B-24
Figure B-8
Figure B-9
Figure B-10
Figure B-11
Figure B-12
Figure B-13
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 57
Page 58

Figure B-1. 2U CEK Heatsink (Sheet 1 of 4)
Mechanical Drawings
58 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 59

Mechanical Drawings
Figure B-2. 2U CEK Heatsink (Sheet 2 of 4)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 59
Page 60

Figure B-3. 2U CEK Heatsink (Sheet 3 of 4)
Mechanical Drawings
60 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 61

Mechanical Drawings
Figure B-4. 2U CEK Heatsink (Sheet 4 of 4)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 61
Page 62

Figure B-5. CEK Spring (Sheet 1 of 3)
Mechanical Drawings
62 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 63

Mechanical Drawings
Figure B-6. CEK Spring (Sheet 2 of 3)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 63
Page 64

Figure B-7. CEK Spring (Sheet 3 of 3)
Mechanical Drawings
64 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 65

Mechanical Drawings
Figure B-8. Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 1 of 6)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 65
Page 66

Mechanical Drawings
Figure B-9. Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 2 of 6)
66 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 67

Mechanical Drawings
Figure B-10. Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 3 of 6)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 67
Page 68

Mechanical Drawings
Figure B-11. Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 4 of 6)
68 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 69

Mechanical Drawings
Figure B-12. Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 5 of 6)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 69
Page 70

Mechanical Drawings
Figure B-13. Baseboard Keepout Footprint Definition and Height Restrictions for
Enabling Components (Sheet 6 of 6)
70 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 71

Mechanical Drawings
Figure B-14. 1U CEK Heatsink (Sheet 1 of 4)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 71
Page 72

Figure B-15. 1U CEK Heatsink (Sheet 2 of 4)
Mechanical Drawings
72 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 73

Mechanical Drawings
Figure B-16. 1U CEK Heatsink (Sheet 3 of 4)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 73
Page 74

Figure B-17. 1U CEK Heatsink (Sheet 4 of 4)
Mechanical Drawings
74 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 75

Mechanical Drawings
Figure B-18. Active CEK Thermal Solution Volumetric (Sheet 1 of 3)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 75
Page 76

Figure B-19. Active CEK Thermal Solution Volumetric (Sheet 2 of 3)
Mechanical Drawings
76 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 77

Mechanical Drawings
Figure B-20. Active CEK Thermal Solution Volumetric (Sheet 3 of 3)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 77
Page 78

Figure B-21. 1U Alternative Heatsink (1 of 4)
Mechanical Drawings
78 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 79

Mechanical Drawings
Figure B-22. 1U Alternative Heatsink (2 of 4)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 79
Page 80

Figure B-23. 1U Alternative Heatsink (3 of 4)
Mechanical Drawings
80 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 81

Mechanical Drawings
Figure B-24. 1U Alternative Heatsink (4 of 4)
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 81
Page 82

Mechanical Drawings
§
82 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 83

Heatsink Clip Load Methodology
C Heatsink Clip Load
Methodology
C.1 Overview
This section describes a procedure for measuring the load applied by the heatsink/clip/
fastener assembly on a processor package.
This procedure is recommended to verify the preload is within the design target range
for a design, and in different situations. For example:
• Heatsink preload for the LGA771 socket.
• Quantify preload degradation under bake conditions.
Note: This document reflects the current metrology used by Intel. Intel is continuously
exploring new ways to improve metrology. Updates will be provided later as this
document is revised as appropriate.
C.2 Test Preparation
C.2.1 Heatsink Preparation
Three load cells are assembled into the base of the heatsink under test, in the area
interfacing with the processor Integrated Heat Spreader (IHS), using load cells
equivalent to those listed in Section C.2.2.
To install the load cells, machine a pocket in the heatsink base, as shown in Figure C-1
and Figure C-2. The load cells should be distributed evenly, as close as possible to the
pocket walls. Apply wax around the circumference of each load cell and the surface of
the pocket around each cell to maintain the load cells in place during the heatsink
installation on the processor and motherboard.
The depth of the pocket depends on the height of the load cell used for the test. It is
necessary that the load cells protrude out of the heatsink base. However, this
protrusion should be kept minimal, as it will create an additional load offset since the
heatsink base is artificially raised. The measurement load offset depends on the whole
assembly stiffness (i.e. motherboard, clip, fastener, etc.). For example, the Quad-Core
Intel® Xeon® Processor 5400 Series CEK Reference Heatsink Design clip and fasteners
assembly have a stiffness of around 160 N/mm [915 lb/in]. If the resulting protrusion
is 0.038 mm [0.0015”], then a extra load of 6.08 N [1.37 lb] will be created, and will
need to be subtracted from the measured load. Figure C-3 shows an example using the
Quad-Core Intel® Xeon® Processor 5400 Series CEK Reference Heatsink designed for
the Quad-Core Intel® Xeon® Processor 5400 Series in the 771–land LGA package.
Note: When optimizing the heatsink pocket depth, the variation of the load cell height should
also be taken into account to make sure that all load cells protrude equally from the
heatsink base. It may be useful to screen the load cells prior to installation to minimize
variation.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 83
Page 84

Heatsink Clip Load Methodology
Alternate Heatsink Sample Preparation
As just mentioned, making sure that the load cells have minimum protrusion out of the
heatsink base is paramount to meaningful results. An alternate method to make sure
that the test setup will measure loads representative of the non-modified design is:
• Machine the pocket in the heatsink base to a depth such that the tips of the load
cells are just flush with the heatsink base.
• Then machine back the heatsink base by around 0.25 mm [0.01”], so that the load
cell tips protrude beyond the base.
Proceeding this way, the original stack height of the heatsink assembly should be
preserved. This should not affect the stiffness of the heatsink significantly.
Figure C-1. Load Cell Installation in Machined Heatsink Base Pocket - Bottom View
Heatsink Base
Heatsink Base
Pocket
Pocket
Diam et er ~
Diam et er ~
29 mm
29 mm
[~1.15”]
[~1.15”]
Package IHS
Package IHS
Outline (Top
Outline (Top
Surface)
Surface)
Load
Load
Cells
Cells
84 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 85

Heatsink Clip Load Methodology
Load Cells (3x)
Preload Fixture (copper
core with milled out pocket)
Figure C-2. Load Cell Installation in Machined Heatsink Base Pocket - Side View
Wax to maintain load cell in
Wax to maintain load cell in
position during heatsink
Height of
Height of
pocket ~ height
pocket ~ height
of selected
of selected
load cell
load cell
position during heatsink
installation
installation
Figure C-3. Preload Test Configuration
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 85
Page 86

C.2.2 Typical Test Equipment
For the heatsink clip load measurement, use equivalent test equipment to the one
listed Ta b le C - 1.
Table C-1. Typical Test Equipment
Item Description Part Number (Model)
Load cell
Notes: 1, 5
Data Logger
(or scanner)
Notes: 2, 3, 4
Notes:
1. Select load range depending on expected load level. It is usually better, whenever possible, to operate in
the high end of the load cell capability. Check with your load cell vendor for further information.
2. Since the load cells are calibrated in terms of mV/V, a data logger or scanner is required to supply 5 volts
DC excitation and read the mV response. An automated model will take the sensitivity calibration of the
load cells and convert the mV output into pounds.
3. With the test equipment listed above, it is possible to automate data recording and control with a 6101-PCI
card (GPIB) added to the scanner, allowing it to be connected to a PC running LabVIEW* or Vishay's
StrainSmart* software.
4. IMPORTANT: In addition to just a zeroing of the force reading at no applied load, it is important to
calibrate the load cells against known loads. Load cells tend to drift. Contact your load cell vendor for
calibration tools and procedure information.
5. When measuring loads under thermal stress (bake for example), load cell thermal capability must be
checked, and the test setup must integrate any hardware used along with the load cell. For example, the
Model 13 load cells are temperature compensated up to 71 °C, as long as the compensation package
(spliced into the load cell's wiring) is also placed in the temperature chamber. The load cells can handle up
to 121 °C (operating), but their uncertainty increases according to 0.02% rdg/°F.
Honeywell*-Sensotec* Model 13 subminiature load cells,
compression only
Select a load range depending on load level being tested.
www.sensotec.com
Vishay* Measurements Group Model 6100 scanner with a
6010A strain card (one card required per channel).
Heatsink Clip Load Methodology
AL322BL
Model 6100
C.2.3 Test Procedure Examples
The following sections give two examples of load measurement. However, this is not
meant to be used in mechanical shock and vibration testing.
Any mechanical device used along with the heatsink attach mechanism will need to be
included in the test setup (i.e., back plate, attach to chassis, etc.).
Prior to any test, make sure that the load cell has been calibrated against known loads,
following load cell vendor’s instructions.
C.2.4 Time-Zero, Room Temperature Preload Measurement
1. Pre-assemble mechanical components on the board as needed prior to mounting
the motherboard on an appropriate support fixture that replicate the board attach
to a target chassis.
For example: If the attach mechanism includes fixtures on the back side of the
board, those must be included, as the goal of the test is to measure the load
provided by the actual heatsink mechanism.
2. Install the test vehicle in the socket.
3. Assemble the heatsink reworked with the load cells to motherboard as shown for
the Quad-Core Intel® Xeon® Processor 5400 Series CEK-reference heatsink
example in Figure C-3, and actuate attach mechanism.
4. Collect continuous load cell data at 1 Hz for the duration of the test. A minimum
time to allow the load cell to settle is generally specified by the load cell vendors
86 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 87

Heatsink Clip Load Methodology
(often on the order of 3 minutes). The time zero reading should be taken at the end
of this settling time.
5. Record the preload measurement (total from all three load cells) at the target time
and average the values over 10 seconds around this target time as well, i.e. in the
interval for example over [target time – 5 seconds; target time + 5 seconds].
C.2.5 Preload Degradation under Bake Conditions
This section describes an example of testing for potential clip load degradation under
bake conditions.
1. Preheat thermal chamber to target temperature (45 ºC or 85 ºC for example).
2. Repeat time-zero, room temperature preload measurement.
3. Place unit into preheated thermal chamber for specified time.
4. Record continuous load cell data as follows:
Sample rate = 0.1 Hz for first 3 hrs
Sample rate = 0.01 Hz for the remainder of the bake test
5. Remove assembly from thermal chamber and set into room temperature conditions
6. Record continuous load cell data for next 30 minutes at sample rate of 1 Hz.
§
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 87
Page 88

Heatsink Clip Load Methodology
88 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 89

Safety Requirements
D Safety Requirements
Heatsink and attachment assemblies shall be consistent with the manufacture of units
that meet the safety standards:
1. UL Recognition-approved for flammability at the system level. All mechanical and
thermal enabling components must be a minimum UL94V-2 approved.
2. CSA Certification. All mechanical and thermal enabling components must have CSA
certification.
3. Heatsink fins must meet the test requirements of UL1439 for sharp edges.
§
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 89
Page 90

Safety Requirements
90 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 91

Quality and Reliability Requirements
E Quality and Reliability
Requirements
E.1 Intel Verification Criteria for the Reference
Designs
E.1.1 Reference Heatsink Thermal Verification
The Intel reference heatsinks will be verified within specific boundary conditions using a
TTV and the methodology described in the Intel® Xeon® Dual- and Multi- Processor
Family Thermal Test Vehicle User's Guide.
The test results, for a number of samples, are reported in terms of a worst-case mean
+ 3σ value for thermal characterization parameter using real processors (based on the
TTV correction offset).
E.1.2 Environmental Reliability Testing
E.1.2.1 Structural Reliability Testing
The Intel reference heatsinks will be tested in an assembled condition, along with the
LGA771 Socket. Details of the Environmental Requirements, and associated stress
tests, can be found in the LGA771 Socket Mechanical Design Guide.
The use condition environment definitions provided in Appendix E-1are based on
speculative use condition assumptions, and are provided as examples only.
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 91
Page 92

Table E-1. Use Conditions Environment
Quality and Reliability Requirements
Use Environment
Shipping and
Handling
Shipping and
Handling
Speculative Stress
Condition
Mechanical Shock
• System-level
•Unpackaged
•Trapezoidal
• 25 g
• velocity change is based
on packaged weight
Product
Weight (l bs )
< 20 lbs
20 to > 40
40 to > 80
80 to < 100
100 to <
120
≥120
†
Change in velocity is based
upon a 0.5 coefficient of
restitution.
Random Vibration
• System Level
•Unpackaged
• 5 Hz to 500 Hz
• 2.20 g RMS random
• 5 Hz @ .001 g
20 Hz @ 0.01 g
(slope up)
• 20 Hz to 500 Hz @ 0.01
2
/Hz (flat)
g
• Random control limit
tolerance is ± 3 dB
Nonpalletized
Product
Velo ci ty
†
Change
sec)
250
225
205
175
145
125
2
/Hz to
2
/Hz
(in/
Example Use
Condition
Total of 12
drops per
system:
•2 drops per
axis
•± direction
Total per
system:
• 10 minutes
per axis
•3 axes
Example 7-Yr
Stress Equiv.
n/a n/a
n/a n/a
Example 10-
Yr Stress
Equiv.
Note: In the case of a discrepancy, information in the most recent LGA771 Socket Mechanical Design
Guidelines supersedes that in the Table E-1 above.
E.1.2.2 Recommended Test Sequence
Each test sequence should start with components (i.e. baseboard, heatsink assembly,
etc.) that have not been previously submitted to any reliability testing.
The test sequence should always start with a visual inspection after assembly, and
BIOS/Processor/memory test. The stress test should be then followed by a visual
inspection and then BIOS/Processor/memory test.
E.1.2.3 Post-Test Pass Criteria
The post-test pass criteria are:
1. No significant physical damage to the heatsink and retention hardware.
2. Heatsink remains seated and its bottom remains mated flatly against the IHS
surface. No visible gap between the heatsink base and processor IHS. No visible tilt
of the heatsink with respect to the retention hardware.
92 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 93

Quality and Reliability Requirements
3. No signs of physical damage on baseboard surface due to impact of heatsink.
4. No visible physical damage to the processor package.
5. Successful BIOS/Processor/memory test of post-test samples.
6. Thermal compliance testing to demonstrate that the case temperature specification
can be met.
E.1.2.4 Recommended BIOS/Processor/Memory Test Procedures
This test is to ensure proper operation of the product before and after environmental
stresses, with the thermal mechanical enabling components assembled. The test shall
be conducted on a fully operational baseboard that has not been exposed to any
battery of tests prior to the test being considered.
Testing setup should include the following components, properly assembled and/or
connected:
• Appropriate system baseboard.
• Processor and memory.
• All enabling components, including socket and thermal solution parts.
The pass criterion is that the system under test shall successfully complete the
checking of BIOS, basic processor functions and memory, without any errors. Intel PC
Diags is an example of software that can be utilized for this test.
E.1.3 Material and Recycling Requirements
Material shall be resistant to fungal growth. Examples of non-resistant materials
include cellulose materials, animal and vegetable based adhesives, grease, oils, and
many hydrocarbons. Synthetic materials such as PVC formulations, certain
polyurethane compositions (e.g. polyester and some polyethers), plastics which contain
organic fillers of laminating materials, paints, and varnishes also are susceptible to
fungal growth. If materials are not fungal growth resistant, then MIL-STD-810E,
Method 508.4 must be performed to determine material performance.
Material used shall not have deformation or degradation in a temperature life test.
Any plastic component exceeding 25 grams should be recyclable per the European Blue
Angel recycling standards.
The following definitions apply to the use of the terms lead-free, Pb-free, and RoHS
compliant.
Lead-free and Pb-free: Lead has not been intentionally added, but lead may still
exist as an impurity below 1000 ppm.
RoHS compliant: Lead and other materials banned in RoHS Directive are either (1)
below all applicable substance thresholds as proposed by the EU or (2) an approved/
pending exemption applies.
Note: RoHS implementation details are not fully defined and may change.
§
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 93
Page 94

Quality and Reliability Requirements
94 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 95

Enabled Suppliers Information
FEnabled Suppliers
Information
F.1 Supplier Information
F.1.1 Intel Enabled Suppliers
The Intel reference enabling solution for Quad-Core Intel® Xeon® Processor 5400
Series is preliminary. The Intel reference solutions have not been verified to meet the
criteria outlined in Appendix E. Customers can purchase the Intel reference thermal
solution components from the suppliers listed in Tabl e F - 1.
For additional details, please refer to the Quad-Core Intel® Xeon® Processor 5400
Series thermal mechanical enabling components drawings in Appendix B.
Table F-1. Suppliers for the Quad-Core Intel® Xeon® Processor 5400 Series Intel
Reference Solution (Sheet 1 of 2)
Assembly Component Description
CEK771-01-2U
(for 2U, 2U+)
CEK Heatsink
Intel Reference
Heatsink p/n
C61708 rev03
Intel Boxed
Heatsink p/n
D36871
CEK Heatsink
Intel Boxed
Heatsink p/n
D36871
Thermal Interface
Material
CEK Spring for
LGA771 socket
Intel p/n D13646
rev04
CEK Spring for
LGA771 socket
Intel p/n D13646
rev04
Copper Fin, Copper
Base
includes PCM45F
TIM+cover
Copper Fin, Copper
Base
includes PCM45F
TIM+cover
Grease Shin-Etsu G751
Stainless Steel 301,
Kapton* Tape on
Reinforced Spring
Fingers
Stainless Steel 301,
Kapton* Tape on
Reinforced Spring
Fingers
Development
Suppliers
Fujikura
CNDA# 1242012
(stacked fin)
Furukawa
CNDA# 65755
(Crimped fin)
CNDA 75610
AVC
CNDA# AP5281
ITW Fastex
CNDA# 78538
Supplier Contact Info
Fujikura America
Ash Ooe
a_ooe@fujikura.com
408-748-6991
Fujikura Taiwan Branch
Yao-Hsien Huang
yeohsien@fujikuratw.com.tw
886(2)8788-4959
Tim Yu
Yu@FurukawaAmerica.com
408-345-1520
Johnson Tseng
Johnson@tfe.com.tw
(02)2563-8148x15
Randy Isaacson
risaacson@microsi.com
(480) 893-8898x113
Steve Huang (APAC)
+86-755-3366-8888 x66888
+86-138-252-45215
steve@avc.com.cn
Huabin Chen (China Only)
+886-755-3366-8888 x66871
huabin@avc.com.cn
Roger Knell
rknell@itwfastex.com
773-307-9035
Henry Lu
henry@mail.itwasia.com.tw
886-7-881-9206x10
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 95
Page 96

Enabled Suppliers Information
Table F-1. Suppliers for the Quad-Core Intel® Xeon® Processor 5400 Series Intel
Reference Solution (Sheet 2 of 2)
Assembly Component Description
CEK771-01-1U
(for 1U)
CEK771-02-1U
(for 1U)
CEK Heatsink
Intel p/n C90546
rev02
Thermal Interface
Material
CEK Spring for
CEK771
CEK Low Cost
Heatsink for Mid
and Low Power
SKUs
Intel p/n D71537
Rev 02
Thermal Interface
Material
CEK Spring for
CEK771
Copper Fin, Copper
Base
See CEK771-01-2U
See CEK771-01-2U
Aluminum
Extrusion
See CEK771-01-2U
See CEK771-01-2U
Development
Suppliers
Fujikura
CNDA# 1242012
(stacked fin)
Asia Vital
Components (AVC)
CNDA# AP5281
Supplier Contact Info
Fujikura America
Ash Ooe
a_ooe@fujikura.com
408-748-6991
Fujikura Taiwan Branch
Yao-Hsien Huang
yeohsien@fujikuratw.com.tw
886(2)8788-4959
Steve Huang (APAC)
+86-755-3366-8888 x66888
+86-138-252-45215
steve@avc.com.cn
Huabin Chen (China Only)
+886-755-3366-8888 x66871
huabin@avc.com.cn
Note: CEK771-02-1U is the 1U alternative reference heatsink design for Quad-Core Intel® Xeon® Processor
E5400 Series in volumetrically constrained form factors.
F.1.2 Additional Suppliers
The Intel enabled solutions for Quad-Core Intel® Xeon® Processor 5400 Series are
preliminary. The Intel enabled solutions have not been verified to meet the criteria
outlined in Appendix E. Customers can purchase the Intel enabled thermal solution
components from the suppliers listed in Tab l e F - 1and Ta bl e F - 2.
For additional details, please refer to the Quad-Core Intel® Xeon® Processor 5400
Series thermal mechanical enabling components drawings in Appendix B.
96 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Page 97

Enabled Suppliers Information
Table F-2. Additional Suppliers for the Quad-Core Intel® Xeon® Processor 5400 Series
Intel Reference Solution (Sheet 1 of 2)
Assembly Component Description
2U Heatsink Alternative CEK
Heatsink
Copper Fin,
Copper Base
Copper Fin,
Copper Base
- and -
Aluminum
Copper Fin,
Copper Base
- and -
Aluminum
Copper Fin,
Copper Base
- and -
Development
Suppliers
Aavid
Thermalloy
CNDA#2525071
ADDA
Corporation
CNDA#AP1249
Asia Vital Components
(AVC)
CNDA# AP5281
Auras
CNDA#5779699
Supplier Contact Info
David Huang
huang@aavid.com
603-223-1724
Frank Hsue
frank.hsu@aavid.com.tw
886-2-26989888 x306
Jungpin Chen
jungpin@adda.com.tw
886-2-82212252x232
Steve Huang (APAC)
+86-755-3366-8888 x66888
+86-138-252-45215
steve@avc.com.cn
Huabin Chen (China Only)
+886-755-3366-8888 x66871
huabin@avc.com.cn
Ian Shih
liverpool@auras.com.tw
+886-937-183-194
Aluminum
Copper Fin,
Copper Base
- and -
Aluminum
Aluminum CoolJag (Chia Cherne
Copper Fin,
Copper Base
Copper Fin,
Copper Base
- and -
Aluminum
Copper Fin,
Copper Base
CCI (Chaun-Choung
Technology Co. Ltd.)
CNDA#8747572
Industry Co., Ltd.)
CoolerMaster
CNDA#7425225
Taisol Electronics
CNDA #3434254
Thermaltake
CNDA#7429482
Monica Chih
monica_chih@ccic.com.tw
8862-29952666 EXT 292
Harry Lin
714-739-5797
ackinc@aol.com
Alice Yang
+886-4-7323090
alice@cooljag.com
Kenny Kwa ng
510-824-0888
kenny@cooljagusa.com
Helena Wen
helena_wen@collermaster.com.tw
+886-2-3234-0050x235
Jane Yui
jane.yui@taisol.com.tw
+886-2-2656-2658 x113
Vera Lee
vera@thermaltake.com
+886-2-2662-6501-255
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 97
Page 98

Enabled Suppliers Information
Table F-2. Additional Suppliers for the Quad-Core Intel® Xeon® Processor 5400 Series
Intel Reference Solution (Sheet 2 of 2)
Assembly Component Description
1U Heatsink Alternative CEK
Heatsink
Copper Fin,
Copper Base
Copper Fin,
Copper Base
- and -
Aluminum
Copper Fin,
Copper Base
- and -
Aluminum
Copper Fin,
Copper Base
- and Aluminum
Copper Fin,
Copper Base
- and -
Aluminum
Aluminum CoolJag (Chia Cherne
Development
Suppliers
Aavid
Thermalloy
CNDA#2525071
ADDA
CNDA# AP1249
Asia Vital Components
(AVC)
CNDA# AP5281
Auras
CNDA#5779699
CCI (Chaun-Choung
Technology Co. Ltd.)
CNDA# 8747572
Industry Co., Ltd.)
Supplier Contact Info
David Huang
huang@aavid.com
603-223-1724
Frank Hsue
frank.hsu@aavid.com.tw
886-2-26989888 x306
Jungpin Chen
jungpin@adda.com.tw
886-2-82212252-232
Steve Huang (APAC)
+86-755-3366-8888 x66888
+86-138-252-45215
steve@avc.com.cn
Huabin Chen (China Only)
+886-755-3366-8888 x66871
huabin@avc.com.cn
Ian Shih
liverpool@auras.com.tw
886-2-89901653 x314
Monica Chih
monica_chih@ccic.com.tw
886-2-29952666x292
Harry Lin
ackinc@aol.com
714-739-5797
Alice Yang
+886-4-7323090
alice@cooljag.com
98 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
Copper Fin,
Copper Base
Copper Fin,
Copper Base
- and -
Aluminum
Copper Fin,
Copper Base
- and Aluminum
Copper Fin,
Copper Base
- and Aluminum
CoolerMaster
CNDA#7425225
Molex
CNDA#11277
Taisol Electronics
CNDA #3434254
Thermaltake
CNDA#7429482
Kenny Kwang
510-824-0888
kenny@cooljagusa.com
Helena Wen
helena_wen@collermaster.com.tw
+886-2-3234-0050x235
Aljo Amorelli
Aljo.Amorelli@molex.com
630-718-5919
Jeremy Shen
+886-2-26202300-459
+886-926132586
Jane Yui
jane.yui@taisol.com.tw
+886-2-2656-2658 x113
Vera Lee
vera@thermaltake.com
+886-2-2662-6501-255
Page 99

Enabled Suppliers Information
§
Quad-Core Intel® Xeon® Processor 5400 Series TMDG 99
Page 100

Enabled Suppliers Information
100 Quad-Core Intel® Xeon® Processor 5400 Series TMDG
 Loading...
Loading...