Page 1

INTEGRATED CIRCUITS
DATA SH EET
TZA3043; TZA3043B
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
Product specification
Supersedes data of 1998 Jul 08
File under Integrated Circuits, IC19
2000 Mar 28
Page 2

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
FEATURES
• Wide dynamic range, typically 2.5 µA to 1.5 mA
• Low equivalent input noise, typically 5.7 pA/√Hz
• Differential transimpedance of 8.3 kΩ
• Wide bandwidth from DC to 950 MHz
• Differential outputs
• On-chip Automatic Gain Control (AGC)
• No external components required
• Single supply voltage from 3.0 to 5.5 V
• Bias voltage for PIN diode
• Pin compatible with TZA3023 and SA5223
• Switched output polarity available (B-version).
ORDERING INFORMATION
TYPE
NUMBER
TZA3043T SO8 plastic small outline package; 8 leads; body width 3.9 mm SOT96-1
TZA3043U − bare die in waffle pack carriers; die dimensions 1.030 × 1.300 mm −
TZA3043BT SO8 plastic small outline package; 8 leads; body width 3.9 mm SOT96-1
TZA3043BU − bare die in waffle pack carriers; die dimensions 1.030 × 1.300 mm −
NAME DESCRIPTION VERSION
APPLICATIONS
• Digital fibre optic receiver in medium and long haul
optical telecommunications transmission systems or in
high speed data networks
• Wideband RF gain block.
GENERAL DESCRIPTION
The TZA3043 is a high speed transimpedance amplifier
with AGC designed to be used in Gigabit Ethernet/Fibre
Channel opticallinks. It amplifies the current generated by
a photo detector (PIN diode or avalanchephotodiode) and
converts it to a differential output voltage.
PACKAGE
2000 Mar 28 2
Page 3
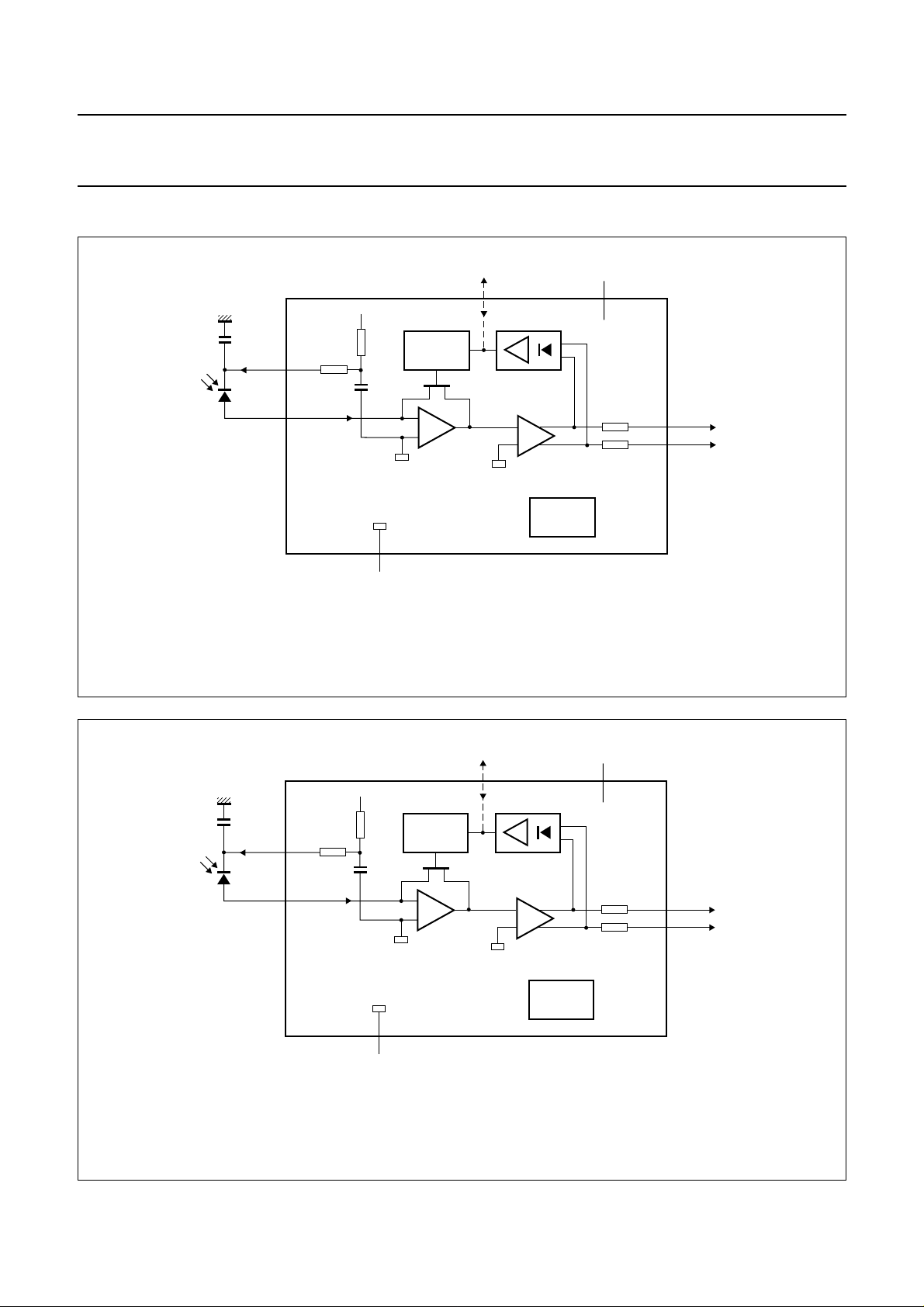
Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
BLOCK DIAGRAM
handbook, full pagewidth
V
CC
1 nF
125 Ω
1 (1)
DREF
3 (4)IPhoto
TZA3043T
TZA3043U
125 Ω
10 pF
GND
GAIN
CONTROL
A1
low noise
amplifier single-ended to
2, 4, 5 (2, 3, 5, 6, 7, 8)
(1)
AGC
peak detector
differential converter
A2
BIASING
TZA3043; TZA3043B
V
CC
8 (11, 12)(13)
(10) 7 OUTQ
(9) 6 OUT
MGU096
The numbers in brackets refer to the pad numbers of the bare die version.
(1) AGC analog I/O (pad 13) is only available on the TZA3043U.
Fig.1 Block diagram of TZA3043T and TZA3043U.
handbook, full pagewidth
V
CC
1 nF
DREF
125 Ω
1 (1)
3 (4)IPhoto
TZA3043BT
TZA3043BU
125 Ω
CONTROL
10 pF
2, 4, 5 (2, 3, 5, 6, 7, 8)
GND
(1)
AGC
GAIN
peak detector
A1
low noise
amplifier single-ended to
A2
differential converter
BIASING
V
CC
8 (11, 12)(13)
(9) 6
OUTQ
(10) 7
OUT
MGU097
The numbers in brackets refer to the pad numbers of the bare die version.
(1) AGC analog I/O (pad 13) is only available on the TZA3043BU.
Fig.2 Block diagram of TZA3043BT and TZA3043BU.
2000 Mar 28 3
Page 4

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
PINNING
SYMBOL
PIN
TZA3043T
DREF 1111analog
GND 2 2 2, 3 2, 3 ground ground
IPhoto 3344analog
GND 4 4 5, 6 5, 6 ground ground
GND 5 5 7, 8 7, 8 ground ground
OUT 6 7 9 10 data
OUTQ 7 6 10 9 data
V
CC
8 8 11, 12 11, 12 supply supply voltage
AGC −−13 13 input/
PIN
TZA3043BT
PAD
TZA3043U
PAD
TZA3043BU
TYPE DESCRIPTION
bias voltage for PIN diode; cathode
output
should be connected to this pin
current input; anode of PIN diode
input
should be connected to this pin;
DC bias levelof 822 mV is one diode
voltage above ground
data output; pin OUT goes HIGH
output
when current flows into pin IPhoto
compliment of pin OUT
output
AGC analog I/O
output
TZA3043; TZA3043B
handbook, halfpage
Fig.3 Pin configuration of TZA3043T.
DREF
IPhoto
GND
1
2
TZA3043T
3
4
MGR287
V
8
CC
OUTQGND
7
OUT
6
GND
5
handbook, halfpage
DREF
IPhoto
GND
1
2
TZA3043BT
3
4
MGU098
8
7
6
5
V
CC
OUTGND
OUTQ
GND
Fig.4 Pin configuration of TZA3043BT.
2000 Mar 28 4
Page 5

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
FUNCTIONAL DESCRIPTION
The TZA3043 is a transimpedance amplifier intended for
use in fibre optic links for signal recovery in Fibre Channel
or Gigabit Ethernet applications. It amplifies the current
generated by a photo detector (PIN diode or avalanche
photodiode) and transforms it into a differential output
voltage. The most important characteristics of the
TZA3043 are high receiver sensitivity and wide dynamic
range. High receiver sensitivity is achieved by minimizing
noise in the transimpedance amplifier.
Input circuit
The signal current generated by a PIN diode can vary
between 2.5 µA to 1.5 mA (p-p).
An AGC loop isimplemented tomake it possible to handle
such a wide dynamic range. The AGC loop increases the
dynamic range of the receiver by reducing the feedback
resistance of the preamplifier.
TZA3043; TZA3043B
The AGC loop hold capacitor is integrated on-chip, so an
external capacitor is not needed for AGC.
AGC monitoring
The AGC voltage can be monitored at pad 13 on the bare
die (TZA3043U/TZA3043BU). Pad 13 is not bonded in the
packaged device (TZA3043T/TZA3043BT). This pad can
beleftunconnected during normal operation.It canalsobe
used to force an external AGC voltage. If pad 13 (AGC) is
connected to GND, the internal AGC loop is disabled and
the receiver gain is at a maximum. The maximum input
current is then approximately 75 µA.
Output circuit
A differential amplifier converts the output of the
preamplifier to a differential voltage (see Fig.5).
The logic level symbol definitions for the differential
outputs are shown in Fig.6.
handbook, full pagewidth
handbook, full pagewidth
V
CC
V
O(max)
V
V
V
O(min)
800 Ω 800 Ω
2 mA
Fig.5 Differential data output circuit.
OQH
V
OH
OQL
V
OL
V
OO
4.5 mA
30 Ω
30 Ω
4.5 mA
MGR290
V
CC
V
o(p-p)
MGR243
OUTQ
OUT
Fig.6 Logic level symbol definitions for data outputs OUT and OUTQ.
2000 Mar 28 5
Page 6

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
PIN diode bias voltage DREF
The transimpedance amplifier together with the PIN diode
determines the performance of an optical receiver for a
large extent. Especiallyhow thePIN diode is connected to
the input and the layout around the input pin influence the
key parameters like sensitivity, the bandwidth and the
Power Supply Rejection Ratio (PSRR) of a
transimpedance amplifier. The total capacitance at the
inputpin is critical to obtainthehighest sensitivity. It should
be kept to a minimum by reducing the capacitance of the
PIN diode and the parasitics around the input pin. The
PIN diode should be placed very close to the IC to reduce
the parasitics. Because the capacitance of the PIN diode
depends on the reverse voltage across it, the reverse
voltage should be chosen as high as possible.
The PIN diode can be connected to the input in two ways
as shown in Figs 7 and 8. In Fig.7 the PIN diode is
connected between pins DREF and IPhoto. Pin DREF
provides an easy bias voltage for the PIN diode. The
voltage at DREF is derived from VCC by a low-pass filter.
The low-pass filter consisting of the internal resistors
R1, R2, C1 and the external capacitor C2 rejects the
supply voltage noise.The external capacitor C2 should be
equal or larger then 1 nF for a high PSRR.
TZA3043; TZA3043B
The reverse voltage across the PIN diode is 4.18 V
(5 − 0.82 V) for 5 V supply or 2.48 V (3.3 − 0.82 V) for
3.3 V supply.
It is preferable to connect the cathode of the PIN diode to
a higher voltage then VCC when such a voltage source is
available on the board. In this case pin DREF can be left
unconnected.Whenanegativesupply voltage is available,
the configuration in Fig.8 can be used. It should be noted
that in this case the direction of the signal current is
reversed compared tothe Fig.7. Properfiltering of the bias
voltage for the PIN diode is essential to achieve the
highest sensitivity level.
V
CC
8
R1
125 Ω
C1
10 pF
MGU103
C2
1 nF
I
i
DREF
IPhoto
R2
125 Ω
1
3
TZA3043
Fig.7 ThePIN diodeconnectedbetweentheinput
and pin DREF.
2000 Mar 28 6
V
CC
8
R1
125 Ω
C1
10 pF
MGU104
1
DREF
IPhoto
3
I
i
negative supply voltage
R2
125 Ω
TZA3043
Fig.8 ThePIN diodeconnectedbetweentheinput
and a negative supply voltage.
Page 7

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
AGC
The TZA3043 transimpedance amplifier can handle input
currents from 1 µA to 1.5 mA. This means a dynamic
range of 63 dB. At low input currents, the transimpedance
must be high to get enough output voltage, and the noise
should be low enough to guaranty minimum bit error rate.
At high input currents however, the transimpedance
should be low to avoid pulse width distortion. This means
that the gain of the amplifier has to vary depending on the
input signal level to handle such a wide dynamic range.
This is achieved in the TZA3043 by implementing an
Automatic Gain Control (AGC) loop. The AGC loop
consists of a peak detector, a hold capacitor and a gain
control circuit.
The peak amplitude of the signal is detected by the peak
detector and it is stored on the holdcapacitor. The voltage
over the hold capacitor is compared to a threshold level.
Thethreshold level is setto25 µA (p-p)input current. AGC
becomes active only for input signals larger than the
threshold level.
TZA3043; TZA3043B
It is disabled for smaller signals. The transimpedance is
then at its maximum value (8.3 kΩ differential).
When AGC is active, the feedback resistor of the
transimpedance amplifier is reduced to keep the output
voltage constant. The transimpedance is regulated from
8.3 kΩ at low currents (I < 30 µA) to 1 kΩ at high currents
(I < 500 µA). Above 500 µA the transimpedance is at its
minimum and can not be reduced further but the front-end
remains linear until input currents of 1.5 mA.
The upper part of Fig.9 shows the output voltages of the
TZA3043 (OUT and OUTQ) as a function of the DC input
current. In the lower part, the difference of both voltages is
shown. It can be seen from the figure that the output
changes linearly up to 25 µA input current where AGC
becomes active. From this point on, AGC tries to keep the
differential output voltage constant around 200 mV for
medium range input currents (input currents <200 µA).
The AGC can not regulate any more above 500 µA input
current and the output voltage rises again with the input
current.
3.9
handbook, full pagewidth
V
o
(V)
3.7
3.5
3.3
3.1
600
V
o(dif)
(mV)
400
200
0
110
V
o(dif)=VOUT
(1) VCC=3V.
(2) VCC= 3.3 V.
(3) VCC=5V.
− V
OUTQ
MGU105
V
OUT
VCC = 5 V
V
OUTQ
(1)
(2)
(3)
10
.
2
3
10
Ii (µA)
4
10
Fig.9 AGC characteristics.
2000 Mar 28 7
Page 8

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
LIMITING VALUES
In accordance with the Absolute Maximum Rating System (IEC 60134).
SYMBOL PARAMETER MIN. MAX. UNIT
V
CC
V
n
I
n
P
tot
T
stg
T
j
T
amb
supply voltage −0.5 +6 V
DC voltage
pin/pad IPhoto −0.5 +1 V
pins/pads OUT and OUTQ −0.5 V
pad AGC (bare die only) −0.5 V
pin/pad DREF −0.5 V
+ 0.5 V
CC
+ 0.5 V
CC
+ 0.5 V
CC
DC current
pin/pad IPhoto −2.5 +2.5 mA
pins/pads OUT and OUTQ −15 +15 mA
pad AGC (bare die only) −0.2 +0.2 mA
pin/pad DREF −2.5 +2.5 mA
total power dissipation − 300 mW
storage temperature −65 +150 °C
junction temperature − 150 °C
ambient temperature −40 +85 °C
HANDLING
Precautions should be taken to avoid damage through electrostatic discharge. This is particularly important during
assembly and handling of the bare die. Additional safety can be obtained by bonding the VCC and GND pads first, the
remaining pads may then be bonded to their external connections in any order.
THERMAL CHARACTERISTICS
SYMBOL PARAMETER VALUE UNIT
R
th(j-a)
thermal resistance from junction to ambient 160 K/W
2000 Mar 28 8
Page 9

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
CHARACTERISTICS
Typical values at T
temperature range and supply range; all voltages are measured with respect to ground; unless otherwise specified.
SYMBOL PARAMETER CONDITIONS MIN. TYP. MAX. UNIT
V
CC
I
CC
P
tot
T
j
T
amb
R
tr
supply voltage 3 5 5.5 V
supply current AC coupled; RL=50Ω− 34 47 mA
total power dissipation VCC=5V − 170 259 mW
junction temperature −40 − +125 °C
ambient temperature −40 +25 +85 °C
small-signal transresistance of
the receiver
f
−3dB(h)
high frequency −3 dB point VCC=5V; Ci= 0.7 pF 1000 1200 − MHz
PSRR power supply rejection ratio measured differentially;
Bias voltage: pin DREF
R
DREF
resistance between DREF and
V
Input: pin IPhoto
V
bias(IPhoto)
input bias voltage on
pin IPhoto
I
i(IPhoto)(p-p)
input current on pin IPhoto
(peak-to-peak value)
R
i
I
n(tot)
small-signal input resistance fi= 1 MHz; input current
total integrated RMS noise
current over bandwidth
=25°C and VCC= 5 V; minimum and maximum values are valid over the entire ambient
amb
V
= 3.3 V − 112 169 mW
CC
measured differentially;
AC coupled
R
= ∞ 13.2 16.6 20 kΩ
L
R
=50Ω 6.6 8.3 10 kΩ
L
V
= 3.3 V; Ci= 0.7 pF 850 1100 − MHz
CC
note 1
f = 1 to 100 MHz − 2 −µA/V
f = 1 GHz − 66 −µA/V
tested at DC 210 250 290 Ω
CC
600 822 1000 mV
VCC= 5 V; note 2 −1500 +6 +1500 µA
V
= 3.3 V; note 2 −1000 +6 +1000 µA
CC
− 28 −Ω
<2 µA (p-p)
referenced to input;
− 200 − nA
∆f = 920 MHz; note 3
2000 Mar 28 9
Page 10

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
SYMBOL PARAMETER CONDITIONS MIN. TYP. MAX. UNIT
Data outputs: pins OUT and OUTQ
V
o(cm)
V
o(se)(p-p)
V
OO
R
o
t
, t
r
f
Automatic gain control loop: pad AGC
I
th(AGC)
t
att(AGC)
t
decay(AGC)
Notes
1. PSRR is defined as the ratio of the equivalent current change at the input (∆I
PSRR
For example, a +10 mV disturbance on V
The external capacitorbetween pins DREF and GND has a large impacton the PSRR. The specificationis validwith
an external capacitor of 1 nF.
2. The pulse width distortion (PWD) is <5% over the whole input current range. The PWD is defined as:
PWD
PRBS pattern of 10
3. All I
photodiode itself, with 0.3 pF allowed for the printed-circuit board layout and 0.2 pF intrinsic to the package. Noise
performance is measured differentially.
common mode output voltage AC coupled; RL=50Ω VCC− 2VCC− 1.7 VCC− 1.4 V
single-ended output voltage
(peak-to-peak value)
differential output offset
AC coupled; RL=50Ω;
input current 100 µA (p-p)
75 200 330 mV
−100 − +100 mV
voltage
output resistance single-ended; DC tested 40 50 62 Ω
rise time, fall time VCC= 5 V; 20% to 80%;
− 285 430 ps
input current <20 µA (p-p)
= 3.3 V;20% to 80%;
V
CC
− 300 460 ps
input current <20 µA (p-p)
AGC threshold current referenced to the peak
− 25 −µA
input current; tested at
10 MHz
AGC attack time − 5 −µs
AGC decay time − 10 − ms
) to a change in supply voltage:
IPhoto
∆I
IPhoto
=
-------------------∆V
CC
at 10 MHz will typically add an extra 20 nA to the photodiode current.
CC
pulse width
----------------------------- -
T
measurements were made with an input capacitance of Ci= 1 pF. This was comprised of 0.5 pF for the
n(tot)
−23
1–
.
where T is the clock period. The PWD is measured differentially with
100%×=
2000 Mar 28 10
Page 11

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
TYPICAL PERFORMANCE CHARACTERISTICS
40
handbook, halfpage
I
CC
(mA)
38
36
34
32
30
28
−40 0
(1) VCC=5V.
(2) VCC= 3.3 V.
(3) VCC=3V.
(1)
(2)
(3)
40
MGU112
Tj (°C)
120
80
34.8
handbook, halfpage
I
CC
(mA)
34.4
34.0
33.6
33.2
32.8
34
TZA3043; TZA3043B
MGU113
56
VCC (V)
Fig.10 Supply current as a function of the junction
temperature.
825
handbook, halfpage
V
i
(mV)
823
821
819
817
34
56
MGU114
VCC (V)
Fig.11 Supply current as a function of the supply
voltage.
920
handbook, halfpage
V
i
(mV)
840
760
680
−40 0
(1) VCC=5V.
(2) VCC= 3.3 V.
(3) VCC=3V.
(1)
(2)
(3)
40
MGU115
80
Tj (°C)
120
Fig.12 Input voltage as a function of the supply
voltage.
2000 Mar 28 11
Fig.13 Input voltage as a function of the junction
temperature.
Page 12

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
1.68
handbook, halfpage
V
o(cm)
(V)
1.675
1.67
1.665
1.66
1.655
3
(1) VCC− V
(2) VCC− V
OUT
OUTQ
(1)
(2)
4
.
.
56
MGU116
VCC (V)
1.85
handbook, halfpage
V
o(cm)
(V)
1.75
1.65
1.55
−40 0
VCC=5V.
(1) VCC− V
(2) VCC− V
OUT
OUTQ
TZA3043; TZA3043B
MGU117
(1)
(2)
40
.
.
80
Tj (°C)
120
Fig.14 Common mode voltage at the output as a
function of the supply voltage.
Fig.15 Common mode voltage at the output as a
function of the junction temperature.
2000 Mar 28 12
Page 13

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
APPLICATION AND TEST INFORMATION
handbook, full pagewidth
22 nF
V
CC
8
DREF
1
TZA3043T
IPhoto
3
1 nF
2
GND
4
GND5GND
10 µH
680 nF
TZA3043; TZA3043B
V
P
7
6
OUTQ
OUT
Zo = 50 Ω
(1)
(1)
Zo = 50 Ω
100 nF
100 nF
R3
50 Ω
R4
50 Ω
(1) For TZA3043BT pin 7 is OUT and pin 6 is OUTQ.
MGU101
Fig.16 Application diagram.
2000 Mar 28 13
Page 14

This text is here in white to force landscape pages to be rotated correctly when browsing through the pdf in the Acrobat reader.This text is here in
ha
_white to force landscape pages to be rotated correctly when browsing through the pdf in the Acrobat reader.This text is here inThis text is here in
white to force landscape pages to be rotated correctly when browsing through the pdf in the Acrobat reader. white to force landscape pages to be ...
2000 Mar 28 14
V
CC
ndbook, full pagewidth
Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
1 nF
DREF
IPhoto
(1) (1) (1)
22 nF
V
CC
8
(2)
1
TZA3043T TZA3044
3
2
GND4GND5GND
7
6
OUTQ
OUT
4 pF
(2)
noise filter:
1-pole, 800 MHz
680 nF
100
Ω
1.5 nF
1.5 nF
DIN
DINQ
100 nF
4
5
3
AGND
V
6
CCA
1
180 kΩ
RSET7CF
16
SUB8JAM
9
STQ10ST
100 nF
ref
14
11
DGND
V
CCD
13
12
DOUT
DOUTQ
1 kΩ
50 Ω 50 Ω
MGU102
data out
level-detect
status
VCC − 2 V
TZA3043; TZA3043B
V
15
(1) Ferrite bead e.g. Murata BLM10A700S.
(2) For TZA3043BT pin 7 is OUT and pin 6 is OUTQ.
Fig.17 Gigabit Ethernet/Fibre Channel receiver using the TZA3043T and TZA3044.
Page 15

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
Test circuits
handbook, full pagewidth
Zo = 50 Ω
223-1 PRBS
PATTERN
GENERATOR
C
D
C
TRD
C IN
ZT = s21.(R + Zi) . 2 R = 470 Ω, Zi = 28 Ω
NETWORK ANALYZER
S-PARAMETER TEST SET
PORT 1 PORT 2
Zo = 50 Ω
V
CC
100 nF
10 nF
51 Ω
470 Ω
IPhoto
TZA3043
OUT
OUTQ
100 nF
TZA3043; TZA3043B
SAMPLING
OSCILLOSCOPE/
TDR/TDT
1
TR
2
OM5803
Fig.18 Electrical test circuit.
Zo = 50 Ω
MGU106
2000 Mar 28 15
Page 16

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
handbook, full pagewidth
23
2
-1 PRBS
PATTERN
GENERATOR
C
D
C
LIGHTWAVE MULTIMETER
−9.54 dBm
OPTICAL ATTENUATOR
0 dBm/1300
LASER DRIVER
TRD
C IN
TZA3041
DIN
DINQ
OPTICAL
INPUT
IN OUT
Laser
10%90%
PIN
10 nF
V
CC
BLM
DREF
IPhoto
TZA3043
22 nF
OUT
OUTQ
TZA3043; TZA3043B
ERROR DETECTOR
DatainClock
in
100 nF
100 nF
SAMPLING
OSCILLOSCOPE/
TDR/TDT
1
2
TR
1.24416 GHz
OM5804OM5802
Fig.19 Optical test circuit.
Zo = 50 Ω
MGU107
2000 Mar 28 16
Page 17

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
handbook, full pagewidth
TZA3043; TZA3043B
MGU108
Fig.20 Differential output with −25 dBm optical input power [input current of 5.17 µA (p-p)].
handbook, full pagewidth
MGU109
Fig.21 Differential output with −15 dBm optical input power [input current of 51.7 µA (p-p)].
2000 Mar 28 17
Page 18

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
handbook, full pagewidth
TZA3043; TZA3043B
MGU110
handbook, full pagewidth
Fig.22 Differential output with −5 dBm optical input power [input current of 517 µA (p-p)].
MGU111
Fig.23 Differential output with −2 dBm optical input power [input current of 1030 µA (p-p)].
2000 Mar 28 18
Page 19

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
BONDING PAD LOCATIONS
SYMBOL PAD TZA3043U PAD TZA3043BU
COORDINATES
xy
DREF 1 1 95 881
GND 2 2 95 618
GND 3 3 95 473
IPhoto 4 4 95 285
GND 5 5 215 95
GND 6 6 360 95
GND 7 7 549 95
GND 8 8 691 95
OUT 9 10 785 501
OUTQ 10 9 785 641
V
CC
V
CC
11 11 567 1055
12 12 424 1055
AGC 13 13 259 1055
(1)
Note
1. All coordinates are referenced, in µm, to the bottom left-hand corner of the die.
VCCV
1030
µm
11
GND
CC
10
9
8
GND
OUTQ
OUT
MGU099
1300
µm
DREF
GND
GND
IPhoto
x
0
1
2
3
4
0
y
1300
µm
DREF
GND
GND
IPhoto
x
0
AGC
12
13
1
2
3
4
0
y
TZA3043U
5
67
GND
GND
AGC
13
TZA3043BU
5
67
GND
GND
VCCV
12
1030
µm
11
GND
CC
10
9
8
GND
OUT
OUTQ
MGU100
Fig.24 Bonding pad locations of the TZA3043U.
2000 Mar 28 19
Fig.25 Bonding pad locations of the TZA3043BU.
Page 20

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
Physical characteristics of the bare die
PARAMETER VALUE
Glass passivation 2.1 µm PSG (PhosphoSilicate Glass) on top of 0.65 µm oxynitride
Bonding pad dimension minimum dimension of exposed metallization is 90 × 90 µm (pad size = 100 × 100 µm)
Metallization 1.22 µm W/AlCu/TiW
Thickness 380 µm nominal
Size 1.03 × 1.30 mm (1.34 mm
Backing silicon; electrically connected to GND potential through substrate contacts
Attach temperature <440 °C; recommended die attach is glue
Attach time <15 s
2
)
2000 Mar 28 20
Page 21

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
PACKAGE OUTLINE
SO8: plastic small outline package; 8 leads; body width 3.9 mm
D
c
y
Z
8
5
TZA3043; TZA3043B
SOT96-1
E
H
E
A
X
v M
A
A
pin 1 index
1
e
DIMENSIONS (inch dimensions are derived from the original mm dimensions)
UNIT
mm
inches
Notes
1. Plastic or metal protrusions of 0.15 mm maximum per side are not included.
2. Plastic or metal protrusions of 0.25 mm maximum per side are not included.
A
max.
1.75
0.069
A1A2A
0.25
1.45
0.10
1.25
0.010
0.057
0.004
0.049
0.25
0.01
b
3
p
0.49
0.25
0.36
0.19
0.019
0.0100
0.014
0.0075
4
w M
b
p
0 2.5 5 mm
scale
(1)E(2)
cD
5.0
4.8
0.20
0.19
eHELLpQZywv θ
4.0
1.27
3.8
0.16
0.050
0.15
2
A
6.2
5.8
0.244
0.228
Q
3
A
θ
0.25 0.10.25
0.010.010.041 0.004
(1)
0.7
0.3
0.028
0.012
o
8
o
0
L
p
L
0.7
0.6
0.028
0.024
(A )
1
detail X
1.0
1.05
0.4
0.039
0.016
OUTLINE
VERSION
SOT96-1
IEC JEDEC EIAJ
076E03 MS-012
REFERENCES
2000 Mar 28 21
EUROPEAN
PROJECTION
ISSUE DATE
97-05-22
99-12-27
Page 22

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
SOLDERING
Introduction to soldering surface mount packages
Thistext gives a very briefinsightto a complex technology.
A more in-depth account of soldering ICs can be found in
our
“Data Handbook IC26; Integrated Circuit Packages”
(document order number 9398 652 90011).
There is no soldering method that is ideal for all surface
mount IC packages.Wave soldering isnot always suitable
for surface mount ICs, or for printed-circuit boards with
high population densities. In these situations reflow
soldering is often used.
Reflow soldering
Reflow soldering requires solder paste (a suspension of
fine solder particles, flux and binding agent) to be applied
tothe printed-circuit boardbyscreen printing, stencilling or
pressure-syringe dispensing before package placement.
Several methods exist for reflowing; for example,
infrared/convection heating in a conveyor type oven.
Throughput times (preheating,soldering and cooling) vary
between 100 and 200 seconds depending on heating
method.
Typical reflow peak temperatures range from
215 to 250 °C. The top-surface temperature of the
packages should preferable be kept below 230 °C.
Wave soldering
Conventional single wave soldering is not recommended
forsurfacemount devices (SMDs) orprinted-circuitboards
with a high component density, as solder bridging and
non-wetting can present major problems.
To overcome these problems the double-wave soldering
method was specifically developed.
TZA3043; TZA3043B
If wave soldering is used the following conditions must be
observed for optimal results:
• Use a double-wave soldering method comprising a
turbulent wave with high upward pressure followed by a
smooth laminar wave.
• For packages with leads on two sides and a pitch (e):
– larger than or equal to 1.27 mm, the footprint
longitudinal axis is preferred to be parallel to the
transport direction of the printed-circuit board;
– smaller than 1.27 mm, the footprint longitudinal axis
must be parallel to the transport direction of the
printed-circuit board.
The footprint must incorporate solder thieves at the
downstream end.
• Forpackageswith leads on foursides, thefootprintmust
be placed at a 45° angle to the transport direction of the
printed-circuit board. The footprint must incorporate
solder thieves downstream and at the side corners.
During placement andbefore soldering, the package must
be fixed with a droplet of adhesive. The adhesive can be
applied by screen printing, pin transfer or syringe
dispensing. The package can be soldered after the
adhesive is cured.
Typical dwell time is 4 seconds at 250 °C.
A mildly-activated flux will eliminate the need for removal
of corrosive residues in most applications.
Manual soldering
Fix the component by first soldering two
diagonally-opposite end leads. Use a low voltage (24 V or
less) soldering iron applied to the flat part of the lead.
Contact time must be limited to 10 seconds at up to
300 °C.
When using a dedicated tool, all other leads can be
soldered in one operation within 2 to 5 seconds between
270 and 320 °C.
2000 Mar 28 22
Page 23

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
Suitability of surface mount IC packages for wave and reflow soldering methods
PACKAGE
BGA, LFBGA, SQFP, TFBGA not suitable suitable
HBCC, HLQFP, HSQFP, HSOP, HTQFP, HTSSOP, SMS not suitable
(3)
PLCC
LQFP, QFP, TQFP not recommended
SSOP, TSSOP, VSO not recommended
Notes
1. All surface mount (SMD) packages are moisture sensitive. Depending upon the moisture content, the maximum
2. These packages are not suitable for wave soldering as a solder joint between the printed-circuit board and heatsink
3. If wave soldering is considered, then the package must be placed at a 45° angle to the solder wave direction.
4. Wave soldering is only suitable for LQFP, TQFP and QFP packages with a pitch (e) equal to or larger than 0.8 mm;
5. Wave soldering is only suitable for SSOP and TSSOP packageswith a pitch (e) equal to or larger than 0.65 mm; it is
, SO, SOJ suitable suitable
temperature (with respect to time) and body size of the package, there is a risk that internal or external package
cracks may occur due to vaporization of the moisture in them (the so called popcorn effect). For details, refer to the
Drypack information in the
(at bottom version) can not be achieved, and as solder may stick to the heatsink (on top version).
The package footprint must incorporate solder thieves downstream and at the side corners.
it is definitely not suitable for packages with a pitch (e) equal to or smaller than 0.65 mm.
definitely not suitable for packages with a pitch (e) equal to or smaller than 0.5 mm.
“Data Handbook IC26; Integrated Circuit Packages; Section: Packing Methods”
SOLDERING METHOD
WAVE REFLOW
(2)
(3)(4)
(5)
suitable
suitable
suitable
(1)
.
2000 Mar 28 23
Page 24

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
TZA3043; TZA3043B
transimpedance amplifier
DATA SHEET STATUS
DATA SHEET STATUS
Objective specification Development This data sheet contains the design target or goal specifications for
Preliminary specification Qualification This data sheet contains preliminary data, and supplementary data will be
Product specification Production This data sheet contains final specifications. Philips Semiconductors
Note
1. Please consult the most recently issued data sheet before initiating or completing a design.
DEFINITIONS
Short-form specification The data in a short-form
specification is extracted from a full data sheet with the
same type number and title. For detailed information see
the relevant data sheet or data handbook.
Limiting values definition Limiting values given are in
accordance with the Absolute Maximum Rating System
(IEC 60134). Stress above one or more of the limiting
values may cause permanent damage to the device.
These are stress ratings only and operation of the device
atthese or at anyotherconditions above those giveninthe
Characteristics sections of the specification is not implied.
Exposure to limiting values for extended periods may
affect device reliability.
Application information Applications that are
described herein for any of these products are for
illustrative purposes only. Philips Semiconductors make
norepresentationor warranty that such applications willbe
suitable for the specified use without further testing or
modification.
DISCLAIMERS
Life support applications These products are not
designed for use in life support appliances, devices, or
systems where malfunction of these products can
reasonably be expectedto result inpersonal injury. Philips
Semiconductorscustomersusingor selling these products
for use in such applications do so at their own risk and
agree to fully indemnify Philips Semiconductors for any
damages resulting from such application.
PRODUCT
STATUS
DEFINITIONS
product development. Specification may change in any manner without
notice.
published at a later date. Philips Semiconductors reserves the right to
make changes at any time without notice in order to improve design and
supply the best possible product.
reserves the right to make changes at any time without notice in order to
improve design and supply the best possible product.
Right to make changes Philips Semiconductors
reserves the right to make changes, without notice, in the
products, including circuits, standard cells, and/or
software, described or contained herein in order to
improve design and/or performance. Philips
Semiconductors assumes no responsibility or liability for
theuseof any of theseproducts, conveysnolicenceor title
under any patent, copyright, or mask work right to these
products,and makes no representationsorwarranties that
these products are free from patent, copyright, or mask
work right infringement, unless otherwise specified.
BARE DIE DISCLAIMER
All die are tested and are guaranteed to comply with all
data sheet limits up to the point of wafer sawing for a
periodof ninety (90)days from thedate of Philips'delivery.
If there are data sheet limits not guaranteed, these will be
separately indicated in the data sheet. There are no post
packing tests performed on individual die or wafer. Philips
Semiconductorshas no controlofthird party procedures in
the sawing, handling, packing or assembly of the die.
Accordingly, Philips Semiconductors assumes no liability
for device functionality or performance of the die or
systems after third party sawing, handling, packing or
assembly of the die. It is the responsibility of the customer
to test and qualify their application in whichthe die is used.
(1)
2000 Mar 28 24
Page 25

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
TZA3043; TZA3043B
NOTES
2000 Mar 28 25
Page 26

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
TZA3043; TZA3043B
NOTES
2000 Mar 28 26
Page 27

Philips Semiconductors Product specification
Gigabit Ethernet/Fibre Channel
transimpedance amplifier
TZA3043; TZA3043B
NOTES
2000 Mar 28 27
Page 28

Philips Semiconductors – a w orldwide compan y
Argentina: see South America
Australia: 3 Figtree Drive, HOMEBUSH, NSW 2140,
Tel. +61 2 9704 8141, Fax. +61 2 9704 8139
Austria: Computerstr. 6, A-1101 WIEN, P.O. Box 213,
Tel. +43 1 60 101 1248, Fax. +43 1 60 101 1210
Belarus: Hotel Minsk Business Center, Bld. 3, r. 1211, Volodarski Str. 6,
220050 MINSK, Tel. +375 172 20 0733, Fax. +375 172 20 0773
Belgium: see The Netherlands
Brazil: see South America
Bulgaria: Philips Bulgaria Ltd., Energoproject, 15th floor,
51 James Bourchier Blvd., 1407 SOFIA,
Tel. +359 2 68 9211, Fax. +359 2 68 9102
Canada: PHILIPS SEMICONDUCTORS/COMPONENTS,
Tel. +1 800 234 7381, Fax. +1 800 943 0087
China/Hong Kong: 501 Hong Kong Industrial Technology Centre,
72 Tat Chee Avenue, Kowloon Tong, HONG KONG,
Tel. +852 2319 7888, Fax. +852 2319 7700
Colombia: see South America
Czech Republic: see Austria
Denmark: Sydhavnsgade 23, 1780 COPENHAGEN V,
Tel. +45 33 29 3333, Fax. +45 33 29 3905
Finland: Sinikalliontie 3, FIN-02630 ESPOO,
Tel. +358 9 615 800, Fax. +358 9 6158 0920
France: 51 Rue Carnot, BP317, 92156 SURESNES Cedex,
Tel. +33 1 4099 6161, Fax. +33 1 4099 6427
Germany: Hammerbrookstraße 69, D-20097 HAMBURG,
Tel. +49 40 2353 60, Fax. +49 40 2353 6300
Hungary: see Austria
India: Philips INDIA Ltd, Band Box Building, 2nd floor,
254-D, Dr. Annie Besant Road, Worli, MUMBAI 400 025,
Tel. +91 22 493 8541, Fax. +91 22 493 0966
Indonesia: PT Philips DevelopmentCorporation, Semiconductors Division,
Gedung Philips, Jl. Buncit Raya Kav.99-100, JAKARTA 12510,
Tel. +62 21 794 0040 ext. 2501, Fax. +62 21 794 0080
Ireland: Newstead, Clonskeagh, DUBLIN 14,
Tel. +353 1 7640 000, Fax. +353 1 7640 200
Israel: RAPAC Electronics, 7 Kehilat Saloniki St, PO Box 18053,
TEL AVIV 61180, Tel. +972 3 645 0444, Fax. +972 3 649 1007
Italy: PHILIPS SEMICONDUCTORS, Via Casati, 23 - 20052MONZA (MI),
Tel. +39 039 203 6838, Fax +39 039 203 6800
Japan: Philips Bldg 13-37, Kohnan 2-chome, Minato-ku,
TOKYO 108-8507, Tel. +81 3 3740 5130, Fax. +81 3 3740 5057
Korea: Philips House, 260-199 Itaewon-dong, Yongsan-ku, SEOUL,
Tel. +82 2 709 1412, Fax. +82 2 709 1415
Malaysia: No. 76 Jalan Universiti, 46200 PETALING JAYA, SELANGOR,
Tel. +60 3 750 5214, Fax. +60 3 757 4880
Mexico: 5900 Gateway East, Suite 200, EL PASO, TEXAS 79905,
Tel. +9-5 800 234 7381, Fax +9-5 800 943 0087
Middle East: see Italy
Netherlands: Postbus 90050, 5600 PB EINDHOVEN, Bldg. VB,
Tel. +31 40 27 82785, Fax. +31 40 27 88399
New Zealand: 2 Wagener Place, C.P.O. Box 1041, AUCKLAND,
Tel. +64 9 849 4160, Fax. +64 9 849 7811
Norway: Box 1, Manglerud 0612, OSLO,
Tel. +47 22 74 8000, Fax. +47 22 74 8341
Pakistan: see Singapore
Philippines: Philips Semiconductors Philippines Inc.,
106 Valero St. Salcedo Village, P.O. Box 2108 MCC, MAKATI,
Metro MANILA, Tel. +63 2 816 6380, Fax. +63 2 817 3474
Poland: Al.Jerozolimskie 195 B, 02-222 WARSAW,
Tel. +48 22 5710 000, Fax. +48 22 5710 001
Portugal: see Spain
Romania: see Italy
Russia: Philips Russia, Ul. Usatcheva 35A, 119048 MOSCOW,
Tel. +7 095 755 6918, Fax. +7 095 755 6919
Singapore: Lorong 1, Toa Payoh, SINGAPORE 319762,
Tel. +65 350 2538, Fax. +65 251 6500
Slovakia: see Austria
Slovenia: see Italy
South Africa: S.A. PHILIPS Pty Ltd., 195-215 Main Road Martindale,
2092 JOHANNESBURG, P.O. Box 58088 Newville 2114,
Tel. +27 11 471 5401, Fax. +27 11 471 5398
South America: Al. Vicente Pinzon, 173, 6th floor,
04547-130 SÃO PAULO, SP, Brazil,
Tel. +55 11 821 2333, Fax. +55 11 821 2382
Spain: Balmes 22, 08007 BARCELONA,
Tel. +34 93 301 6312, Fax. +34 93 301 4107
Sweden: Kottbygatan 7, Akalla, S-16485 STOCKHOLM,
Tel. +46 8 5985 2000, Fax. +46 8 5985 2745
Switzerland: Allmendstrasse 140, CH-8027 ZÜRICH,
Tel. +41 1 488 2741 Fax. +41 1 488 3263
Taiwan: Philips Semiconductors, 6F, No. 96, Chien Kuo N. Rd., Sec. 1,
TAIPEI, Taiwan Tel. +886 2 2134 2886, Fax. +886 2 2134 2874
Thailand: PHILIPS ELECTRONICS (THAILAND) Ltd.,
209/2 Sanpavuth-Bangna Road Prakanong, BANGKOK 10260,
Tel. +66 2 745 4090, Fax. +66 2 398 0793
Turkey: Yukari Dudullu, Org. San. Blg., 2.Cad. Nr. 28 81260 Umraniye,
ISTANBUL, Tel. +90 216 522 1500, Fax. +90 216 522 1813
Ukraine: PHILIPS UKRAINE, 4 Patrice Lumumba str., Building B, Floor 7,
252042 KIEV, Tel. +380 44 264 2776, Fax. +380 44 268 0461
United Kingdom: Philips Semiconductors Ltd., 276 Bath Road, Hayes,
MIDDLESEX UB3 5BX, Tel. +44 208 730 5000, Fax. +44 208 754 8421
United States: 811 East Arques Avenue, SUNNYVALE, CA 94088-3409,
Tel. +1 800 234 7381, Fax. +1 800 943 0087
Uruguay: see South America
Vietnam: see Singapore
Yugoslavia: PHILIPS, Trg N. Pasica 5/v, 11000 BEOGRAD,
Tel. +381 11 3341 299, Fax.+381 11 3342 553
For all other countries apply to: Philips Semiconductors,
International Marketing & Sales Communications, Building BE-p, P.O. Box 218,
5600 MD EINDHOVEN, The Netherlands, Fax. +31 40 27 24825
© Philips Electronics N.V. SCA
All rights are reserved. Reproduction in whole or in part is prohibited without the prior written consent of the copyright owner.
The information presented in this document does not form part of any quotation or contract, is believed to be accurate and reliable and may be changed
without notice. No liability will be accepted by the publisher for any consequence of its use. Publication thereof does not convey nor imply any license
under patent- or other industrial or intellectual property rights.
2000
Internet: http://www.semiconductors.philips.com
69
Printed in The Netherlands 403510/200/02/pp28 Date of release: 2000 Mar 28 Document order number: 9397 750 06817
 Loading...
Loading...