Page 1

Betapure™
CMP Series
CMP Filter Cartridges
Superior Reduction Of Large Particle
Counts For Improved Yields
Betapure™ CMP filter cartridges are high capacity depth filters optimized for oxide and metal
slurries used in chemical mechanical planarization (CMP) applications. Betapure CMP filters are
composed of all-polypropylene components and features a multi-zone "graded-porosity" design
for the optimum level of particle classification. This novel construction provides enhanced flow
characteristics, including low pressure drop, to minimize shearing of the slurry while providing
superior service life.
The objective of a slurry lter is for the majority of particles to pass through it unchanged,
while only removing the undesired or “oversized” particles. The oversized particle population
is commonly referred to as large particle counts (LPC) and they typically form over time when
the suspended particles in the slurry settle forming aggregates, agglomerates, and gels. Large
particles can also be the result of ad verse shipping conditions, shearing, slurry drying, and
interaction with other distribution loop components such as ttings, tanks, piping, valves, and
pumps. These large particles can scratch metal and inter-level dielectrics potentially causing
wafer defects. The Betapure CMP lter reduces large particle counts that can potentially
reduce yields while maintaining the polishing characteristics of the slurry.
Applications
Semiconductor Oxide/Low-k Dielectrics, Shallow Trench
Features & Benefits
Graded Porosity Design
Superior removal of hard and soft gel contaminants, for reduced defectivity
and improved yields
High contaminant holding capacity reduces downtime and increases overall
equipment effectiveness
The filters are "matched" to the slurry providing the optimum level of
performance needed to dramatically reduce defect causing particles
Provides a low pressure drop reducing the potential for fluid shear of the slurry
100% Polypropylene
Low cartridge extractables, free of adhesives, binders, and surfactants
Excellent chemical compatibility with low and high pH slurries
Quality Manufacturing
ISO certified quality management system
Non-contact welding reduces a potential source for contamination
Manufactured and double-bagged in a clean environment to provide superior downstream cleanliness out of the package
Built to Exacting Specifications
Provides a consistent quality of slurry enabling repeatability of the planarization process
Data Storage Magnetic Heads, Nickel and Glass
Data Transmission Optical Fiber
Compound Semiconductor Light Emitting Diodes (LED)
Isolation (STI), Inter-level Dielectric (ILD),
Polysilicon, Tungsten, and Copper
Substrates
1
Page 2

Particle Size Distribution
The filtration of CMP slurries is a unique and challenging process as compared to the filtration of high purity chemicals used in electronics
manufacturing. High purity chemical filtration is typically performed using 0.2 micron or tighter membrane filters that have a sharp particle
removal cut-off at the rated pore size. The majority of CMP slurries contain a de sired mean particle size that ranges from 0.03 - 0.2 microns.
Consequently, the filter that was specifically designed for particle clarification of high purity chemicals would strip out the de sired particles and
adversely affect the polishing characteristics of the CMP slurry. Over sized particles in the slurry typically greater than 0.5 micron are undesired
and represent the “tail” (Figure 1) of the particle size distribution (PSD). Betapure™ CMP filters remove the PSD tail while allowing the majority
of desired or “target” size particles to pass through it unchanged
.
Particle Removal Efficiency is the Best Measure of Filter Performance
Figure 1 com pares the PSD of colloidal-silica slurry and a lab oratory test dust which is typically used by filter suppliers to establish depth filter
ratings. The data shows that test dust has a broader PSD above 0.5 micron proving that it is not a true representation of the types of particles in
CMP slurry. A wide variation in performance also exists from one filter supplier to the next because there is no industry accepted standard for
rating retention of depth filters. Furthermore, Absolute and Nominal filter ratings are both used to specify particle removal efficiency which
only serves to confuse the situation while not providing the application specific information needed. In Figure 2, particle removal efficiency is
compared for the same grade of CMP filters from 3M Purification. The filters were challenged using both a lab oratory test dust and colloidal
silica slurry. There is a significant difference in particle removal efficiency, which is a direct result of the contaminant PSD distribution. The
broad PSD of the test dust yields significantly higher particle removal efficiency than achieved when tested with slurry. Therefore, test dust is not
representative of slurry and ratings based on test dust will likely be over stated and meaningless for CMP slurry applications. In Figure 3, particle
removal efficiency is compared for equivalent rated CMP filters from 3M Purification Inc., Competitor P, and Competitor M in colloidal silica
slurry. The data clearly shows that equivalent rated filters from different manufacturers does not deliver equivalent performance and reinforces
the fact that the “rating” generated in a lab using test dust is not meaningful in predicting actual performance. Based on this information particle
removal efficiency generated in slurry is the best measure of filter performance. Other important factors in selecting the appropriate slurry filter
include particle classification, pressure drop, and filter lifetime..
Number of Particles per ml
Figure 1. - Particle Size Distribution > 0.5 micron - Colloidal Silica Slurry & ISO Test Dust
200000
Colloidal Silica Slurry
150000
100000
ISO Test Dust
50000
0
0.5 1 2 105
Particle Diameter (microns)
2
Page 3

Betapure™ CMP Series
CMP Filter Cartridges
Particle Removal Efficiency
Colloidal Silica vs. ISO Test Dust
Betapure CMP560 - Colloidal Silica
Betapure CMP560 - ISO Test Dust
100
80
60
40
20
0
Particle Removal Efficiency (%)
Figure 2. - Particle Removal Efficiency Figure 3. - Comparative Particle Removal Efficiency in Colloidal Silica
Particle Size > 0.54 micron
Superior Particle Retention through
Graded Porosity Design
Betapure™ CMP filter media was specifically engineered to provide a low
porosity, downstream section with a sharp retention cut-off that closely aligns
to the size distribution of undesired particles to be removed. This sharp removal
cut-off will not alter per cent solids (Figure 4) or re move de sired or “target” size
particles thus preserving the polishing characteristics of the slurry. In contrast,
competitive point-of-use filters (Figure 4) that have a broad removal range can in
fact retain particles smaller than the PSD. Re moving these “target” size particles
can alter the per cent solids of the slurry which in turn reduces filter lifetime
because more particles are being re moved than required in the application.
The multiple higher porosity layers on the upstream section (Figure 5) provide
effective pre-filtration of over sized particles resulting in higher contaminant
removal capacity and increased filter life-time. This novel graded porosity
(Figure 5) design also provides a tortuous downstream path and low pressure
drop which is ideal for gel capture and reduced shear effect on the slurry.
Particle Removal Efficiency
for Equivalent Rated Filter Cartridges
Betapure CMP
Competitor P
Competitor M
100
80
60
40
20
0
Particle Removal Efficiency (%)
> 0.54 micron > 1.01 micron
Percent Solids - Colloidal Silica
Influent
Effluent
0.5
0.4
0.3
0.2
0.1
Percent Solids (%)
0
Competitor P Betapure CMP
Figure 4. - Percent Solids Comparison
TM
Superior Particle Retention through
Graded Porosity Design
Large particles, greater than 0.5 micron, can scratch metal and interlevel dielectrics
potentially causing wafer defects. Variations in particle size distribution and
particle counts in the slurry can affect re peat ability of the planarization process.
In both cases, major reductions in large particle counts can be associated to proper
filtration, resulting in reduced defectivity (Figure 6) and an increase to yields. Proper
filtration also provides a consistent quality of slurry which enables repeatability
of the planarization process. The ideal slurry filter will have a retention curve that
closely aligns to the PSD of “undesired” particles to be removed. By matching that
characteristic, Betapure CMP filters are able to maintain the polishing characteristics
of the slurry, maximize contaminant holding capacity, and increase filter lifetime.
3
Flow Direction
Inner
Outer
Medium
Figure 5. - Graded Porosity Design
Medium
Page 4
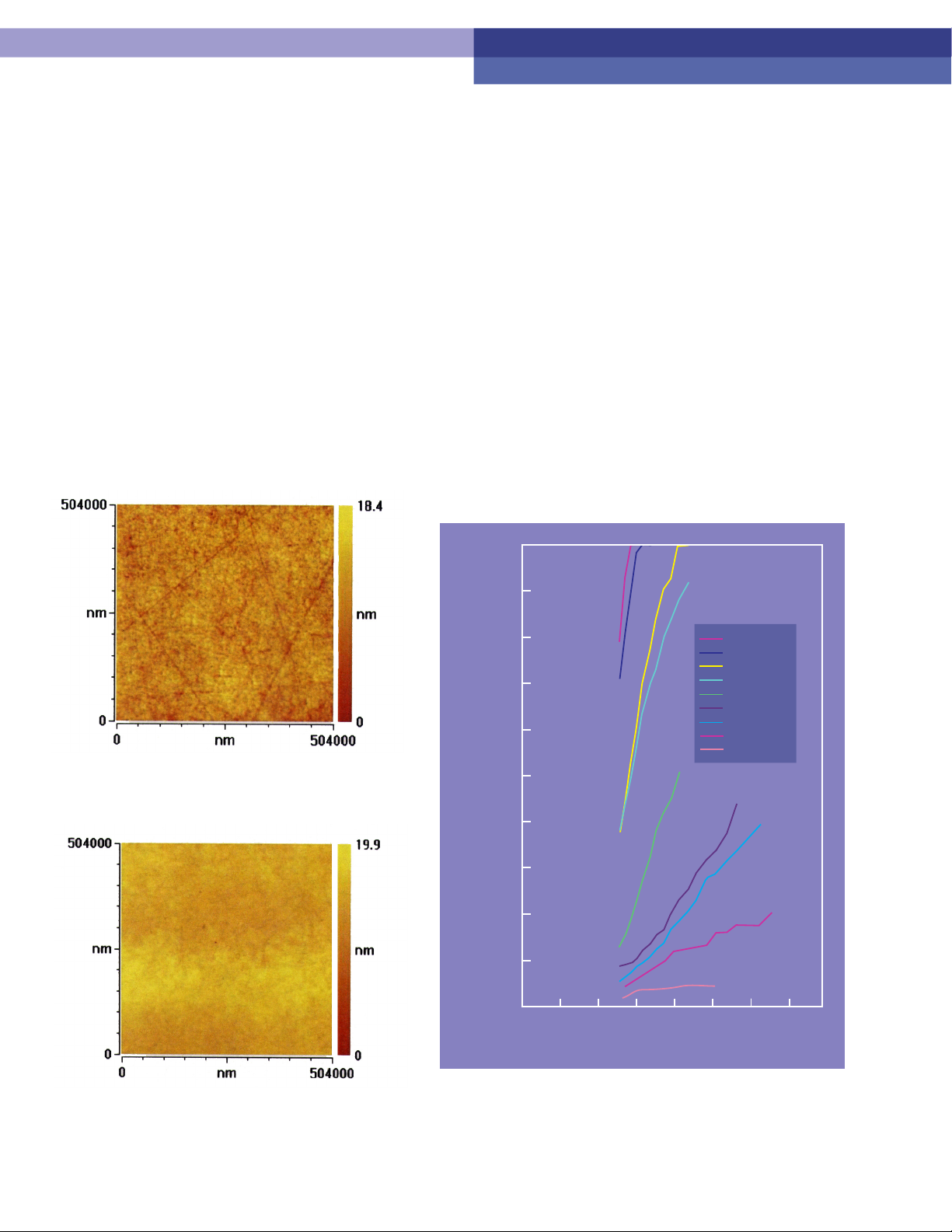
Cartridge Removal Efficiencies
Depending on the location in the slurry distribution system a filter with a sharp particle removal cut-off and a filter with a broad particle removal
cut-off will be needed to re duce defectivity and increase yields. For example, in single pass applications at point-of-use the filter should have
a sharp cut-off which is slightly larger than the de sired PSD. Figure 7 shows that Betapure™ CMP510, CMP520, CMP530, and CMP540
contain that sharp cut-off making it ideal for particle classification at point-of-use. However, in the distribution loop, the filter should have a
broad removal range that closely aligns to the un de sired PSD tail to be removed like that exhibited by Betapure CMP550, CMP560, CMP570,
CMP580 and CMP590. Betapure CMP filters for distribution loop applications contain a higher porosity media as compared to Betapure CMP
filters at point-of-use. The higher porosity media increases flow while reducing pressure drop and f luid shear on the slurry. Increasing flow
while maintaining particle removal efficiency results in particle specifications being achieved in less time. Figure 8, shows the particle removal
efficiency of an Betapure CMP560 filter in re-circulation mode over specific time intervals.
“Matching” the slurry to the proper Betapure CMP filter provides the peak level of performance needed to dramatically reduce defect causing
large particle counts. The porosity of the media layers can also be customized to meet the specific requirements of CMP slurry manufacturers.
Figure 6. - Benefits of Proper Filtration -
Horizon Capture of Copper Wafer Surface
Figure 7. - Betapure™ CMP Particle Removal Efficiency
100
90
No Filtration - High Level of Defectivity
80
70
60
50
40
30
Particle Removal Efficiency (%)
20
10
0
0
0.4
0.2
Particle Size (microns)
0.6
0.8
1.0
CMP 510
CMP 520
CMP 530
CMP 540
CMP 550
CMP 560
CMP 570
CMP 580
CMP 590
1.2
1.4
With Filtration - Relatively Defect Free
4
Page 5

200000
Betapure™ CMP Series
CMP Filter Cartridges
Figure 8. - Particle Removal Efficiency Over Time
Inlet
150000
10 minute Outlet
60 minute Outlet
100000
120 minute Outlet
180 minute Outlet
50000
Number of Particles per ml
0
0.5
1
2
Particle Diameter (microns)
Betapure™ CMP Cartridge Construction
Betapure™ CMP filter cartridges are constructed using all polypropylene components (see Table 1). Cartridges are manufactured using the most
advanced non-contact thermoplastic welding techniques - no adhesives, binders, or surfactants are used in the process - and are double-bagged in a
clean environment to ensure superior cleanliness out of the package. The Betapure CMP filter manufacturing site operates within an ISO certified
quality management system.
Table 1. - Product Specifications
Materials of Construction
Media
Media Support Layer
Core and End Caps
“O” Rings/Gaskets
Dimensions
Length
Outside Diameter
Operating Conditions
Maximum Forward Differential Pressure
Maximum Operating Temperature
Polypropylene
Polypropylene
Polypropylene
See ordering guide
See "Cartridge Configurations"
2.6” (6.6 cm)
60 psid @ 86°F (4.1 bar @30°C)
30 psid @ 140°F (2.0 bar @ 60°C)
140°F (60°C)
Betapure™ CMP Cartridge Flow Rates
Figure 9 depicts typical 10" cartridge f low rates for 1 cp fluids at 20°C.
Figure 9. - 10" Cartridge Flow Rate vs.
Pressure Drop for 1cp Fluids @ 20°C
10
CMP510
9
8
7
6
5
4
Pressure Drop (psid)
3
2
1
0
0
0
2
1
CMP520
3
10
CMP530
5
4
Flow Rate (GPM)
20 30
Flow Rate (LPM)
CMP540
CMP550
CMP560
CMP570
CMP590
6
7
CMP580
9
8
0.6
0.5
0.4
0.3
Pressure Drop (bar)
0.2
0.1
0
10
5
Page 6

SASS
3M Purification Electronics performs in-house and on-site filtration studies worldwide through its
Scientific Applications Support Services (SASS) group using the most advanced particle counting
technologies (PSS-780A) to optimize the CMP process at the customer facility. In addition, 3M
Purification Electronics works closely with the slurry manufacturers to characterize and customize
filtration solutions that meet current and future requirements.
Slurry Type Post Blending (1) Distribution Loop (2) POU Dispense (3)
Fumed Silica Oxide*
Colloidal Silica Oxide
Silica Based Metal
Non - Silica Based Metal < 2% Solids
Non - Silica Based Metal > 2% Solids
* Shear sensitive
Concentrated
Slurry
Slurry Blending
Mixing Station
Betapure™ CMP Filter Recommendation Guide
Filtration Location (see Figure 10)
CMP560
CMP560
CMP560
CMP540 or CMP550
CMP560
CMP560, CMP570, or CMP580
CMP550, CMP560, or CMP570
CMP560 or CMP570
CMP540 or CMP550
CMP560 or CMP570
Figure 10. - CMP Filtration Locations
CMP
Tool
3
Day Tank
1
2
Distribution
Filter
CMP
Tool
3
Particle Sizing Instrumentation
CMP540, CMP550, or CMP560
CMP520, CMP530, or CMP540
CMP520, CMP530, or CMP540
CMP510 or CMP520
CMP530 or CMP540
CMP
Tool
3
3
CMP
Tool
Betapure™ CMP Filter to Pore Size Cross-Reference
Betapure™ CMP Filter Grade Typical Pore Size (Micron)
510
520
530
540
550
560
570
580
590
0.3
0.5
0.8
1
3
5
10
25
50
6
Page 7

Betapure™ CMP Series
CMP Filter Cartridges
Betapure™ CMP Filter Cartridge Ordering Guide
Cartridge
CMP
Filter Grade
510
520
530
540
550
560
570
580
590
Media
1 - Polypropylene
* F only; ** Replaces Mykrolis Code 0, 10" length only (see U Style below).
Betapure™ CMP Cartridge Configurations
C Style
2 5/8”
(6.6 cm)
C Style
Inches Centimeters
A
12.81 High
B
A
22.52 High
32.43 High
B
12.0
21.8
31.7
C
32.5
57. 2
82.3
Length (Inches)
4 - 4"*
10 - 10"
20 - 20"
30 - 30"
09 - 9
19 - 19
29 - 29
D
30.5
55.4
80.5
End Modification
C - 222 O-ring & Spear
F - 222 O-ring & Flat Cap
U - 222 O-ring & Flat Cap**
N Style
A
Gasket/O-ring Material
C - EPR
G - Polyethylene N - Double Open End
N Style
Inches Centimeters
A
9.81 High
19.62 High
29.43 High
B
24.9
49.8
74.7
1 3/4”
(4.4 cm)
F Style
2 5/8”
(6.6 cm)
F Style
U Style
2 5/8”
(6.6 cm)
Inches Centimeters
A
1/2 High
B
A
1 High
2 High
3 High
1 3/4”
(4.4 cm)
5.2
11.0
20.7
30.6
B
4.4
10.2
20.0
29.8
C
13. 2
27. 9
52.6
7 7. 7
D
11.2
25.9
50.8
75.7
10.4”
(26.4 cm)
9.6”
(24.4 cm)
1 3/4”
(4.4 cm)
7
Page 8

Important Notice
The information described in this literature is accurate to the best of our knowledge. A variety of factors, however, can affect the performance of the Product(s) in a particular
application, some of which are uniquely within your knowledge and control. INFORMATION IS SUPPLIED UPON THE CONDITION THAT THE PERSONS RECEIVING THE
SAME WILL MAKE THEIR OWN DETERMINATION AS TO ITS SUITABILITY FOR THEIR USE. IN NO EVENT WILL 3M PURIFICATION INC. BE RESPONSIBLE FOR DAMAGES
OF ANY NATURE WHATSOEVER RESULTING FROM THE USE OF OR RELIANCE UPON INFORMATION.
It is your responsibility to determine if additional testing or information is required and if this product is fit for a particular purpose and suitable in your specific application.
3M PURIFICATION INC. MAKES NO REPRESENTATIONS OR WARRANTIES, EITHER EXPRESS OR IMPLIED INCLUDING WITHOUT LIMITATION ANY WARRANTIES OF
MERCHANTABILITY, FITNESS FOR A PARTICULAR PURPOSE OR OF ANY OTHER NATURE HEREUNDER WITH RESPECT TO INFORMATION OR THE PRODUCT TO WHICH
INFORMATION REFERS.
Limitation of Liability
3M Purification Inc. will not be liable for any loss or damage arising from the use of the Product(s), whether direct, indirect, special, incidental, or consequential, regardless of
the legal theory asserted, including warranty, contract, negligence or strict liability. Some states do not allow the exclusion or limitation of incidental or consequential damages,
so the above limitation may not apply to you.
Your Local Distributor:
3M Purifi cation Inc.
400 Research Parkway
Meriden, CT 06450
U.S.A.
Phone (800) 243-6894
(2 03) 237- 5541
Fax (203) 630-4530
www.3Mpurifi cation.com
Betapure is a trademark of 3M Company used under license.
All other trademarks are the property of their respective owners.
Please recycle. Printed in U.S.A.
3M is a trademark of 3M Company.
© 3M 2011. All rights reserved.
70-0201-8697-2 REV 1011b
 Loading...
Loading...