Page 1

Engineer-to-Engineer Note EE-182
a
Technical notes on using Analog Devices DSPs, processors and development tools
Contact our technical support at dsp.support@analog.com and at dsptools.support@analog.com
Or vi sit our o n-li ne r esou rces htt p:/ /www.analog.com/ee-notes and http://www.analog.com/processors
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors
Contributed by Greg F. Rev 1 – February 3, 2004
Introduction
This EE-Note discusses thermal relief design
considerations for Analog Devices ADSPTS201S TigerSHARC® processors. This
document assists PCB and system designers by
providing thermal data as well as heat sink
recommendations to allow for proper design of
their thermal relief system.
The ADSP-TS201S processor is an ultra-highperformance, static superscalar, 32-bit processor
from the TigerSHARC family of Analog Devices
Inc. The processor core operates at a clock
frequency of 500 MHz, and is available in a flipchip ball grid array (BGA_ED) package.
Overview
This EE-Note discusses the following topics:
• Thermal overview
• Thermal calculations
• Heat sink basics
• Heat sinks: pin fins vs. rectangular-fins
• Heat sink recommendations
• Specification recommendations
• Heat sink attachment recommendations
• PCB design for thermal dissipation
• Thermal simulations
• Alternate thermal relief solutions
• Terminology
Thermal Overview
Proper thermal management is required to ensure
that the processor operates within the
temperature specifications provided in the
ADSP-TS201S data sheet [1]. Operating within
the specified temperature range ensures proper
processor operation and reliability.
The overall power estimation can also be used to
estimate a thermal relief budget for the
processor. Equation 1 gives a value for the total
average estimated power. Note that this equation
yields the total estimated average power
consumption for a single ADSP-TS201S in a
given system. Guard-banding this value is
recommended for a thermal relief design that will
allow the system to operate within specified
thermal parameters, even under worst-case
conditions.
P
Equation 1. Total Estimated Average Power
For more information on power consumption for
the ADSP-TS201, refer to the Engineer-toEngineer note EE-170, titled “Estimating Power
for ADSP-TS201S TigerSHARC Processors”
[2], which can be found on the Analog Devices
Web site, at
Figure 1 shows the top and side views of the
ADSP-TS201S processor package. This
TigerSHARC processor is available in a 25mm x
25mm BGA_ED package.
= PDD (avg.) + P
THERMAL
(avg.) + P
DD_IO
DD_DRAM
www.analog.com/tigersharc.)
(avg.)
Copyright 2004, Analog Devices, Inc. All rights reserved. Analog Devices assumes no responsibility for customer product design or the use or application of
customers’ products or for any infringements of patents or rights of others which may result from Analog Devices assistance. All trademarks and logos are property
of their respective holders. Information furnished by Analog Devices Applications and Development Tools Engineers is believed to be accurate and reliable, however
no responsibility is assumed by Analog Devices regarding technical accuracy and topicality of the content provided in Analog Devices’ Engineer-to-Engineer Notes.
Page 2
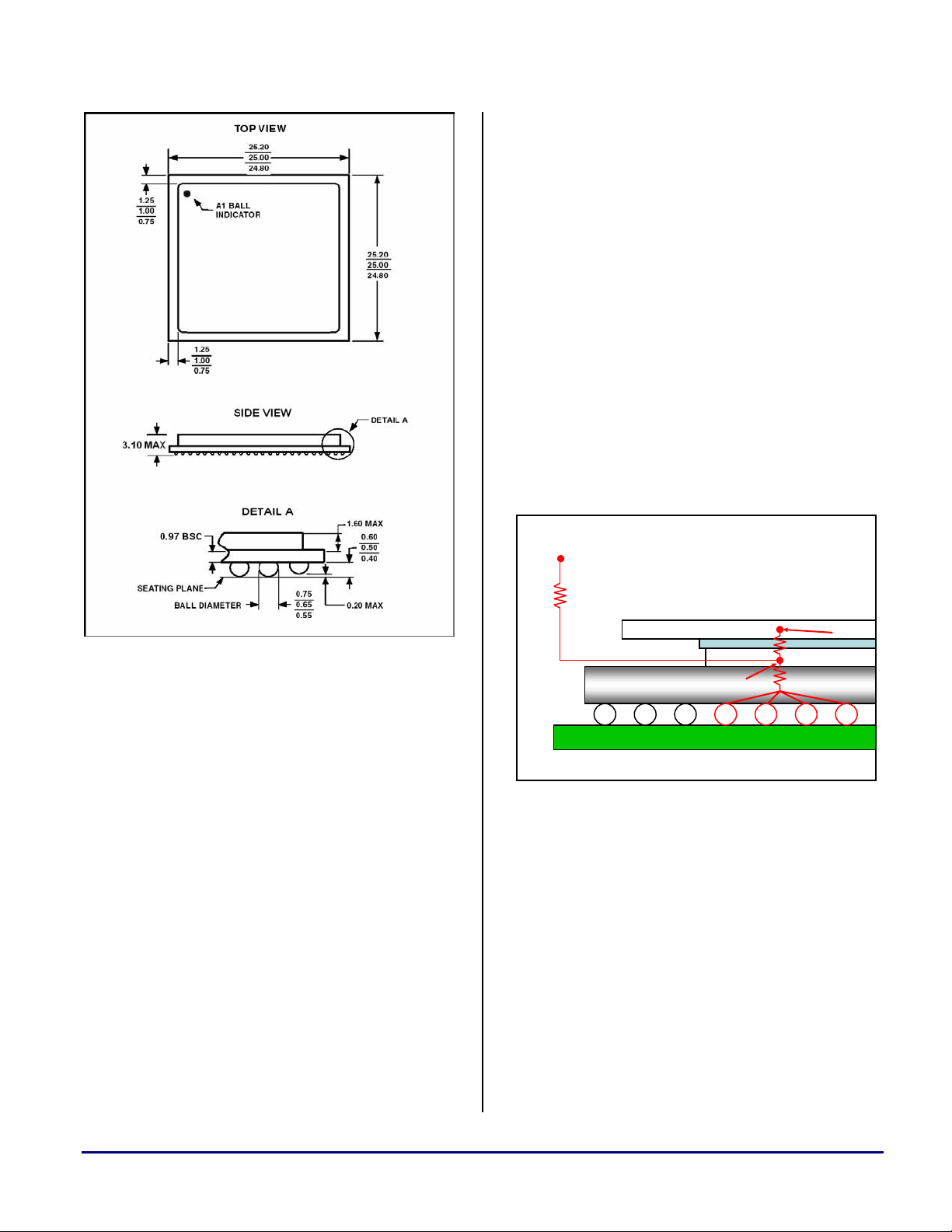
a
that there are two possible avenues for thermal
heat dissipation: the primary heat dissipation
path (i.e., the path with the least thermal
resistance) is via the “top” of the processor
package (through the thermal path denoted by
θ
), and the secondary heat dissipation path is
JC
through the “bottom” of the processor package,
via the package balls (through the thermal path
denoted by θ
The maximal thermal energy of the processor can
be transferred when the thermal resistance from
each component in the system is minimized.
Thus, the thermal energy generated by the
processor can be dissipated to the cooler ambient
air of the system (or through the PCB by the use
of thermal vias and an internal or external heat
sinking plane).
) to the PCB.
JB
Figure 1. ADSP-TS201S Outline Diagram
The BGA_ED package consists of the laminate
(with the attached ball-grid array on its bottom
surface), and a heat spreader, which is bonded to
the processor die via a thermally conductive
adhesive. The heat spreader aids in thermal
dissipation, since it attaches directly to the
processor die and provides a much larger surface
area than the die. (Increasing the surface area
decreases the overall thermal resistance for a
given surface.)
After thermal calculations have been completed,
if it is determined that a heat sink is necessary in
the system, use a heat sink with a minimum size
of 25mm square for thermal relief of the
processor.
Figure 2 is a simple model of a thermal system,
showings the components of the processor
package. This model shows all of the associated
components present in a thermal system. Note
T
AMB
θ
JA
HEAT SPREADER
LAMINATE
PCB
Figure 2. Thermal System Model Example
THERMAL ADHESIVE
T
JUNCTION
T
CASE
θ
JC
DIE
θ
JB
Note that θJA is a composite parameter that
encompasses all possible paths to the system’s
ambient air temperature based on the JEDEC
X-Y-Z spec. (The values for θ
, θJB, and θJC are
JA
provided in the “Thermal Characteristics”
section of the ADSP-TS201S data sheet.)
Thermal Calculations
To calculate the thermal performance of a
system, the first parameter that should be known
at the time of performing thermal calculations is
the maximum ambient air temperature, T
AMBIENT
of the system. The second parameter that should
,
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 2 of 9
Page 3

a
be known is the value of the processor’s thermal
power consumption (P
THERMAL
). The third
parameter is the junction-to-ambient thermal
resistance, θ
. These three system parameters
JA
are required to calculate the maximum junction
temperature, as shown in Equation 2.
T
Equation 2. Processor Junction Temperature Calculation
JUNCTION
= (P
THERMAL
x θJA) + T
AMBIENT
From the result of Equation 2, we can then use
the calculated value for T
JUNCTION
to solve for the
calculated value for the processor's case
temperature, T
, using Equation 3. The result
CASE
of Equation 3 determines whether a heat sink is
required to allow the ADSP-TS201 to operate
within the thermal operating conditions specified
in the ADSP-TS201S data sheet. If the calculated
value for T
exceeds the maximum specified
CASE
case temperature for the device (from the ADSPTS201S data sheet), a heat sink will be required.
T
(max)= T
CASE
Equation 3. Heat Sink Requirement Equation
JUNCTION
– (P
THERMAL
x θJC)
If a heat sink is required for the processor, an
appropriate heat sink with the proper thermal
performance characteristics must be chosen. The
following two parameters for the heat sink must
be known: the sink-to-ambient (θ
) thermal
SA
resistance, and the thermal resistance of the
thermal interface material (θ
), which resides
CS
between the processor's case and the bottom
surface of the heat sink.
Knowing these two thermal resistance
parameters of the desired heat sink, we can now
calculate the case temperature (T
) of the
CASE
processor with the heat sink attached by using
Equation 4.
T
CASE (MAX)
Equation 4. Derived Heat Sink Requirement Equation
< T
AMBIENT
+ (P
THERMAL
x θSA) + (P
THERMAL
x θCS)
Equation 4 yields a conservative estimate for the
value for T
. This is because there are other
CASE
paths in the system to sink the thermal energy
(for example, through the PCB). A more
comprehensive model of the system to include
these additional paths can be used when
performing the thermal calculations for the
processor. (The value for θ
is provided in the
JB
data sheet of the ADSP-TS201S.)
Table 2 shows the thermal resistance parameters
of the BGA_ED package of the processor based
on preliminary thermal parameters.
Air Velocity
(m/s)
0 19.6 8.3 0.7
1 15.4 8.3 0.7
2 13.7 8.3 0.7
Table 2. BGA_ED Thermal Resistance Parameters
θ
Without
JA
Heat Sink (°C/W)
θ
Nominal
JB
(°C/W)
θ
Nominal
JC
(°C/W)
Table 3 shows thermal resistance values for an
AAVID 374224B00032 heat sink. The values
shown in Table 3 are provided as an example.
Air Velocity
(m/s)
0 19.7 10.7
1 6.4 5.5
2 4.8 4.5
Table 3. Heat Sink Thermal Resistance Example
θ
Heat Sink
SA
Resistance (°C/W)
θ
With Heat Sink
JA
(°C/W)
For a specific application, the heat sink’s thermal
resistance values can be obtained from the
particular heat sink vendor.
Using Equation 4 and the data from Table 3, the
required minimal airflow over the heat sink can
be determined to allow for operating the
ADSP-TS201S within the maximum case
temperature specified in the processor's data
sheet. If this value is still insufficient, an active
thermal relief solution is required. See “Alternate
Thermal Relief Designs” later in this document.
If the resultant value from Equation 4 exceeds
the maximum value for T
CASE (MAX)
(from the
ADSP-TS201S data sheet), a heat sink with
better thermal characteristics will be required.
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 3 of 9
Heat Sink Basics
A heat sink is characterized by its thermal
resistance, which describes the flow of heat from
Page 4

a
the heat sink to the ambient air for a given rise in
the heat sink temperature.
Thermal resistance is measured in units of °C/W.
Heat sink to local ambient thermal resistance
(θ
) is a measure of the thermal resistance from
SA
the bottom of the heat sink to the local ambient
air.
Thermal resistance is dependent upon the
following four parameters:
• Heat sink material
• Thermal conductivity of the heat sink
• Geometry of the heat sink
• Air velocity through the fins of the heat sink
Lowering the thermal resistance between the
processor and the ambient air increases the
thermal solution's efficiency.
Copper heat sinks are less thermally resistive
than aluminum, however, they are more
expensive typically. For copper, the value of
thermal resistivity (R) is 0.11; for aluminum the
thermal resistivity value is 0.23. The units for R
are given as °C-inches per Watt.
(See Figure 3.) The channel should be deep
enough and long enough to allow for the
thermocouple to sit at the center of the heat
spreader of the processor.
Place the thermocouple at the center of the heat
spreader. Secure it with a small, single bead of
thermally conductive epoxy. Clean the heat sink
and the heat spreader surfaces with isopropyl
alcohol (100%), and a lint-free cloth or swab
prior to attachment.
Pin Fins versus Rectangular Fins
Pin-Fin
Heat Sink
Rectangular-Fin
Heat Sink
When performing processor case temperature
measurements, measure the case temperature,
T
, at the center of the heat spreader using a
CASE
thermocouple.
Heat Sink
(Bottom View)
Channel
Note:
Thermocouple
should be
located at the
exact center of
the heat
spreader.
Thermocouple
Figure 3. Thermocouple Placement and Heat Sink Channel
If a heat sink is to be used during the thermal
measurements, mill a channel in the heat sink to
facilitate the placement of the thermocouple.
Figure 4. Pin-Fin vs. Rectangular-Fin Heat Sink Example
Although rectangular-fin heat sinks have been
around longer, pin-fin heat sinks perform better
than rectangular-fin heat sinks, especially in
environments that provide little or no airflow in
the system. Due to the omni-directional structure
of pin-fin heat sinks, air can penetrate and exit
the heat sink at every possible angle, providing
more efficiency. The round shape of the
“pin-fins” creates turbulence within the heat
sink; this turbulence breaks the stagnant air
boundary layers around the pins, enhancing the
heat sink’s thermal performance. In addition, the
round pin structure exposes a large percentage of
the surface area to incoming airflow without
presenting an extreme pressure resistance to the
incoming airflow.
Heat sinks of many different sizes are available
from the listed manufacturers. Following is a list
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 4 of 9
Page 5

a
of recommended heat sink manufacturers and
specific heat sinks that exhibit required thermal
relief performance. Visit the Web sites listed
below for more information.
Cool Shield Inc.,
www.coolshieldinc.com:
Figure 5. CSH0xx012 and CSH0xx021 Polymer Heat Sinks
Cool Innovations, www.coolinnovations.com:
4-101005U (pin-fin, copper)
4-101003U (pin-fin, copper)
3-101003U (pin-fin, aluminum)
3-101005M (pin-fin, aluminum)
AAVID Thermalloy, www.aavidthermalloy.com:
Figure 8. AAVID Thermalloy 374224B00032 Heat Sink
Figure 6. Cool Innovations “M” Series Pin-Fin Heat Sinks
Figure 7. Cool Innovations “U” Series Pin-Fin Heat Sinks
Figure 9. AAVID Thermalloy 374224B60023 Heat Sink
Specification Recommendations
The heat sink used to cool the ADSP-TS201S is
recommended to not exceed the weight and
dimension guidelines shown in Table 4. A
horizontal position for the assembled heat sink
and processor package is recommended.
Maximum Heat
Sink Dimension
(mm)
53 x 53 x 16.5 54 200 5
Table 4. Heat Sink Weight and Dimension Guidelines
Do not exceed the maximum lateral and vertical
forces when installing or removing the heat sink.
Analog Devices, Inc. recommends a heat sink
with length and width dimensions of 25mm. This
allows proper coverage of the heat spreader of
Maximum
Weight
(grams)
Minimum
Lateral (X-Y)
Shear Strength
(psi)
Maximum
Vertical (Z)
Force
(Kg)
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 5 of 9
Page 6

a
the processor package. If a larger heat sink
(> 25mm square) is to be used, mechanical
support is necessary to avoid cantilevering of the
heat spreader.
Ensure that the heat sink is centered on the heat
spreader. When using a heat sink of 23mm x
23mm (which are the dimensions of the heat
spreader), used to ensure that the heat sink is
centered on the heat spreader to within 0.06”.
Heat Sink Attachment Recommendations
The thermal heat spreader is designed to increase
the thermal performance of the processor, and is
also the physical interface for attaching a heat
sink. Clear the thermal heat spreader and bottom
surface of the heat sink cleaned with Isopropyl
alcohol (100%) and a clean, lint-free swab before
mating the surfaces. Allow the isopropyl alcohol
to fully evaporate before dispensing the heat sink
adhesive.
Special care should be used when physically
handling the nickel-plated copper BGA_ED
package, since oil in the skin of the fingers can
contaminate the top surface of the thermal heat
spreader. Remove any finger oil, which
contaminates the thermal heat spreader, with
isopropyl alcohol before applying a heat sink or
thermal interface material to the processor.
For ADSP-TS201S processors, Analog Devices,
Inc. recommends three types of heat sink
attachment methods: tape anchor, solder anchor,
and adhesive.
The tape attachment method requires the use of a
thermally conductive adhesive tape that mates
the surfaces of the processor and the heat sink.
The tape serves a dual-purpose since it is also
used to compensate for any small surface
imperfections in either the processor or the heat
sink, which would work as an insulating air
barrier and would therefore increase the thermal
resistance in the system.
A solder anchor attachment method also requires
thermally conductive interface material between
the processor and the heat sink. This interface
material does not aid in attaching the heat sink to
the processor. The advantage to this method is
that a smaller amount of thermal interface
material is required; therefore, less thermal
resistance is introduced into the system. The
disadvantage is that additional board real estate
is required in order to facilitate the use of the
solder anchors on the top of the PCB.
GE Silicones “TSE 3281G” can be used to attach
a heat sink to the heat spreader of the
ADSP-TS201S package. (This material may be
purchased from General Electric Company, 960
Hudson River Road, Waterford, NY 12188 USA.
General Electric’s phone number is (800) 332-
5390.
Consider the adhesive's shelf life when selecting
the adhesive used to attach the heat sink to the
processor’s package. Dispense the adhesive in an
“X” pattern in the center of the nickel-plated heat
spreader; the adhesive is not allowed on the
bottom surface of the package laminate. A small
amount of adhesive is allowed to flow out to the
edge at the heat spreader and heat sink interface.
It is desired that no adhesive flows out of the
interface.
It is recommended that there is 0.45” clearance
on two opposite sides between the BGA_ED
body and the nearest component for heat sink
tool removal access.
The following information is presented for
reference purposes only. Verify any specific
applications needs.
• The adhesive thickness on the bonded surface
is nominally 0.004” (0.10mm) and must not
exceed 0.010” (0.25mm).
• The percentage of covered area of the bonded
surface shall not be less than 80% and must
not exceed 90% of the heat sink surface. The
adhesive must be centered about the heat
spreader’s surface within 0.06” (1.5mm).
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 6 of 9
Page 7

a
• The surfaces to be bonded must be flat to
within 0.004” (0.10mm).
PCB Design for Thermal Dissipation
Figure 10, a thermal model of the BGA_ED
package, shows that more thermal energy will be
dissipated through the top of the package since
the die is upside-down in the package. Due to
design constraints, there may be situations where
sufficient clearance to install a heat sink on the
device may not be available (or there may be
enough room only for a smaller heat sink that
may not have sufficient heat dissipation
characteristics) to allow for thermal power
dissipation to escape through this interface.
T
AMB
T
θ
θ
PA
HEAT SPREADER
LAMINATE
THERMAL ADHESIVE
DIE
T
JUNCTION
θ
θ
SINK
SA
CS
T
CASE
θ
JC
JB
Performing thermal simulations on a given
system is one method of ensuring proper system
performance.
Correct processor performance is not guaranteed
if T
value for T
is exceeded; ensure that the operating
CASE
is within the range specified in
CASE
the ADSP-TS201S data sheet.
Below is a listing of vendors that provide thermal
simulation software. These companies can also
provide thermal simulation assistance.
• Maya (
• Flotherm (
http://www.mayahtt.com/home.asp)
http://www.flowtherm.com)
• ThermoAnalytics, Inc.
(
http://www.thermoanalytics.com)
• Harvard Thermal Inc.
(
http://www.harvardthermal.com)
Alternate Thermal Relief Designs
In some specific cases, a passive thermal relief
solution may not be sufficient for cooling the
processor to within its specified operating
temperature range. Alternate thermal relief
solutions that may be applicable to specific
system application include:
• Heat sink fans
PCB
T
PCB
Figure 10. ADSP-TS201S BGA-ED Thermal Model
In this situation, thermal energy can be dissipated
from the solder balls of the BGA_ED package to
a heat sinking plane of the PCB. Thermal vias in
the PCB can be used in conjunction with a heat
sinking plane (i.e., a copper layer or some other
type of thermally conductive material) of
• Heat pipes
• Forced airflow (ducting)
Heat Sink Fans
A heat sink and fan combination is probably the
simplest method in achieving better thermal
relief performance over a passive system. The
heat sink fan increases the flow of air across the
heat sink, which aids in decreasing the overall
thermal resistance of the heat sink.
sufficient area to allow thermal transfer to a heat
sink or some other means of thermal relief.
Pros: Better thermal relief performance is
achieved with the same heat sink.
Thermal Simulations
Cons: A fan requires additional system power. It
also consumes additional space in the system,
Due to the high-performance of modern DSPbased systems, proper thermal management is
regardless whether the fan is located on top of or
next to the heat sink.
critical for desired performance and operation.
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 7 of 9
Page 8

a
Heat Pipe
A heat pipe can be used as a thermal relief
solution when there is insufficient height in a
system to allow placement of a heat sink, or the
height requirements limit the use of specific heat
sinks that exhibit insufficient thermal
characteristics. In this case, a heat pipe can
conduct thermal energy away from the processor
(via a cooling plate and a thermally conductive
pipe filled with a pressurized coolant) to a
remote heat sink and system fan to dissipate the
thermal energy to cooler air outside of the
system.
HEAT
PIPE
COOLING
COOLING
PLATE
FINS
Pros: The air duct (and fan combination) draw
cooler outside air into the enclosure and across
the processor’s heat sink. The air duct can be
designed to increase the speed of the air that
flows through it, increasing the cooling
characteristics of the system; a smaller fan can be
used in this case, decreasing overall system
noise. Lastly, air ducts can also isolate the
processor from the effects of system heating
(caused by other system components, such as a
linear regulator.)
Cons: Since air ducts are custom designed, they
can be expensive when compared to a heat sink.
Terminology
P
: The total power consumed on the VDD
DD
voltage domain by the TigerSHARC core. This is
an average value.
P
voltage domain by the Link Ports and Cluster
Bus of the TigerSHARC processor. This value is
system dependent, and is an average value.
: The total power consumed on the V
DD_IO
DD_IO
Figure 11. Heat Pipe Example
Pros: Heat pipes can be advantageous in systems
where a heat sink may be physically too large to
install.
Cons: Compared to a heat sink or fan sink
design, heat pipes are typically custom designed
and can be expensive.
Forced Airflow and Air Ducts
Forced airflow or ducting is another means to
achieve better cooling performance over a
passive design. Forced airflow is advantageous
in system designs with small enclosures that may
be so small that a fan of sufficient airflow
characteristics and size may not fit. A fan
external to the enclosure draws in or expels air
through an air duct, forcing air across the
processor heat sink.
P
DD_DRAM
: The total power consumed by the
internal DRAM of the processor. This is an
average value.
P
THERMAL
: Total power consumed by the
processor. This is an average value.
Heat transfer coefficient: theta (
θ
), given in
°C/W.
Thermal resistance: A measure of the flow of
heat from one medium to another.
Thermal equilibrium: System state when the
electrical power dissipated in the device is equal
to the heat flow out of the device.
T
AMBIENT
: The temperature of the local air
surrounding the processor in the system.
T
: The case temperature of the processor.
CASE
T
JUNCTION
T
SINK
: The processor junction temperature.
: The temperature of the heat sink.
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 8 of 9
Page 9

a
θ
: The thermal resistance between the case of
CA
the processor and the ambient air.
θ
: The thermal resistance between the junction
JA
of the processor and the ambient air.
θ
: The thermal resistance between the junction
JB
and the balls of the package.
θ
: The thermal resistance between the junction
JC
and the case of the processor.
θ
: The thermal resistance between the heat sink
SA
and the ambient air. This is also sometimes
known as the thermal resistance of the thermal
interface material (applied between the heat sink
and the processor package), or θ
TIM
.
References
[1] ADSP-TS201S TigerSHARC Embedded Processor Preliminary Data Sheet. Rev PrH, January 2004.
Analog Devices, Inc.
[2] Estimating Power for ADSP-TS201S TigerSHARC Processors (EE-170)
. In preparation. Analog Devices, Inc.
Document History
Version Description
Rev 1 – February 3, 2004
by Greg F.
Public Release
Thermal Relief Design for ADSP-TS201S TigerSHARC® Processors (EE-182) Page 9 of 9
 Loading...
Loading...